SMT packaging Special Report Ⅱ
CSP Rework의 경우 부품 제거, 사이트 교정 그리고 새로운 부품의 솔더링 동안에 PCB는 멀티 리플로우 사이클과 관계가 깊다. 무연 솔더를 사용한다면, 보드는 240°C~250°C의 온도 범위에서 다양한 열적 왕복운동을 실시한다. 이러한 높은 공정 온도는 PCB 재질을 잠재적으로 악화시키고, 지나친 휨, delamination, 솔더 마스크 얼룩 그리고 데미지를 입힐 수 있다. 게다가 Rework 동안의 멀티 리플로우 사이클은 PCB 표면 마감의 변화와 구리 재질 패드의 산화를 초래할 수도 있다. 이는 OSP(Organic Solderability Protection)가 처리된 PCB 패드에 전통적으로 나타나는 현상이다.
전자분야에서 납 사용의 규제 법안은 Lead-Free 솔더, 표면 마감재료들 그리고 부품 리드 마감재들에 있어서 납의 적용을 적극적으로 막는 것이다. CSP(Chip Scale Packages) 어셈블리와 Rework에서 Lead-Free 솔더 사용에 있어서 가장 중요한 부품들과 보드들이 겪는 상대적으로 높은 온도이다. 파인피치의 CSP는 매우 낮은 스탠드오프 높이를 가지고 있어 어셈블리업체에서는 검사 공정과 더불어 이들 부품들의 Rework 작업이 더욱 어려워졌다. 또 다른 주의사항은 Rework 공정 동안 인접부품에 미치는 열과 Rework의 관계이다. Lead-Free 리플로우 온도를 조절하는 Rework 장비의 한계와 결합된 이들 문제는 Rework하는 해당 업체들이 해결해야 하는 사항이다.
본고에서는 SnAg와 SnAgCu 솔더 볼을 지닌 Lead-Free CSP가 어셈블리했고, 이를 다시 Rework을 시대했다. 게다가 비교하기 위해 SnPb CSP를 동일한 조건에서 어셈블리했고, 이를 Rework했다. 다른 Rework 순서, 교정 그리고 플럭싱 기술을 평가한다. Post-어셈블리와 post-Rework 검사는 X-Ray 검사기, 스탠드오프 측정 그리고 횡단면 분석 검사기기 등을 이용해서 실시했다. Rework 어셈블리 업체들은 0°C~100°C의 AATC(Air-to-Air Thermal Cycling)에서 920사이클을 실시했다. post-Rework 테스트에서 어떠한 타임-제로의 전기적인 실패가 발견되지 않았다. 특히, 파인피치 부품과 CSP의 Lead-Free Rework을 위해 사용 가능한 가이드라인은 발전되고 있으며, 본고에서는 이를 설명한다.
서론
Lead-Free CSP의 Rework은 SnPb CSP 공융과 비슷하다. Lead-Free와 SnPb CSP Rework 양쪽 모두 다음의 단계를 고려해야 한다

SnAg, SnAgCu 등의 무연 솔더 합금이 이용된 Lead-Free 어셈블리와 Rework과 연계된 중요한 문제 중 하나는 공융 SnPb 합금 융점(183°C)과 비교해서 무연 합금의 상대적으로 높은 융점(~220°C)이다. 많은 무연 솔더들의 리플로우 온도 피크는 거의 240°C~250°C에 근접해야 하는데, 이는 210°C~220°C의 SnPb 솔더링 온도와 비교된다. 이러한 리플로우 온도의 증가는 멀티 리플로우에서 Lead-Free 온도를 적용하기 위해 부품과 PCB 재질을 재평가하는 것이 필요하게 한다. 어셈블리와 Rework 공정은 부품과 PCB 재질의 특성이 타협되지 않는 것을 확실하게 하기 위해 최적화가 필요하다.
CSP Rework의 경우 부품 제거, 사이트 교정 그리고 새로운 부품의 솔더링 동안에 PCB는 멀티 리플로우 사이클과 관계가 깊다. 무연 솔더를 사용한다면, 보드는 240°C~250°C의 온도 범위에서 다양한 열적 왕복운동을 실시한다. 이러한 높은 공정 온도는 PCB 재질을 잠재적으로 악화시키고, 지나친 휨, delamination, 솔더 마스크 얼룩 그리고 데미지를 입힐 수 있다. 게다가 Rework 동안의 멀티 리플로우 사이클은 PCB 표면 마감의 변화와 구리 재질 패드의 산화를 초래할 수도 있다. 이는 OSP(Organic Solderability Protection)가 처리된 PCB 패드에 전통적으로 나타나는 현상이다.
CSP 어셈블리
본고에서는 3개의 다른 패키지를 이용해 설명한다. 두 개의 CSP 패키지는 무연 솔더 합금 볼이 이용됐으며, 하나는 공융 SnPb 솔더 볼을 실험했다. 표 1은 부품의 자세한 사항을 보여주고 있다. 패키지 A는 부품 패드가 정의된 non-solder 마스크를 가지고 있다. 반면에 패키지 B와 C는 부품의 사이드에 패드가 정의된 솔더 마스크를 가지고 있다. 3개의 모든 패키지는 평가 목적을 위해 daisy-chained 구조로 된 기계적으로 동일한 샘플들이다.
.gif)
.gif)
본고에서의 테스트 보드는 62.0mm 두께의 무전해 Ni/이머젼 Au 마감재가 처리된 FR-4 다층기판이다. 보드는 서로에 인접한 3개의 CSP 어셈블리 사이트를 포함하고 있다. 11.0mm, 13.0mm 그리고 15.0mm의 3개의 패드 사이즈는 PCB에 위치해 있다. 3가지 사이트의 저항과 전기적인 지속성 그리고 서로 다른 사이트는 테스트 보드 일련의 프로브 패드를 통해서 결정될 수 있다.
패키지 A, B 그리고 C를 12번씩 어셈블리했다. 패키지 A는 90% 금속이 함유된 Type 4의 63%Sn/37%Pb 페이스트를 이용해 어셈블리했다. 패키지 B는 89%의 금속이 함유된 Type 4의 95.8%Sn/3.5%Ag/0.7%Cu 페이스트가, 패키지 C는 89% 금속의 Type 4 96.5%Sn/3.5%Ag 페이스트를 사용해 어셈블리했다. 레이저 절단을 이용한 5.0mm 두께의 스테인리스-강 스텐실이 솔더 페이스트 프린트에 사용됐다. 프린트 파라미터는 페이스트 구성성분을 밀수 있도록 최적화시켰다. 모든 솔더 페이스트를 위해 높이를 거의 4.0mm로 맞췄다. 페이스트 침전은 레이저 측정기를 이용해서 측정했다. 그림 1은 테스트 보드에서 SnAg(96.5Sn/3.5Ag) 페이스트의 침전을 보여주고 있다.
.gif)
부품들은 테스트 보드에 놓은 후에 리플로우했다. 245℃의 피크를 지닌 싱글 리플로우 프로파일은 패키지 B와 C 양쪽의 리플로우 솔더링을 위해 사용됐다. SnAg와 SnAgCu의 다른 융점은 섭씨 몇 도의 차이로 비슷했다. 그리고 싱글 리플로우 프로파일은 두 개의 솔더 합금에 충분하다는 것을 발견했다. 이는 어셈블리된 패키지의 최초 X-Ray 검사기와 횡단면 분석기에 의해 확인되었다.
.gif)
그림 2는 Lead-Free 패키지의 어셈블리에 이용된 리플로우 프로파일을 보여주고 있다. 표 2는 공융 SnPb 프로파일과 Lead-Free 프로파일 양쪽 모두의 리플로우 프로파일을 나타내고 있다. 리플로우 프로파일로부터 입증된 것은 Lead-Free 솔더링 시 부품들과 보드들이 공융 SnPb 솔더링과 비교해서 더 길고 더 높은 온도가 필요하다는 것이다.
어셈블리 된 PCB들은 X-Ray와 횡단면적 분석기를 이용해서 검사했다. 특이한 브릿지 혹은 오픈을 검출하지 못할 수도 있다. 그러나 약간의 작은 보이드가 일부 어셈블리 된 PCB에서 나타났다. 이러한 작은 보이드의 존재는 솔더 접합의 신뢰성에 중요한 영향을 끼치지 않는다. 크지 않은 보이드 혹은 많은 수의 작은 보이드는 어셈블리 된 PCB의 X-Ray 검사기에서 나타났다. 그림 3은 어셈블리 된 패키지 B의 X-Ray 이미지를 보여주고 있다. 모든 PCB는 전기적으로 우수했으며, Rework 후에 저항수치가 대조적임을 주의해야 한다. 어셈블리의 스탠드오프 높이는 레이저 측정기를 이용해서 측정했다.
CSP Rework
많은 어셈블리 업체들은 반자동 열풍 가스 시스템을 이용해서 Rework한다. Rework 시스템은 두 개의 히터를 가지고 있는데, 상부 히터는 Rework되는 부품의 부분 가열을 위해 사용되고, 보드-밑의 히터(혹은 하부 히터)는 전면적인 보드의 열적 증감을 감소시키기 위해 전체 보드의 가열에 이용된다. 독립적인 픽업 튜브는 부품을 제거하고 재배치하기 위해 사용된다. 열풍 가스 노즐은 부품을 완벽하게 대응하고 PCB의 표면에 위치해 있다.
노즐은 부품의 아래로 향하는 온풍의 흐름을 쉽게 한다. 노즐은 10.0mm×12.0mm의 CSP Rework에 이용된다. 보드 아래의 서포터는 상승된 온도가 필요하다. 4개의 보드 서포터는 테스트 보드를 잡기하기 위해 이용됐다. 모든 테스트 보드들은 비활성 질소 환경에서 Rework됐다.
열적 프로파일링
열적 프로파일링은 CSP의 Rework에 있어서 가장 중요한 단계 중 하나이다. 증가된 프로파일은 패드의 리프팅을 초래할 수도 있다. 만약 솔더가 녹아들지 않았다면 그 전에 제거해야 한다. 한편, 만약 부품이 넓게 가열된다면, PCB 위의 인접 부품들에서 피해가 발생할 수 있다. CSP를 재배치 할 때, 적합한 열적 프로파일은 부품과 보드가 과열되지 않고 모든 솔더 볼이 리플로우됐다는 것을 보증한다.
Rework의 제거와 재배치 프로파일은 어셈블리의 리플로우 프로파일과 비슷하다. 따라서 주요 문제는 Rework 장비에서 어셈블리의 프로파일과 동일한 설정여부이다. 어셈블리 공정의 결정적인 순간에서 온도를 관찰하는 것은 필요하다. 솔더 접합의 온도, 보드를 가로지르는 온도 차이 그리고 인접한 부품의 온도는 관찰되어졌다.
3.0 직경의 K-타입 서머커플은 열 프로파일에 사용된다. Rework되는 부품의 솔더 접합 온도를 관찰하기 위해서 어셈블리에 앞서 PCB 패드에 구멍이 뚫어졌다. 그런 후에 부품이 어셈블리됐다. 그리고 나서 서머커플들은 PCB의 바닥 면으로부터 이들 구멍에 끼워지고 UV 경화 접착제를 이용해 고정시켰다. 5개의 서머커플들은 열 프로파일 측정을 위해 사용된다. 그림 4는 5개의 서머커플 위치와 Rework 셋업을 보여주고 있다. 5개의 서머커플의 위치는 다음과 같다.
▶ Rework 되는 부품의 솔더 접합 중앙
▶ Rework 되는 부품의 솔더 접합 코너
▶ Rework 되는 부품의 위
▶ Rework 되는 부품 아래 보드의 밑면
▶ Rework 되는 하나의 부품에 인접한 솔더 접합의 코너
.gif)
어셈블리 프로파일은 10존 리플로우 오븐을 사용하면서 향상됐다. Rework 장비에 어셈블리 공정과 같은 프로파일을 적용하는 것은 어려운 일이다. 이는 발열 구조의 차이와 Rework 장비의 한계 때문이다. Rework 장비에서 ramp 비율은 1.7℃/sec로 제안되어 있다. 그림 5에서는 Rework 장비의 Rework 프로파일이 향상되었다는 것을 보여주고 있다. Rework 장비에서 향상된 리플로우 파라미터는 표 3에 나타내고 있다.
Rework 장비에서의 프로파일은 시스템 소프트웨어를 이용해서 향상됐다. 소프트웨어는 상부와 바닥면의 발열 온도를 비슷하게 유지시킨다. 특이한 서머커플에 의해 측정되는 온도가 특정 프로파일을 따라오게 함으로써 가능하게 한다. Rework 되어진 부품의 솔더 접합 중앙에서 서머커플은 서머커플 레퍼런스로써 사용된다. 소프트웨어(작업자에 의해 설정된 어셈블리 리플로우 프로파일이 솔더 접합 온도의 중앙에 따라오게 하는 것과 같은 방식)는 상부와 바닥면의 발열 온도가 비슷하게 된다. 입력 프로파일 설정과 유사한 프로파일은 Rework 공정을 향상시킨다.
어셈블리와 Rework 리플로우 파라미터를 비교함으로써, 두 개 사이에 중요한 차이가 있음을 확인할 수 있었다. 액상선 온도 이전의 과잉의 시간은 과도한 금속간 화합물의 성장을 촉진시킨다. 그러나 Rework 장비는 어셈블리 리플로우 프로파일과 동일하게 요구하는 ramp 비율을 이룰 수 없다. 그림 5에서는 리플로우 프로파일을 나타내고 있으며, SnPb Rework 리플로우 프로파일은 부품 제거와 부품 재배치 공정에 이용된다.
.gif)
부품 제거
앞에서 언급했던 바와 같이 어셈블리 된 부품들은 Rework 프로파일을 이용해서 제거된다. 패키지 A는 SnPb Rework 프로파일이 이용되어 제거됐으며, 패키지 B와 C는 Lead-Free Rework 프로파일이 사용되어 제거됐다. Rework 장비에서 소프트웨어는 주요 Rework 공정을 이행하도록 구성된 다수의 반자동으로 스퀀시를 제공한다. ‘Remove Zero Force’는 이러한 스퀀시 중 하나이다. 그 후에 노즐과 픽업 튜브가 프리즘 비전 시스템을 이용해서 매뉴얼대로 정렬된 부품을 제거하기 위해서 Rework 장비는 부품 제거 공정의 스퀀시가 미리 결정된 대로 실행한다. 노즐이 내려오고, 부품을 덮고 그리고 PCB의 표면에 놓는다. 상부와 하부 히터는 특정한 부품을 위해 향상된 Rework 프로파일대로 Rework 사이트를 발열한다. 프로파일의 리플로우 단계의 마지막 부분에서 모든 솔더 접합이 녹을 때, 픽업 튜브는 내려가고 부품을 들어올린다.
CSP가 제거된 후에, Rework 사이트는 연구되고 잔여 솔더의 높이는 측정된다. 패드의 벗겨짐(혹은 패드 리프팅) 혹은 솔더 마스크 등의 어떠한 피해가 없었다. 잔여 솔더 높이는 4.1mm~10.8mm까지 나타났으며, 평균 6.0mm이었다. 이 수치는 세 개의 모든 패키지 타입을 인계받은 192 패드 위치의 측정 결과이다. SnPb와 Lead-Free 솔더 잔여의 차이를 증명하는 명백한 경향을 입증하지 못했다.
사이트 교정
새로운 부품을 놓을 수 있도록 평편한 표면을 확보하기 위해 떼어진 부분의 잔여 솔더는 제거되어야 한다. 표면이 평편하지 않을 때는 새로운 부품의 솔더링 시 오픈 접합, odd-shaped 접합 그리고 부품의 잘못된 배치 결과를 초래할 수 있다. 따라서 고정적으로 많은 솔더의 양이 패드에 남아있는 것은 중요하고 성공적인 부품의 재배치를 위해 표면은 평편해야 한다.
사이트 교정은 Rework 공정에서 작업자의 의존도가 가장 높은 단계이다. 일부 교정 기술에서는 PCB에 끼칠 수 있기에 피해를 없애기 위해 숙련된 작업자가 필요하다. 사이트 교정이 솔더 마스크 피해와 패드 벗겨짐 시에 일부에서 일반적인 문제들로 대두됐다. 인두기&브레이드에 의한 방법, 울퉁불퉁한 copper coupon을 사용하는 기술 등 이 두 개의 사이트 교정 기술로 실험했다.
인두기&브레이드 기술은 작업자의 숙련도에 의존한다. 플럭스가 주입된 구리 브레이드는 잔여 솔더에 놓여지고, 인두기를 이용해 열을 가한다. 잔여 솔더는 녹고, 구리 브레이드에 스며든다. 이리 하여 PCB 패드에는 얇은 솔더 층이 남게 된다. 하지만 보드의 성질이 어떻게든 손상되지 않는다는 것을 확실하게 해야 하는 것을 주의해야 한다. 솔더 위크(solder wick)의 넓이와 솔더링 인두기의 팁이 주의 깊게 선택되어야 한다. 적당하지 않은 솔더 위크의 사이즈와 솔더링 인두기 팁은 솔더 마스크와 PCB 패드를 벗겨낼 수도 있다. copper coupon 방법에서 거친 사이트 크기의 copper coupon은 240 크기의 그릿 페이퍼를 이용해서 모래를 뿌리고, 잔여 솔더가 있는 사이트에 매뉴얼대로 배치된다.
플럭스를 사이트와 copper coupon 양쪽에 칠했다. 제거 작업은 리플로우 프로파일을 이용해서 제거와 재배치가 가능하도록 향상된 Rework 장비에서 실시했다. 잔여 솔더가 녹을 때, 솔더는 copper coupon에 젖으면서 coupon과 함께 제거됐다. 이러한 사이트 교정 방법은 더욱 발전하여 작업자의 의존도를 감소시킨다. 그러나 교정 후에 많은 양의 잔여 솔더가 사이트에 남아 있을 경우에는 솔더링 인두기&브레이드 방법에 의해 보다 더 많은 양이 남는다. 이 방법의 결점은 솔더링 인두기&wick 방법과 비교해서 보드가 추가적으로 리플로우 사이클을 거쳐야만 한다는 것이다. 솔더링 인두기&브레이드 방법은 본고에서의 이 방법이 이야기 되지 전에 다른 보드에서 사용되고 있다. 그러나 이러한 방법이 이용되는 많은 사이트 교정은 약간의 피해가 나타난다. 가장 일반적인 피해는 솔더 마스크에서 발생한다. Copper coupon 방법의 교정에서는 더욱 반복적으로 발견되고, 어떠한 솔더 마스크에서도 피해를 초래하지 않는다. copper coupon에서의 잔여 무연 솔더의 젖음성은 SnPb의 젖음성 만큼 좋지 않았다. 상부 히터 온도 피크는 이전의 325℃에서 340℃까지 증가되어 젖음성을 증대시켰다. 많은 양의 잔여 솔더가 제거되어 현저한 증가가 관찰되었지만, 여전히 SnPn 솔더보다 덜 했다. 크기가 작아지고 가스가 흐르는 동안 copper coupon이 노즐 안으로 이동했다.
‘Zero Force Removal’ 스퀀시는, 픽업 노즐은 50.0g의 힘이 사용되고, soak 스테이지의 가장자리까지 배치 장소에서 coupon을 잡는 ‘Force Removal’ 스퀀시로 변경된다. Soak 스테이지 가장자리에서, 픽업 튜브는 coupon을 놓아주고, 40.0mm로 이동한다. 이는 놓이는 장소의 coupon을 잡고, 잔여 솔더의 상당 부분을 성공적으로 제거한다. 교정 후에 2가지 방법을 이용해서 패드 위에 남아있는 솔더는 Laser profilometer를 이용해서 측정되었다. 솔더링 인두기&브레이드 방법의 경우에 패드에 남아 있는 솔더의 높이는 0.4mm~2.2mm까지로 나타났으며, 평균은 대략 1.1mm이다. copper coupon 교정 기술은 평균 2.4mm의 1.7mm~3.0mm 범위의 많은 솔더 양이 남는다. 그림 6은 SnAgCu 합금 redressing 전후의 PCB 표면을 덮는 솔더의 높이를 보여주고 있다.
.gif)
플럭스 적용과 부품 재배치
부품의 재배치는 매우 어려운 일이다. CSP는 무게가 매우 가벼워서 솔더링 공정 동안에 노의 내부로 옮겨질 수 있다는 단점을 가지고 있다. 더불어 플럭스만을 이용한 재배치 공정은 솔더링 공정 동안에 부품이 놓이는 장소에서 요구하는 양의 두께를 만족시키지 못할 수도 있다. 상부 히터 열풍은 솔더링 공정 동안 부품이 움직이는 것을 고정하기 위해 100SCFH(Standard Cubic Feet per Hour)에서 50 SCFH로 감소시켰다. 그러나 낮은 열풍세기를 사용해서 솔더 접합이 나쁘게 형성됐다. 50SCFH보다 낮은 열풍 세기는 Rework 장비에서 유지될 수 없다. 그래서 Rework 장비의 ‘Zero Force Place Release Reflow’ 시퀀시를 위한 조절은 ‘Force Place Release Reflow’ 시퀀시에서 변경된다.
부품에 적용되는 플럭스 적용은 ‘doctor’ 블레이드를 사용하는 평면 금속 판 위에서 얇은 층의 점착 플럭스 스크리닝과 관계가 있다. ‘doctor’ 블레이드의 차이는 금속 판 위에서 플럭스 필름의 두께를 결정한다. 그런 후에 재배치되기 위한 부품은 플럭스의 얇은 필름에 배치된다. 일치하는 PCB 사이트는 얇은 브러시를 사용하는 동일한 점착성 플럭스를 가지고 플럭스된다. 그 다음에 부품은 픽업 튜브에 의해 금속판으로부터 픽업되고 PCB 사이트에 정렬된다. 그 후 마침내 프리즘 비전을 사용해서 최종 얼라인먼트되고 픽업 튜브는 내려오고, PCB에 부품을 배치한다. 기본 시퀀시를 변경함으로써 픽업 튜브는 부품을 50.0g의 압력을 가하고, soak 스테이지 가장자리까지 부품을 적당하게 잡는다.
Soak 스테이지의 가장자리에서, 픽업튜브가 부품을 놓고, 40.0mm 정도 움직이고 리플로우 사이클의 휴지는 유지했다. 리플로우 사이클의 마지막에, 부품은 PCB에 솔더됐다. 전통적인 재배치 시퀀시의 이러한 수정은 모든 패키지에서 작업이 잘 됐다. 평균 0.5 솔더 볼 높이의 플럭스 depth는 재배치 공정에 사용됐다. 4.0mm의 플럭스 depth는 패키지 B와 C 그리고 5.0mm는 패키지 A에 사용됐다.
수정된 ‘Force Place Release Reflow’ 스퀀시에서는, 솔더가 리플로우되기 전에 픽업 튜브는 부품을 놓고 옮긴다. 리플로우 스테이지에서의 프로파일 동안의 지속적인 압력은 솔더 접합 형성의 외형에 영향을 끼치고, 솔더 브릿지를 촉진한다. 그러므로 soak 스테이지 후에 픽업 튜브가 부품을 가지고 모든 접촉이 끊어지는 지가 측정된다. 예열 동안 부품의 전반에 걸친 픽업의 존재와 soak 스테이지는 솔더 합금의 self-centering 능력을 제한할 수도 있다.
X-Ray 검사기와 횡단면 분석기
Rework되는 샘플들은 광학적으로 검사했다. 그리고 그 후에 전기적인 지속성을 조사했다. 모든 샘플들은 전기성이 우수했으며, Rework 전의 샘플들과 비슷한 저항치를 가지고 있었다. Rework된 어셈블리들은 우수한 솔더 접합 형상을 나타냈으며, 심각한 보이드는 발생하지 않았다. 그림 7은 패키지 B의 Rework된 어셈블리의 X-Ray 이미지 영상을 보여주고 있다.
각각의 패키지로 Rework된 3개의 샘플들은 솔더 접합의 모양, 패드 주위의 솔더 젖음성 그리고 스탠드오프를 연구하기 위해 횡단면을 잘랐다. 횡단면은, Rework 되지 않은 하나의 샘플, 인두기&브레이드 교정 기술이 적용된 하나의 Rework 샘플 그리고 각각의 패키지에 copper coupon 교정 기술이 이용된 하나의 Rework 샘플을 선출해 실시했다. 횡단면을 이용해 측정된 스탠드오프는 Laser profilometer를 이용해 측정한 스탠드오프와 비교했다. 표 4는 Rework되지 않은 것과 Rework된 패키지(Laser profilometer와 횡단면을 사용해서 측정된)의 스탠드오프 측정을 보여주고 있다.
Laser profilometer 기록은 패키지 당 4개를 스캔해서 얻은 9개 패키지의 평균이다. Laser profilometer 기록은 횡단면을 사용해서 측정한 스탠드오프보다 더 낮았다. 플럭스만으로 Rework 공정이 실행됐기 때문에 스탠드오프는 나중의 Rework은 이전 Rework의 스탠드오프와 더 비교되지 않는다는 것을 알았다. 인두기&wick 사이트 교정 방법을 이용해 Rework된 무연 패키지의 스탠드오프는 평균 0.5mm~0.8mm로, 이는 copper coupon 사이트 교정 방법을 사용해 Rework된 패키지보다 낮은 수치이다.
.gif)
.gif)
Rework 되지 않은 패키지들의 횡단면은 솔더 접합의 우수한 패드 젖음성과 무너짐을 보여주고 있다. 그러나 일부에서는 보이드가 검사됐다. 그림 8은 Rework되지 않은 패키지 B(SnAgCu) 솔더 접합의 횡단면을 보여주고 있다.
Rework 된 패키지의 횡단면도 역시 패드 주위에 우수한 젖음성을 보여주었다. 그러나 공융 솔더(SnPb)의 솔더볼 보다 더 큰 패키지 A를 제외하고, 나머지 Lead-Free 패키지들은 Rework되지 않은 어셈블리와 비교해 동등한 수준의 무너짐 현상이 나타나지 않았다. 게다가 Rework된 Lead-Free 패키지들의 횡단면은 PCB 패드에서 어느 정도의 부품 misalignment가 나타났다. 이는 변경된 부품 재배치 공정 때문일지도 모른다. 그러나 이러한 misalignment는 패키지 A의 횡단면에서는 나타나지 않았다. copper coupon 사이트 교정 방법으로 Rework된 패키지들은 인두기&wick 사이트 교정 방법으로 했을 때보다 더 나아진 솔더 접합 모양을 보였다. 이는 PCB 패드에 많은 양의 솔더가 남아있던 탓일지도 모른다.
그림 9는 copper coupon 사이트 교정 방법으로 Rework된 패키지 A의 솔더 접합 횡단면을 나타내고 있다. 그림 10은 인두기&wick 방법으로 Rework된 패키지 B의 횡단면을 보여주고 있다. 그림 11은 copper coupon 사이트 교정 방식으로 Rework된 패키지 C의 횡단면 사진이다.
3개의 패키지 어셈블리들 경우에, Ni-Sn 금속간 화합물을 관찰했다. NiSn 금속간 화합물 레이어 두께는 Rework 후에 현저하게 성장하는 것을 볼 수 있었다. 깨지기 쉬운 특성의 이들 금속간 화합물들은 솔더 접합 특성에 악영향을 미칠 수 있다. 그림 12는 Rework된 패키지 C(SnAg) 솔더 접합의 금속간 화합물 레이어를 보여준다.
신뢰성
Rework된 샘플들은 AATC에서 실시했다. 열 사이클은 5분의 ramp와 soak 주기를 지닌 0°C~100°C까지의 20분 사이클이었다. Rework된 샘플들은 어떠한 실패 없이 920의 열적 사이클을 실시했다. 이후에 결과를 기다렸다.
결 론
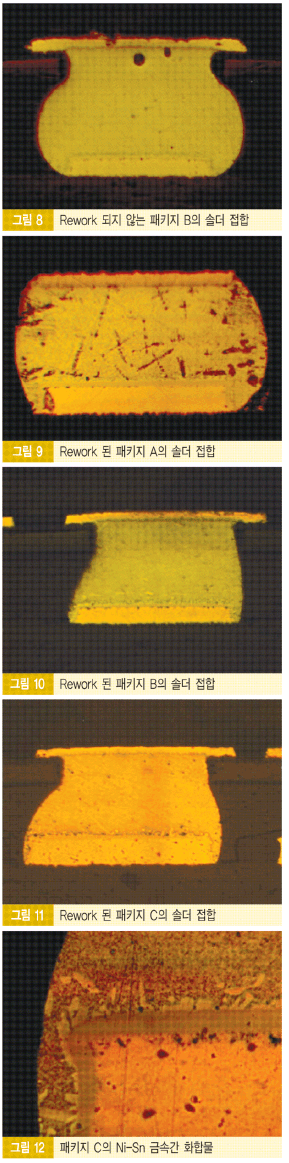 CSP의 파인피치 특성, 낮은 스탠드오프, Lead-Free 공정 온도 그리고 Rework 공정과 관계된 불일치는 Lead-Free CSP Rework에 있어서 큰 문제이다. Lead-Free CSP Rework에 사용되는 Rework 장비의 가용 능력은 매우 중요하다. 히팅 프로세서의 효율은 주로 Rework 기기와 노즐 디자인의 히팅 시스템에 의존한다. Rework 기기의 depth 평가는 실제 작업에 필요하다. Lead-Free Rework를 위해 보유해야 하는 Rework 기기의 주요 기능들은 다음과 같다;
CSP의 파인피치 특성, 낮은 스탠드오프, Lead-Free 공정 온도 그리고 Rework 공정과 관계된 불일치는 Lead-Free CSP Rework에 있어서 큰 문제이다. Lead-Free CSP Rework에 사용되는 Rework 장비의 가용 능력은 매우 중요하다. 히팅 프로세서의 효율은 주로 Rework 기기와 노즐 디자인의 히팅 시스템에 의존한다. Rework 기기의 depth 평가는 실제 작업에 필요하다. Lead-Free Rework를 위해 보유해야 하는 Rework 기기의 주요 기능들은 다음과 같다;
▶ Lead-Free 공정 온도에 부합한 능력
▶ 효율적인 히팅 시스템(상부 히터와 하부 보드 히터)
▶ 파인피치 부품들을 정확하게 배치할 수 있는 비전 시스템
▶ Hot gas airflow control
▶ 열 프로파일과 Rework 스퀀시 조절을 위한 유연한 소프트웨어
열 프로파일은 매우 중요한 것으로, 솔더 접합에서 온도를 측정하기 위한 임무를 충족시켜야 한다. 부품 제거는 비교적 더 단순한 공정이다. 넓은 보드 서포트가 지원되어야 하고, PCB 사이트에 어떠한 피해는 예방되어야 한다. 사이트 교정은 Lead-Free Rework에서 중요한 공정이다. 인두기&wick 방법은 솔더 마스크에 피해를 끼치는 결과를 초래한다. Copper coupon 교정 방법은 PCB 사이트에 어떠한 피해도 주지 않는 우월성을 제공한다. copper coupon 교정의 주요 이점은 공정에서 전적으로 작업자에게 의존하지 않아도 되고 지속적인 공정이 가능하다는 것이다. 그러나 이는 추가적인 리플로우 사이클에 어셈블리를 맡기는 것을 포함하고 있다. 추가적인 리플로우 사이클은 과도한 금속간 화합물 형성 때문에 PCB 사이트의 특성과 어셈블리의 신뢰성에 악영향을 끼칠지도 모른다.
재배치 공정 스퀀시 변경은 리플로우 동안의 부품 이동을 예방하는 것이 요구된다. 이러한 변경은 부품의 self-centering 능력에 악영향을 미칠 수도 있다. 따라서 일부 발생하는 잘못된 배치에 대해 설명했다. Rework된 부품들은 과잉 습기를 제거하기 위해 125℃에서 굽는 것이 좋으며, 이는 리플로우 동안의 어떠한 delamination 혹은 popcorning 형성을 예방한다. 굽는 기간은 패키지의 민감한 습기 수준에 의존한다. 이러한 경험이 축적된 CSP는 non-moisture sensitive(JEDEC Level 1)로 분류되기 때문에 재배치 이전의 굽는 공정은 실시되지 않는다.
브릿지 혹은 전기적인 실패의 어떠한 예도 발견되지 않았다. Rework된 샘플들의 횡단면 검사는 모든 경우에 우수한 패드 젖음성을 보였으나, Lead-Free 패키지들은 감소된 무너짐을 보였다. Copper coupon 사이트 교정 기술은 인두기&브레이드 방법보다 더 나은 솔더 접합 모양을 보인다. 스탠드오프 post-Rework은 인두기&브레이드 사이트 교정 방법의 경우에 0.8mm~1.2mm, copper coupon 사이트 교정 방법의 경우에는 0.3~0.6mm 감소시킨다. Rework 공정 후의 금속간 화합물의 두께는 증가한다. 이는 Rework 패키지의 신뢰성에 결정적일수도 있다. Rework 패키지의 열 사이클 신뢰성 결과는 좀 더 기다려야 한다.
