이전 특허방법은 칩 사이즈에 따른 인클로저(enclosure)를 형성하도록 판금을 가공하여 인클로저 내부의 적절한 위치에 칩을 넣거나, 칩의 외주에 가공된 판금을 덧붙이는(laminating) 공정을 포함한다. 그러므로 그 방법은 처리 공정의 수가 많아지거나 비용이 커지는 문제가 있다. 그러므로 인쇄 기판과의 양호한 EMC를 유지할 수 있고, 간단하고 쉬운 공정으로 저렴하게 제조될 수 있는 반도체 패키지, 반도체 패키지의 제조 방법 및 반도체 패키지를 포함하는 광학 모듈 제공하는 것이 바람직하다.
반도체 패키지가, 지지 기판, 지지 기판의 제1 주면에 형성된 기능 소자 및 제1 접합 요소, 기능 소자와 제1 접합 요소를 개재하여 지지 기판에 대해 대향하는 관계로 배치된 실링 기판, 지지 기판의 제2 주면상에 제공된 제2 접합 요소, 지지 기판을 관통하도록 제공되고 제1 접합 요소와 제2 접합 요소를 전기적으로 접속시키게 구성된 관통 전극 및 제1 주면 및 제2 주면과 직교하여 연장하는 지지 기판의 측면의 모든 면적에 코팅된 제1 전자기적 실드 막을 포함한다.
기술 분야
본 발명은 WCSP(Wafer level chip size package : 웨이퍼 레벨 칩 사이즈 패키지) 등과 같은 반도체 패키지 및 반도체 패키지를 이용한 WLCM(Wafer level camera module : 웨이퍼 레벨 카메라 모듈)에 관한 것이다.
근년의 집적화 기술의 향상에 따라, 전자 기기의 소형화 및 경량화, 저전압 동작 및 저소비 전력화 및 고주파 동작화가 급속하게 진전되었다. 그래서 BGA(ball grid array : 볼 그리드 어레이), LGA(land grid array : 랜드 그리드 어레이) 및 CSP(chip size package : 칩 사이즈 패키지) 등과 같은 에리어 어레이형 패키지(area array type package)의 수요가 확대되고 있다. 최근에는 관통 전극을 이용한 WCSP 등과 같은 선진 기술도 보급되기 시작하고 있다.
WCSP는 실링 수지(sealing resin)나 외부 단자의 형성 처리 공정이 다이싱(dicing) 전의 웨이퍼의 단계에서 행해지는 반도체 패키지다. 설명한 것과 같은 WCSP에서는, 칩이 머더 보드(mother board) 등과 같은 인쇄 기판에 장착될 때, 칩상의 패드와 인쇄 기판상의 패드가 땜납 볼(solder ball)을 거쳐 서로 접합될 수 있다. 이것은 본딩 와이어(bonding wire)나 인터포서(interposer)에 접속할 필요가 없게 한다. WCSP는 예를 들어 수광 소자나 MEMS(MicroElectroMechanical System: 마이크로머신) 소자를 위한 전자 부품 패키지로서 적절하게 이용되고 있다. 그러나 앞에서 설명한 WCSP와 같은 반도체 패키지에서는 인쇄 기판과의 EMC(ElectroMagnetic Compatibility:전자기적 불간섭)를 확보할 필요가 있고, 다양한 대책이 요구되고 있다. 예를 들어, 일본 특허 공개 2009-158853호(이하, 특허 문헌 1이라고 지칭됨)에는 관통 전극(through-electrode)을 이용한 반도체 패키지의 외주에 판금(metal sheet) 등으로 이루어진 전자기적 차단체(electromagnetic shield)를 배치하는 방법이 개시되어 있다.
발명의 내용
해결하려는 과제
그러나 특허 문헌 1에 개시된 방법은 예를 들어 칩 사이즈에 따른 인클로저(enclosure)를 형성하도록 판금을 가공하여 인클로저 내부의 적절한 위치에 칩을 넣거나, 칩의 외주에 가공된 판금을 덧붙이는(laminating) 공정을 포함한다. 그러므로 그 방법은 처리 공정의 수가 많아지거나 비용이 커지는 문제가 있다. 그러므로 인쇄 기판과의 양호한 EMC를 유지할 수 있고, 간단하고 쉬운 공정으로 저렴하게 제조될 수 있는 반도체 패키지, 반도체 패키지의 제조 방법 및 반도체 패키지를 포함하는 광학 모듈 제공하는 것이 바람직하다.
과제의 해결 수단
본 발명의 한 실시예에 따르면, 지지 기판, 지지 기판의 제1 주면(principal surface)에 형성된 기능 소자 및 제1 접합 요소, 기능 소자와 제1 접합 요소를 개재하여 지지 기판에 대해 대향하는 관계로 배치된 실링 기판(sealing substrate), 지지 기판의 제2 주면상에 제공된 제2 접합 요소, 지지 기판을 관통하도록 제공되고 제1 접합 요소와 제2 접합 요소를 전기적으로 접속시키게 구성된 관통 전극, 및 제1 주면 및 제2 주면과 직교하여 연장하는 지지 기판의 측면의 모든 면적에 코팅된 제1 전자기적 실드 막(electromagnetic shield film)을 포함하는, 반도체 패키지가 제공된다.
본 발명의 다른 실시예에 따르면, 기능 소자와 제1 접합 요소가 제공된 제1 주면을 갖는 지지 기판에 실링 기판을 덧붙이는 공정, 지지 기판의 제1 접합 요소에 대응하는 영역에 관통 전극을 형성하는 공정, 지지 기판의 제2 주면측에서 관통 전극에 전기적으로 접속되는 제2 접합 요소를 형성하는 공정, 및 제1 주면 및 제2 주면과 직교하여 연장하는 제1 지지 기판의 측면의 모든 면적에 제1 전자기적 실드 막을 형성하도록 도전 재료(conductive material)를 도포하는 공정을 포함하는, 반도체 패키지의 제조 방법이 제공된다.
본 발명의 또 다른 실시예에 따르면, 지지 기판, 지지 기판의 제1 주면(principal surface)에 형성된 기능 소자 및 제1 접합 요소, 수광 소자와 제1 접합 요소를 개재하여 지지 기판에 대해 대향하는 관계로 배치된 실링 기판(sealing substrate), 지지 기판의 제2 주면상에 제공된 제2 접합 요소, 지지 기판을 관통하도록 제공되고 제1 접합 요소와 제2 접합 요소를 전기적으로 접속시키게 구성된 관통 전극, 실링 기판 상에 제공된 렌즈 유니트 및 제1 주면 및 제2 주면과 직교하여 연장하는 지지 기판의 측면의 모든 면적에 코팅된 제1 전자기적 실드 막(electromagnetic shield film)을 포함하는, 광학 모듈이 제공된다.
본 발명의 반도체 패키지, 반도체 패키지의 제조 방법, 및 광학 모듈에서는, 지지 기판의 2개의 상이한 주면 상에 형성된 제1 접합 요소와 제2 접합 요소가 관통 전극을 거쳐 서로에 대해 전기적으로 접속되어 있다. 또한, 외부 접속 단자가 지지 기판의 제1 주면측으로부터 제2 주면측으로 인출되어 있다. 위에서 설명한 바와 같은 반도체 패키지 또는 광학 모듈의 측면의 모든 면적에 도전 재료가 도포되어 제1 전자기적 실드막을 형성한다.
제1 전자기적 실드 막은 발생할 가능성이 있는 반도체 패키지 또는 광학 모듈과 예를 들어 반도체 패키지 또는 광학 모듈이 장착되는 인쇄 기판 사이의 전자기적 간섭을 억제한다.
발명의 효과
본 발명의 반도체 패키지, 반도체 패키지의 제조 방법, 및 광학 모듈에 의해, 지지 기판의 상이한 주면들에 형성된 제1 접합 요소와 제2 접합 요소는 관통 전극을 거쳐 서로에 대해 전기적으로 접속되고, 반도체 패키지 또는 광학 모듈의 측면의 모든 면적에 도전 재료를 도포함으로써 제1 전자기적 실드 막이 형성된다. 이러한 방식으로 제1 전자기적 실드 막이 형성되므로, 전자기적 실드를 형성하기 위해 판금 등이 가공되는 대안적인 경우에 비해, 공정 수가 감소되고 비용이 감소될 수 있다. 그러므로 간단하고 쉬운 처리에 의한 저렴한 비용으로 인쇄 기판과의 반도체 패키지 또는 광학 모듈의 양호한 EMC가 유지될 수 있다.
본 발명의 상기 및 기타의 특징 및 장점은 다음과 같은 설명 및 첨부된 특허 청구의 범위를 첨부된 도면과 관련해서 읽으면 명백해질 것이다.
발명을 실시하기 위한 구체적인 내용
이하, 본 발명의 양호한 실시예에 대해 첨부 도면을 참조하여 상세하게 설명하겠다. 주목할 것은 설명이 다음과 같은 순서로 이루어진다는 것이다.
1. 실시예 (측면 및 후면에 전자기적 차광 실드 막이 형성된 카
메라 모듈의 예)
2. 변형례 (배선 층 형성 공정의 다른 예)
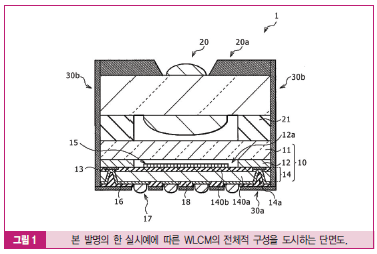
<실시예>
카메라 모듈(1)의 전체적 구성
그림 1은 본 발명의 한 실시 예에 따른 광학 모듈인 카메라 모듈(1)의 단면 구성을 나타내는 것이다. 그림 1을 참조하면, 카메라 모듈(1)은 예를 들어 이미지 센서 장치 등과 같은 광학 기기에 사용되고, 반도체 패키지인 웨이퍼 레벨 패키지(10)상에 통합된 렌즈 유니트(20)를 포함한다. 카메라 모듈(1)은 그 하면측, 즉 웨이퍼 레벨 패키지(10) 측에서 머더 보드 등과 같은 인쇄 기판상에 장착되어 있고, 그 상면측, 즉 렌즈 유니트(20) 측으로부터 빛을 입사시켜 수광하고 있다.
웨이퍼 레벨 패키지(10)는 지지 기판(14)과 실링 기판으로서의 글라스 기판(glass substrate)(11) 사이에 예를 들어 수광 소자(15)가 밀봉되어 있는 WCSP(wafer level chip size package)이다. 지지 기판(14)과 글라스 기판(11)은 그 주연부(peripheral edge portion)에서 접착 층(12)을 거쳐 서로에 대해 덧붙여진 것이다. 지지기판(14), 글라스 기판(11) 및 접착 층(12)에 의해 둘러싸인 영역은 수광 소자(15)을 기밀적(air tight)으로 밀봉하기 위한 캐비티(cavity)(12a)를 형성한다.
지지 기판(14)은 수광 소자(15) 등을 지지하는 기판이고, 예를 들어 실리콘 기판(140a) 상에 형성된 SiO2층(140b)을 포함한다. 지지 기판(14)은 다음과 같은 방식으로 구성된 전면, 즉 제1 주면 및 후면, 즉 제2 주면을 갖는다.

지지 기판(14)의 전면측의 구조
지지 기판(14)의 전면 또는 제1 주면상에는, 캐비티(12a)에 대해 대향하는 관계로 수광 소자(15)가 제공되며, 접착 층(12)에 대해 대향하는 관계로 제1 접합 요소인 복수의 전극 패드(13)가 제공되어 있다. 그림 2a는 지지 기판(14)의 전면의 평면 구성의 한 예를 나타낸 것이다. 그림 2a를 참조하면, 도시된 예에서는, 정사각 형상을 갖는 지지 기판(14)의 전면의 중앙 부근의 위치에 수광 소자(15)가 제공되며, 지지 기판(14)의 주위, 즉 지지 기판(14)의 주연(peripheral edge)을 따라 복수의 전극 패드(13)가 배치되어 있다. 주목할 것은, 수광 소자(15)와 전극 패드(13)의 사이의 영역에는 도시되지 않은 주변 회로가 형성되어 있다는 것이다.
전극 패드(13)는 수광 소자(15) 및 주변 회로에 도시되지 않은 배선에 의해 접속되어 있고, 수광 소자(15) 및 주변 회로에 전기 신호를 입력하거나, 수광 소자(15) 및 주변 회로로부터 출력되는 전기 신호를 추출하기 위한 외부 접속을 위해 이용된다. 전극 패드(13)는 예를 들어 알루미늄(Al) 등으로 형성된다.
수광 소자(15)는 예를 들어 CCD(Charge Coupled Device) 및 CMOS(Complementary Metal Oxide Semiconductor) 등과 같은 고체 촬상 소자다. 수광 소자(15)의 수광면에는 도시되지 않은 칼라 필터가 제공되어 있다. 수광 소자(15)에서는 전극 패드(13)를 통해 입력된 전기 신호에 응하여 노광 및 수광 신호의 판독이 행해지며, 판독된 수광 신호가 전극 패드(13)를 통해 외부로 출력된다.
지지 기판(14)의 후면측 또는 인쇄 기판 접합측의 구조
앞에서 설명한 바와 같은 구성을 갖는 지지 기판(14)의 후면측, 즉 제2 주면측에는, 제2 접합 요소인 복수의 땜납 볼(17)이 배치되어 있다. 또한, 땜납 볼(17)에 대응하는 개구를 갖는 실링 수지 층(18) 및 전자기적 차광 실드 막 또는 제2 전자기적 실드 막(30a)이 형성되어 있다. 그림 2b는 지지 기판(14)의 후면의 평면 구성의 한 예를 도시한다. 그림 2b를 참조하면, 도시된 예에서는, 지지 기판(14)의 정사각 형상의 후면에는 복수의 땜납 볼(17)이 소정의 피치(P)로 규칙적으로 배열된다. 땜납 볼(17)의 배열은 장착될 인쇄 기판(도시 안 함) 측의 접합 패드의 위치에 응하여 적절하게 설정된다. 따라서 전극 패드(13)의 땜납 볼(17)의 배열로 변환되고, 그것들이 마더 보드 등과 같은 인쇄 기판에 직접 장착될 수 있다. 주목할 것은, 그러한 배열에 따른 땜납 볼(17)이 지지 기판(14)의 후면의 중앙의 부근에 형성되지 않을지라도, 땜납 볼(17)이 지지 기판(14)의 중앙의 부근에 다른 방식으로 배치되거나, 후면의 주연 영역에만 배치될 수도 있다는 것이다.
땜납 볼(17)은 인쇄 기판에 장착되기 위한 외부 접속 단자로서 기능하는 것이고, 예를 들어 Sn-Ag-Cu 등과 같은 무연 고융점 땜납(leadless high-melting point solder) 등으로 형성된다. 땜납 볼(17)은 지지 기판(14)의 후면측에서 전자기적 차광 실드(30a)으로부터 돌출하도록 형성되어 있고, 아래에서 설명하는 재배선 층(16)을 거쳐 전극 패드(13)와 전기적으로 접속되어 있다.
실링 수지 층(18)은 예를 들어 에폭시계, 폴리이미드계, 실리콘계, 아크릴계 수지 등으로 이루어지며, 재배선 층(16)을 보호한다. 실링 수지 층(18)은 전자기적 차광 실드(30a)의 직경보다 큰 개구를 갖는다.
전자기적 차광 실드 막(30a)은 예를 들어 카본 블랙 등과 같이 예를 들어 도전성(예를 들어 저항치가 104Ω 이하) 및 차광성을 갖는 재료로 형성된다. 전자기적 차광 실드 막(30a)의 개구의 직경은 재배선 층(16)에 있어서의 아래에서 설명하는 땜납 랜드(solder land)(16c)의 직경보다 작게 설정되고, 전자기적 차광 실드 막(30a)의 두께는 땜납 볼(17)의 두께를 초과하지 않을 정도로 적절하게 설정된다. 주목할 것은, 전자기적 차광 실드 막(30a)이 도전성뿐만 아니라 차광성을 가질지라도, 전자기적 차광 실드 막(30a)이 적어도 도전성을 갖고 있으면, 전자기적 실드로서의 기능을 발휘할 수 있다는 것이다.
지지 기판(14)은 전극 패드(13)에 대응하는 위치에 제공되어 제1 관통공으로서의 역할을 하는 관통 비아(through-via)(14a)를 갖는다. 관통 비아(14a)는 지지 기판(14)의 전면으로부터 후면까지 관통해 있으므로, 전극 패드(13)의 일부가 후면측에 노출된다. 관통 비아(14a)의 내부에 형성된 재배선 층(16)의 일부는 노출된 전극 패드(13)의 전면을 덮도록 형성되어 있다. 또한, 재배선 층(16)은 관통 비아(14a)의 내부로부터 지지 기판(14)의 전면에 있어서의 땜납 볼(17)의 형성 영역까지 연장 또는 인출되어 있다. 관통 비아(14a) 및 재배선 층(16)은 본 발명에 있어서의 관통 전극의 구체적인 예에 상당한다. 주목할 것은, 지지 기판(14)의 후면과 재배선 층(16)의 사이에는 그림 1에는 도시되지 않았지만 아래에서 설명하는 절연 막(141) 및 시드 층(seed layer)(142)이 형성되어 있다는 것이다.
재배선 층(16)은 예를 들어 동(Cu),알루미늄,텅스텐(W),티탄(Ti),금(Au),니켈(Ni),은(Ag),몰리브덴(Mo),TiW 등과 같은 금속재료로 이루어진다. 세부사항은 뒤에서 설명하겠지만, 재배선 층(16)은 관통 비아(14a)의 내부를 덮는 패드 접속부(16a)와 땜납 볼(17)의 형성 영역으로 작용하는 땜납 랜드(solder land)(16c) 및 패드 접속부(16a)와 땜납 랜드(16c)를 상호 접속하는 인출 배선부(16b)를 포함한다. 그러한 구조를 갖는 웨이퍼 레벨 패키지(10)의 글라스 기판(11)에는 접착 층(21)을 개재하여 렌즈 유니트(20)가 덧붙여져 있다. 렌즈 유니트(20)의 상면에는 차광막(20a)이 소정의 패턴으로 형성되어 있다.
렌즈 유니트(20)는 일반적인 고정 초점 렌즈 또는 가변 초점 렌즈를 포함하고, 입사 광선을 수광 소자(15)에 집광시키는 기능을 갖는 것이다. 차광막(20a)은 원하는 방향으로부터의 광선만을 렌즈 유니트(20) 및 수광 소자(15)에 선택적으로 입사시키는 것이고, 예를 들어 크롬으로 구성되어 있다.
앞서 설명한 바와 같은 구성을 갖는 카메라 모듈(1)의 측면, 즉, 지지 기판(14)의 전면 및 후면에 직교하는 측면의 모든 면적에는 제1 전자기적 실드 막인 전자기적 차광 실드 막(30b)이 코팅되어 있다. 전자기적 차광실드 막(30b)은 전자기적 차광 실드 막(30a)과 유사하게 예를 들어 도전성 및 차광성을 갖는 재료로 구성되고, 예를 들어 5㎛~30㎛의 두께를 갖는다. 이 전자기적 차광 실드 막(30b)은 이후에 설명하는 바와 같이 측면에 대해 위에서 설명한 재료를 직접 도포함으로써 형성된다. 전자기적 차광 실드 막(30a,30b)은 지지 기판(14)의 후면측에서 서로 접속, 즉 전기적으로 접속되는 것이 양호하다.

카메라 모듈(1)의 제조 방법
앞서 설명한 바와 같은 카메라 모듈(1)은 예를 들어 아래에서 설명하는 바와 같은 방식으로 제조할 수 있다. 그림 3a 내지 그림 14b는 카메라 모듈(1)의 제조 프로세스를 예시한다.
1. 웨이퍼 덧붙이기 공정
우선, 전면에 수광 소자(15), 전극 패드(13) 및 도시되지 않은 주변 회로가 칩마다 형성된 지지 기판(또는 웨이퍼)(14), 및 글라스 기판(11)을 준비한다. 그리고 그림 3a 및 그림 3b에 도시된 바와 같이, 지지 기판(14)과 글라스 기판(11)를 접착 층(12)을 거쳐 서로에 대해 덧붙인다. 이 때, 지지 기판(14)의 전면의 수광 소자(15)의 형성 영역이 아닌 다른 영역, 즉, 다이싱 라인(dicing line)(DL)에 따른 영역에 접착 층(12)이 형성되어 수광 소자(15)를 캐비티(12a) 내에 밀봉한다. 그리고 지지 기판(14)의 후면, 즉, 실리콘 기판(140a))을 깎아서, 그림 3c에 도시된 바와 같이, 실리콘 기판(140a)을 얇게 한다. 주목할 것은, 그림 3b와 그림 3c에는 간편한 도시를 위해 웨이퍼의 일부의 단면 구성만 도시되어 있다는 것이다. 그리고 앞서 설명한 바와 같은 방식으로 글라스 기판(11)에 의해 밀봉된 지지 기판(14)에 있어서, 관통 비아형성, 절연 막과 시드 층 형성, 재배선 층 형성, 실링 수지 층 형성 및 땜납 볼 형성을 위한 공정들이 이 순서대로 웨이퍼 레벨, 즉, 다이싱에 의해 잘라내기 전 단계에서 행해진다. 설명한 공정을 도시하는 그림 4a 내지 그림 10의 단면도는 그림 3c에서의 영역S에 해당하는 부분만을 도시한다. 또한, 지지 기판(14)은 그 후면측이 위로 향하고, 그 전면측이 아래로 향하도록 도시되어 있다.
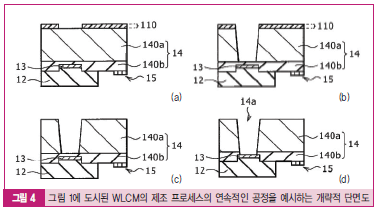
2. 관통 비아 형성 공정
우선, 그림 4a에 도시된 바와 같이, 지지 기판(14)의 후면에 포토레지스트 막(110)을 형성한 후, 전극 패드(13)에 대향하는 포토레지스트 막(110)의 위치들에서 패터닝(patterning)에 의해 개구들이 형성된다. 그리고 그림 4b에 도시된 바와 같이, 예를 들어 RIE(Reactive Ion Etching : 반응성 이온 에칭)에 의해, 지지 기판(14)의 실리콘 기판(140a)에서 전극 패드(13)에 대향하는 영역만을 선택적으로 제거한다. 그 후, 그림 4c에 도시된 바와 같이, 포토레지스트 막(110)을 지지 기판(14)의 후면으로부터 박리한다. 그럼으로써, SiO2층(140b)이 지지 기판(14)의 후면측에 노출된다. 그 후, 그림 4d에 도시된 바와 같이, 노출된 SiO2층(140b)이 예를 들어 RIE에 의해 전극 패드(13)의 전면까지 에칭된다. 그럼으로써, 전극 패드(13)에 대향하는 위치에서, 지지 기판(14)의 후면으로부터 전면까지 연장된 관통 비아(14a)가 형성된다. 다시 말해서, 전극 패드(13)가 지지 기판(14)의 후면측에 노출된다.

3. 절연 막 및 시드 층 형성 공정
그리고, 그림 5a에 도시된 바와 같이, 관통 비아(14a)가 형성된 지지 기판(14)의 후면의 모든 면적에서 예를 들어 SiO2로 된 절연 막(141)이, 예를 들어 CVD(Chemical Vapor Deposition : 화학증착)에 의해 형성된다. 그 후, 그림 5b에 도시된 바와 같이, 예를 들어 포토리소그라피(photolithography)에 의해 절연 막(141)의 관통 비아(14a)의 바닥이 선택적으로 제거되어 전극 패드(13)의 전면을 노출시킨다. 그 후, 그림 5c에 도시된 바와 같이, 절연 막(141) 및 노출된 전극 패드(13)를 덮도록, 예를 들어 구리로 된 시드 층(142)이 예를 들어 스푸터링(sputtering)에 의해 형성된다.
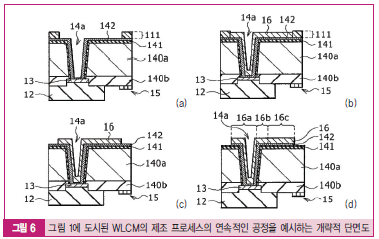
4. 재배선 층 형성 공정
그 후, 각각의 전극 패드(13)상의 한 위치로부터 관통 비아(14a)를 통해 지지 기판(14)의 후면측의 소정의 영역, 즉 땜납 볼(17)의 형성 영역까지 재배선 층(16)이 연속적으로 형성 또는 뻗어 있다. 구체적으로는 우선, 그림 6a에 도시된 바와 같이, 위에서 설명한 시드 층(142)상에 포토레지스트 막(111)이 형성되고, 재배선 층(16)의 형성 영역, 즉, 패드 접속부(16a),인출 배선부(16b)및 그림 6a 내지 그림 6d에는 도시되지 않은 땜납 랜드(16c)에 대응하여 개구를 형성하기 위해 패터닝이 수행된다. 그 후, 그림 6b에 도시된 바와 같이, 시드 층(142) 상의 포토레지스트 막(111)의 개구 부분에 예를 들어 전기 도금 등에 의해 위에서 설명한 재료 중 어느 것으로 이루어진 재배선 층(16)이 형성된다.
그리고 그림 6c에 도시된 바와 같이, 포토레지스트 막(111)이 박리된 후, 그림 6d에 도시된 바와 같이, 지지 기판(14)의 후면측에 노출된 시드 층(142)이 예를 들어 습식 세정(wet washing)에 의해 제거된다. 이러한 방식으로 지지 기판(14)의 후면측에 재배선 층(16)이 형성된다.
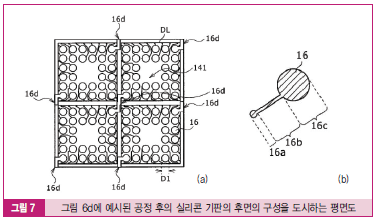
그림 7a에는 재배선 층(16) 형성된 지지 기판(14)의 후면측의 구성이 개략적으로 도시되어 있다. 주목할 것은, 간편한 도시를 위해, 서로 인접하게 배치된 4개의 칩에 대응하는 영역들만 도시되어 있다는 것이다. 또한, 그림 7b는 재배선 층(16)의 확대된 형태를 도시한다. 이 방식으로, 재배선 층 형성 공정에서는 상세하게는 관통 비아(14a), 즉, 전극 패드(13)에 대향하는 위치에 패드 접속부(16a)가 형성되고, 땜납 볼(17)에 대향하는 위치에 땜납 랜드(16c)가 형성된다. 또한, 패드 접속부(16a) 및 땜납 랜드(16c)를 서로 접속하기 위한 인출 배선부(16b)가 형성된다. 땜납 랜드(16c)는 인쇄 기판측의 접합 패드의 배열 등에 응하여 설정되는 위치에 형성된다.
인출 배선부(16b)는 땜납 볼(17)이 전극 패드(13)의 배열과 상이한 배열로 형성되는 것이 가능하게 한다. 그럼으로써, 외부 접속을 위한 단자들이 지지 기판(14)의 전면측의 전극 패드로부터 지지 기판(14)의 후면측의 땜납볼(17)로 변환되고, 땜납 볼(17)을 이용하여 인쇄 기판에 직접 장착하는 것이 가능해진다. 또한, 전극 패드(13)와 땜납 볼(17)의 개수에 대응하는 그러한 복수의 재배선 층(16)이 형성되지만, 재배선 층(16)의 일부는 인접하는 칩들 사이에서 서로 접속되도록 형성된다. 예를 들어, 각각의 칩의 코너 부분에서, 재배선 층(16)들이 서로 접속되어 있는 부분, 즉 실드 접속부(shield connection portion)(16d))가 형성된다. 그럼으로써, 아래에서 설명하는 다이싱 공정에서 각각의 칩을 잘라낼 때, 실드 접속부(16d)가 칩의 측면에 노출될 수 있고, 그럼으로써, 실드 접속부(16d)와 후 공정에서 측면에 형성되는 전자기적 차광 실드 막(30b) 사이의 전기적 접속이 이루어질 수 있다.
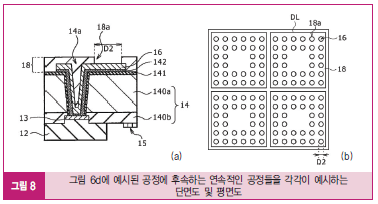
5. 실링 수지 층 형성 공정
그리고 그림 8a 및 그림 8b에 도시된 바와 같이, 지지 기판(14)의 후면의 모든 면적 위에 실링 수지 층(18)이 도포되어 형성되고, 예를 들어 포토리소그라피에 의해 재배선 층(16)의 땜납 랜드(16c)에 대향하는 영역에 개구(18a)가 형성된다. 개구(18a)의 직경(D2)은 예를 들어 아래에서 설명하는 전자기적 차광 실드 막(30a)에서의 개구(a1)의 직경보다 작게 설정된다.
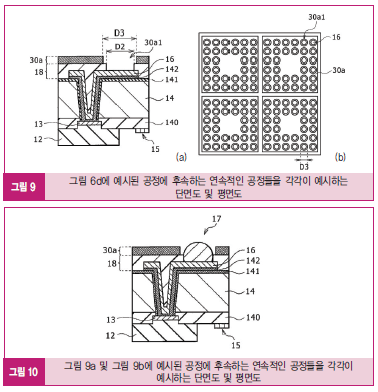
6. 전자기적 차광 실드 막(30a)(하면)의 형성 공정
그 후, 그림 9a와 그림 9b에 도시된 바와 같이, 실링 수지 층(18)의 모든 면적에 위에서 설명한 재료 중 어느 것으로 이루어진 전자기적 차광 실드 막(30a)을 형성하고, 포토리소그라피에 의해 땜납 랜드(16c) 및 실링 수지 층(18)의 개구(18a)에 대응하는 영역에 개구(31a)가 형성된다. 그 때, 개구(31a)의 직경(D3)은 실링 수지 층(18)에서의 개구(18a)의 직경(D2)보다 수십㎛ 정도 크게 설정하여 땜납 볼(17)이 거기에 접촉하지 않게 한다. 그러나 개구(31a)의 직경(D3)은 재배선 층(16)의 땜납 랜드(16c)의 직경(D1)보다 작게 설정되는 것이 양호하다.
개구(31a1)의 직경(D3)이 땜납 랜드(16c)의 직경(D1)보다 크면, 땜납 볼(17)의 주변 영역으로부터 인쇄 기판측으로의 빛의 누출이 발생하기 때문이다.
7. 땜납 볼 형성 공정
그리고 재배선 층(16)의 땜납 랜드(16c)에서 실링 수지 층(18)의 개구(18a) 및 전자기적 차광 실드 막(30a)의 개구(30a1)를 통해 노출되는 영역에 땜납 볼(17)이 형성된다.

8. 다이싱 공정
그리고 웨이퍼 레벨에서 땜납 볼(17)이 지지 기판(14)에 형성된 후, 그림 11에 도시된 바와 같이, 다이싱에 의해, 다이싱 라인(DL)을 따라 각각의 칩을 잘라낸다. 그럼으로써, 재배선 층 형성 공정에서 인접하는 칩들 사이의 접속을 위해 형성된 실드 접속부(16d)가 각각의 칩의 측면에 노출된다. 구체적으로는, 실드 접속부(16d)가 각각의 칩의 코너 부분(A)에 노출된다. 그림 12에 도시된 바와 같이, 이러한 방식으로, 웨이퍼 레벨 패키지(10)가 형성된다.
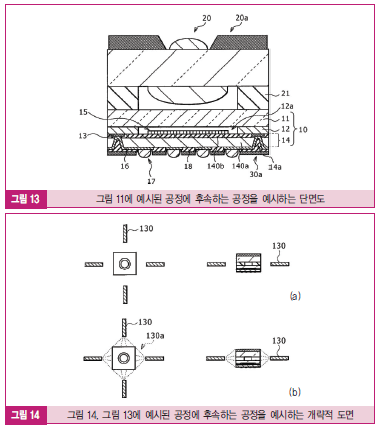
9. 렌즈 유니트 접합 공정
그 후, 그림 13에 도시된 바와 같이, 각각의 칩, 즉 각각의 웨이퍼 레벨 패키지(10)마다 렌즈 유니트(20)가 접착 층(21)을 거쳐 글라스 기판(11)에 덧붙여진다. 설명의 편의상, 렌즈 유니트(20)가 덧붙여지는 웨이퍼 레벨 패키지(10)는 이하 접합체라고 지칭된다.
10. 전자기적 차광 실드 막(30b)(측면)의 형성 공정
마지막으로, 예를 들어 카본 블랙 등과 같은 위에서 설명한 재료로 이루어진 전자기적 차광 실드 막(30b)이 앞에서 설명한 바와 같은 방식으로 형성된 접합체의 측면의 모든 면적에 예를 들어 도포 장치를 이용하여 분사 또는 도포함으로써 형성된다. 그 때, 접합체는 예를 들어 그림 14a에 도시된 바와 같이, 4개의 분사용 노즐(130)이 서로 직교하는 다른 방향을 따라 제공된 도포 장치 내에 배치된다. 그 후 그림 14b에 도시된 바와 같이, 카본 블랙(130a)이 노즐(130)으로부터 접합체의 4개의 측면 전체에 분사된다. 주목할 것은, 그림 14a와 그림 14b에서는 좌측에서 본 도면이 접합체의 상면을 도시하고, 우측에서 본 도면이 접합체를 측면으로부터 도시한다는 것이다. 그럼으로써, 접합체의 측면의 전체가 카본 블랙(130a)으로 된 전자기적 차광 실드 막(30b)으로 코팅된다. 여기에서, 측면에 노출된 실드 접속부(16d)가 전자기적 차광 실드 막(30b)으로 덮여 그 것들이 서로 전기적으로 접속된다. 그럼으로써, 그림 1에 도시된 카메라 모듈(1)이 완성된다.
인쇄 기판에의 장착
앞서 설명한 바와 같은 방식으로 제작된 카메라 모듈(1)을 장착하기 위해, 카메라 모듈(1)과 인쇄 기판이 웨이퍼 레벨 패키지(10)측을 아래로 향하고 땜납 볼(17)과 인쇄 기판상의 접합 패드가 서로에 대해 위치를 맞춘 채로 접합된다. 그리고 전자기적 차광 실드 막(30a,30b)은 예를 들어 인쇄 기판의 접지 단자에 접속됨으로써 전자기적 차광 실드 막(30a,30b)이 접지 전위로 유지될 수 있게 한다. 앞에서 설명한 바와 같이, 본 실시예에서는 지지 기판(14)의 전면측에 형성된 전극 패드(13)와 후면측에 형성된 땜납 볼(17)이 관통 비아(14a) 및 재배선 층(16)을 거쳐 전기적으로 접속되고, 지지 기판(14)의 전면측으로부터 후면측으로 외부 접속 단자가 인출된다. 다시 말해서, 외부 접속 단자가 전극 패드(13)로부터 땜납 볼(17)로 변환된다. 또한, 전자기적 차광 실드 막(30b)은 카메라 모듈(1), 즉, 웨이퍼 레벨 패키지(10))의 측면의 모든 면적을 도포함으로써 형성된다. 전자기적 차광 실드 막(30b)에 의해, 예를 들어 장착되는 인쇄 기판이나 세트 내의 기타의 부품 등에 의한 전자기적 간섭의 발생이 억제된다. 다시 말해서, 전자기적 실드를 형성하기 위해 판금 등을 가공하는 대안적인 경우에 비해, 공정 수를 줄이고, 비용을 줄일 수 있다. 그러므로 저비용 및 간단하고 쉬운 프로세스로 인쇄 기판과의 EMC를 양호하게 유지할 수 있다.
또한 전자기적 차광 실드 막(30b)이 도전성뿐만 아니라 차광성을 가짐으로써, 모듈의 측면으로부터 광선이 밀려드는 것이 방지될 수 있다. 카메라 모듈(1)의 측면은 흔히 지지 기판(14), 글라스 기판(11), 렌즈 유니트(20) 및 접착 층(21) 등과 같이 투명 재료로 구성되는 것이 일반적이므로, 측면에 형성되는 전자기적 차광 실드 막(30b)이 차광성을 갖는 것이 양호하다. 또한, 도포에 의한 형성이 가능하고, 도전성 및 차광성을 갖는 재료로서는 카본 블랙이 적절하다.
또한 전자기적 차광 실드 막(30a)이 지지 기판(14)의 후면측에 제공되므로, 인쇄 기판과의 전자기적 간섭이 더 효과적으로 억제된다. 구체적으로는 지지 기판(14)의 후면측에서는 패드 접속부(16a)와 땜납 랜드(16c)를 상호 접속하는 인출 배선부(16b)가 재배선 층(16)로서 형성되고, 때때로 인출 배선부(16b)와 인쇄 기판상의 배선 사이에 전기적 크로스토크(electric crosstalk)가 발생하며, 특히, 고속 신호 전송의 정확한 차동 전송에 실패하게 된다. 또한, 웨이퍼 레벨 패키지(10)에서는 땜납 볼이 칩 사이즈 내의 제한적인 영역 내에 배치되므로, 재배선 층(16)의 인출 배선부(16b)의 배선 루트가 제한된다. 그러므로 크로스토크를 억제하기 위해, 인쇄 기판 상의 배선위치가 조정될 필요가 있다. 그러나 이것은 층 수의 증가, 특히 핀 수의 증가가 있는 경우에는 소형화 추세를 유지하기 위해 비용 증가를 촉진할 가능성이 있다. 그러나 본 실시예에서는, 전자기적 차광 실드(30a)가 지지 기판(14)의 후면측에도 제공되므로, 위에서 설명한 바와 같은 크로스토크의 발생이 억제될 수 있다.
또한 이와 같은 전자기적 차광 실드 막(30a)이 도전성에 더해 차광성을 가지므로, 지지 기판(14)을 통한 인쇄 기판측으로 광선이 누출되는 것을 방지할 수 있다.

<변형례>
그림 15a 내지 그림 15d는 재배선 층(16)과 전자기적 차광 실드 막(30b) 사이의 통신을 설정하기 위한 다양한 방법의 프로세스를 도시한다. 앞서 설명한 실시예에서는 재배선 층(16)과 전자기적 차광 실드 막(30b) 사이의 통신을 설정하기 위해, 재배선 층(16)의 일부가 서로 인접하게 배치된 칩 사이에서 서로에게 접속되도록 형성되고, 다이싱에 의해 칩의 측면에 노출된다. 대조적으로, 본 변형례에서는 재배선 층(16)과 전자기적 차광 실드 막(30b) 사이의 통신을 설정하기 위해, 관통 비아 형성 공정에서 각각의 칩의 지지 기판(14)의 코너 부분에도 관통 비아가 형성되고, 일부의 재배선 층 부분은 재배선 층 형성 공정에서 관통 비아의 내부까지 연속적으로 형성된다.
구체적으로는, 그림 15a에 도시된 바와 같이, 지지 기판(14)의 후면에 관통 비아 또는 제2 관통공(14b)이 관통 비아 형성 공정에서의 관통 비아(14a)와 동시에 형성된다. 그러나 관통 비아(14b)는 그 각각의 코너 부분에서 서로 인접하게 배치된 4개의 칩의 중앙, 즉, 다이싱 라인의 교차점에 배치된다. 그리고 재배선 층 형성 공정에서, 그림 15b에 도시된 바와 같이 예를 들어 각각의 칩의 코너 부분에서 관통 비아(14b)의 내부까지 일부의 재배선 층(16)이 연속하여 형성된다. 재배선 층(16)의 그 부분은 실드 접속부(16d1)라고 지칭된다. 그 후, 실링 수지 층의 형성 및 전자기적 차광 실드 막(30a)의 형성이 위에서 설명한 실시예에서와 유사한 방식으로 행해진다. 그 후, 그림 15c에 도시된 바와 같이, 다이싱 라인(DL)을 따라 다이싱이 행해진다. 그럼으로써, 그림 15d에 도시된 바와 같이, 실드 접속부(16d1)가 각각의 칩의 4개의 코너에 노출된다. 그 후, 전자기적 차광 실드 막(30b)이 카메라 모듈의 측면에 도포됨으로써 형성되어 실드 접속부(16d1)를 전자기적 차광 실드 막(30b)에 전기적으로 접속한다.
재배선 층(16)과 전자기적 차광 실드 막(30b) 사이의 통신이 본 변형례에서처럼 관통 비아(14b)을 이용하여 설정될 수 있을 것이다.
본 발명의 실시예 및 변형례가 위에서 설명될지라도, 본 발명은 실시예 또는 변형례에 제한되는 것이 아니다. 특히, 카메라 모듈(1) 또는 광학 모듈의 구성, 그 제조 방법에 관한 절차 등은, 위에서 설명한 실시예 및 변형례에 의한 것과 유사한 효과가 성취될 수 있는 한, 자유롭게 변형될 수 있다. 예를 들어, 위에서 설명한 실시예 및 변형례에서는 도전성 및 차광성을 갖는 전자기적 차광 실드 막(30a,30b)이 각각이 본 발명의 제1 및 제2 전자기적 실드 막으로서 설명될지라도, 그것들이 적어도 도전성을 갖고 있으면, 본 발명의 효과가 얻어질 수 있다. 또한, 전자기적 차광 실드 막(30a,30b)의 사이로부터 적어도 카메라 모듈(1)의 측면측에 전자기적 차광 실드 막(30a)을 제공하는 것만 필요하고, 카메라 모듈(1)의 하면측, 즉, 지지 기판(14)의 후면측의 전자기적 차광 실드 막(30a)은 반드시 형성될 필요는 없다.
또한, 위에서 설명한 실시예 및 변형례에서는, 카메라 모듈(1)의 제조 방법으로서, 웨이퍼의 형태인 실링체로부터 잘라낸 각각의 칩 또는 웨이퍼 레벨 패키지(10))에 렌즈 유니트가 덧붙여진 후, 칩의 측면의 모든 면적에 전자기적 차광 실드 막(30b)이 형성된다. 그러나 렌즈 유니트가 제공되는 경우에는, 예를 들어 다음과 같은 방식으로 전자기적 차광 실드 막이 형성될 수도 있을 것이다. 구체적으로는, 각각의 칩의 잘라내기를 행한 후, 칩의 측면의 모든 면적에 전자기적 차광 실드 막이 형성될 수도 있을 것이다.
또한, 위에서는 수광 소자를 본 발명의 기능 소자의 예로 들면서 실시예 및 변형례를 설명할지라도, 기능 소자는 수광 소자로 제한되는 것이 아니며, MEMS소자 등일 수도 있을 것이다. MEMS소자의 반도체 패키지가 인쇄 기판에 장착되는 경우에도, 본 발명의 전자기적 실드 막이 이용되면, 인쇄 기판과의 전자기적 간섭의 발생이 억제될 수 있다.
