무연 솔더링 전환은 극도의 신뢰성을 요구하는 복합한 PCA의 변화를 의미하는 것은 아니다. 조사는 검증되었다. 이전의 장비 설정이 무연 솔더의 고온 요구에 대응할 수 있는 능력이 있다. 중간 및 고도의 복잡한 어셈블리에 대한 기본적인 무연 SMT 프로세스는 이전 SnPb 프로세스 파라미터를 이용하면서 발전되었다. 신뢰할 만한 두 번째 레벨 상호접합이 SnPb 프로세스 장비 설정과 무연 재료들과 호환이 가능하여 가능했다. (2012년 10월호에 이어서)
열 프로파일
10개의 히팅 존과 2개의 쿨링 존으로 구성된 컨백션 가열 노 방식인 BTU Paragon 150 모델이 적용한 이유는 DOE에서 혼합된 factor level에 대응하는 총 32개의 열 프로파일을 향상시키기 위해서였다. 열 프로파일과 관련 있는 factor level은 산업계 보고서의 피드백과 초창기 프로세스 검사단계 이전에 터득한 경험을 기반으로 하여 수립되었다.
우선, 여러 부품의 접합부의 온도들을 모니터했다. 초기 프로파일에서 수집한 최저 및 최고의 온도들은 보드 디자인에 포함된 가장 높고, 가장 적은 열에 노출된 부품들을 정의하기 위해 적용되었다. 이들 대조적인 패키지 사이에서 평균 측정치는 다양한 열 프로파일을 향상시키기 위해 적용되었다. 매 실험 조건을 위한 곡선의 특성은 각각 개별적으로 설정된 휴지 시간과 3℃/s 이하의 냉각-다운 램프 조건에 따라 실온에서 피크 온도로 올리는 리니어 히팅 램프를 이용하여 생성하였다. 그림 1에서는 실험에서 이용된 전형적인 무연 솔더링 열 프로파일을 보여주고 있다.

어셈블리
그림 2에서 보여준 양면 보드의 어셈블리 프로세스는 모든 테스트 조건을 대표하는 제조 플로우이다. 이전의 장비들-세트, 비세척 솔더 페이스트 및 Air 리플로우는 어셈블리 프로세스 내에서 핵심 요인들이다. 보드들은 프로세스 사이마다 시각 검사가 이뤄졌고, 품질 데이터가 매 프로세스 단계별로 기록되었다. 리플로우 프로세스 이전, 어셈블리에서는 자동광학 검사 설비들을 이용해 검사되었다. 무연 합금의 영향이 이 프로세스에서 어떻게 작용하는지를 분석하였다.
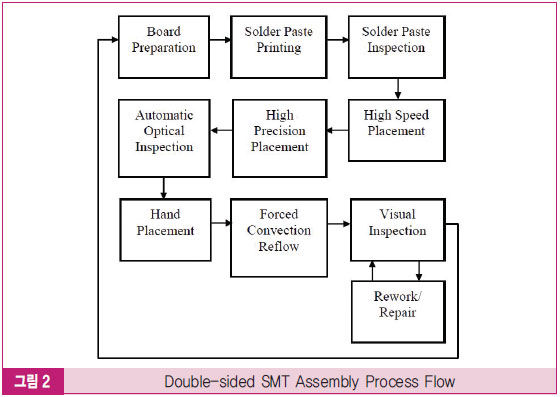
최종적으로, 모든 보드들은 라미노그래프 X-Ray를 이용하여 검사되었다. X-Ray 데이터 또한 수집되었다. 내적으로는 향상된 다변량해석 소프트웨어가 데이터 분석과 잠재적인 기계적인 불량을 결정하기 위해 이용되었다. 소프트웨어에 의해 수집된 분석 및 결과물은 결국 프로세스 결함에 직결하는 ATC 불량과 관련하여 이용하였다.
ATC 테스트 방법들
ATC 테스트는 열피로에 대한 저항을 결정하기 위해 어셈블리의 하나의 세트에 실행되어졌고, 그래서 접합의 품질이 각 세트의 DOE 조건이 생성되었다. 선택된 온도 범위는 보드에서 측정한 일반적인 0~100℃이었다. 32개 보드에 대량의 열량은 원하는 대로 10분 램프를 하지 않았으며, 램프는 거의 15분으로 더 길게 했다. 높은 온도에서 10분 유지하였으며, 이는 50분 사이클 결과가 나왔다.

2개의 HP E1346A 데이터 수집 시스템을 지닌 Thermotorn 챔버가 실험에서 사용되었다. 데이지체인을 위한 패키지 선택, 지속적인 저항 모니터링은 표 1에 나열하였다. 테스트 된 다양한 부품을 위한 데이지체인은 1.25~2.70Ω의 저항범위를 가지고 있다. 간단하게, 5Ω의 단일고장기준은 솔더 접합부의 예상된 불량을 고르기 위해 선택했다. 이 기준은 IPC-9710 스펙에서 특징지어진 20% 상승보다 다소 덜 민감한 60~100% 저항 상승을 나타낸다. 이 차이는 본고에서 발견된 부분에서 영향을 미치지 않았다.

리드-프레임 패키지 솔더 접합부의 열 피로 성능은 3014 ATC 열사이클 완료이후의 액체침투분석(dye & pry)으로 표시된 크랙에 의해 평가되었다. 액체침투단상에 적용된 리드-프레임 패키지는 표 2에서 보여주고 있다.
불량 분석 방법들
ATC 테스트 목적으로, 테스트 패키지 어셈블리용 실패 모드를 결정하기 위해 두 개의 독립된 기술들을 이용하여 진행되었다. 첫 번째 기술에는 패키지 어셈블리를 크로스-섹션하였고, 크랙 발생 혹은 보이드와 같은 다른 징후들을 확인하기 위해 표준 금속조직 기술들을 이용하여 이들을 검사하였다. 두 번째 방법은 액체침투분석(dye & pry)이다. 이러한 경우에, 열 사이클 목적으로 진행된 테스트 어셈블리는 마킹 액체의 욕조에 담궈졌고, 초음파 진동을 실시한 후 말렸다. 그런 후 어레이 패키지는 PCB에서 패키지를 떼어 내기 위해 Instron 기계적 테스트 머신으로 3개의 지점을 밴딩하였다. 리드-프레임 패키지는 평면 툴을 지닌 dye stain 분석에 따라 보드로부터 떼어졌다. 그래서 솔더 접합부 내의 크랙 존재는 저전력 마이크로스코프 하의 시각검사에 의해 결정되었다. ATC 테스트에 의해 밝혀진 이미 존재해 있는 크랙은 접합부 표면에 밝은 빨간 색의 염료로 나타난다.
결과 & 논의
테스트 시료 디자인
일반적으로, PCB 재료(High Tg FR-4) 성능은 두 개의 리플로우 가열 사이클 이후에 겨우 사용할 수 있었다. 일부 변색, 박리 및 휨 레벨이 보드의 표면과 가장자리에서 나타났다. 이 타입의 재료는 복잡한 무연 어셈블리의 제조에 사용할 수 없음을 알 수 있었다. 쓰루홀 비아 무결성은 여전히 연구 중에 있다.
무연 솔더 접합부의 시각 검사
리플로우 이후에 모든 테스트 시료들은 시각 검사를 실시했다. 솔더 브릿지, 오픈, 톰스톤 등과 같은 기계적인 불량에 대해 어떠한 예외가 발생하지 않았음이 판명되었다. 일반적으로 두 개의 PCB 마감재(OSP & 전기 니켈/금 도금)는 비슷한 행태를 보였다. SnPb 합금의 젖음성과 비교했을 때 젖음 부족은 두 개의 PCB 마감재에서 나타났다. 무연 SAC 합금은 전기 니켈/금 도금에 비해 OSP 표면 마감 처리된 랜드 패드 젖음에서 심각한 감소를 보였다. 초창기 프로세스 평가 동안 무연 접합부의 형상은 논의했던 것과 같이 매우 비슷했다. 모든 접합부는 그림 2에서 보는 바와 같이 무디고 거칠어 보였다.
불량 분석 결과들
데이지-체인 어레이 패키지들
염료 침투와 종단면 절단 방법 모두를 사용하야 불량 BGA-280 패키지의 작은 단편부분에서 불량 분석이 실행되었다. 그림 3에서 보는 바와 같이, 이들 분석에서는 지적하고 있다. ATC 내의 불량은 패키지 위의 패드와 연동 된 근처의 접합부 내의 솔더 피로도에 의해 발생되었다.
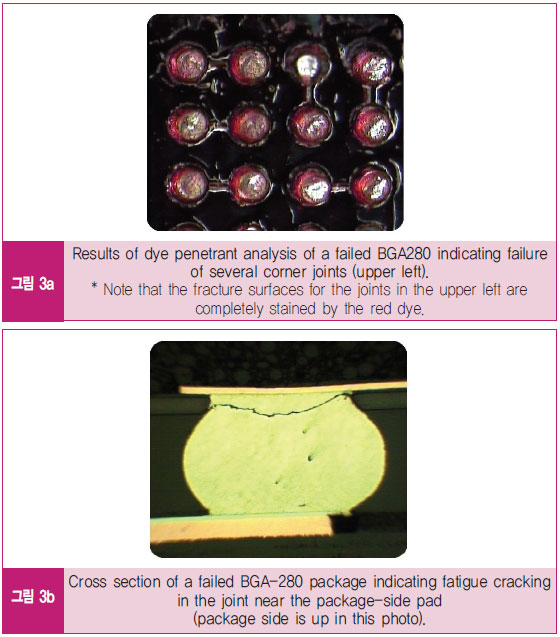
BGA-256 패키지는 ATC 테스트에서 커다란 부분의 ‘초기’ 불량이 존재한다. 불량 분석에서는 이들 패키지가 SnAgCu 보다 SnPb 솔더 볼이 잘못 제공되었음을 보여주었다. 이러한 사실은 SEM 내의 종단된 접합부를 X-Ray 분광기로 이용하여 결정되었다. 그림 4는 이들 접합부 내 Pb-rich phase의 전형적인 X-Ray 스펙트럼의 예를 보여주고 있다.
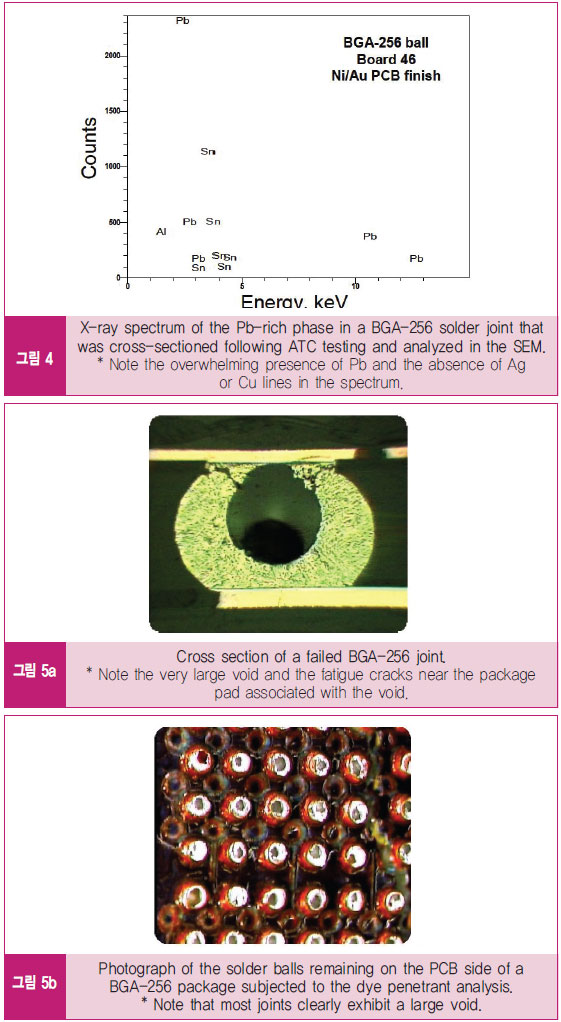
접합부의 미세구조의 분석에 의한 이 분석을 기반으로 하면, 이들 BGA 솔더 볼들은 분명한 SnPb 재질로 되어 있다.
게다가 염료침투법과 종단면 분석법을 이용한 BGA-256 패키지의 분석에서는 ATC 불량이 패키지 패드 근처 접합부 내의 크랙 시작과 확산에 의해 유발된다는 점을 보여주고 있다. 대부분의 경우, 이들 불량은 그림 5에서 나타내는 바와 같이 커다란 보이드와 관계가 있다. 그림 5a에서는 보여주고 있다. 비록 매번은 아니지만 커다란 보이드는 피로 크랙과 주로 관계가 있으며, 그들의 존재가 최소한 부분적이나마 초기 ATC 불량에 책임이 있음을 유추할 수 있었다. 그림 5b에서는 SAC 솔더 페이스트를 이용한 어셈블리에서 이들 패키지 내에 이러한 커다란 보이드의 존재가 매우 일반적임을 보여주고 있다. 이러한 보이드들은 ATC 테스트 동안 다른 두 개의 패키지(초기 불량이 나타나지 않았던) 모니터링에서는 나오지 않았다.
보이드는 SnPb 솔더 프로세스 조건 하에서 SnPb 솔더 페이스트를 이용한 초창기 Yunque 방식 어셈블리에서는 발견되지 않았다. 이는 커다란 보이드와 ATC 내의 초기 불량이 SAC 솔더 페이스트와 SnPb 솔더볼을 함께 사용한 결과이고, SMT 프로세스 조건과 관계있음을 유추할 수 있었다. 보이드 생성의 근본적인 원인은 조사 중이다.
리드-프레임 패키지
ATC 테스트 동안 리드-프레임 패키지가 전기적으로 관찰되지 않았기 때문에, 이들의 열피로 저항은 사이클링 완료에 따른 염료 침투 분석을 이용하여 평가했다. 이 분석에서는 이들 패키지가 접합부의 근소한 하락과 함께 3014 열 사이클을 견뎌냈다고 지적했다. 이 발견은 다음 섹션에 설명한 예외로 하여 모든 DOE 조건이 어셈블리에 적용하였다. 많은 접합부들이 보드로부터 패키지를 떼어내는 프로세스가 솔더 접합부에서 균열보다 오히려 패키지 몸체로부터 분리되어 유발하는 ATC와 같은 수준 그대로 있다. 다른 접합부의 경우, 피로 크랙이 접합부의 힐 부분에서 나타났지만, 어떠한 크랙도 접합부의 풋 혹은 토어에서 나타나지 않았다. 리프-프레임 패키지 솔더 접합부가 ATC 테스트 내에서 아주 우수했기 때문에 다양한 DOE 파라미터의 기능으로써 접합부 품질 혹은 성능이 확실하게 구별되지 않았다.
통계 분석
ATC 열 사이클이 3014 사이클에서 멈췄다. 일부 불량이 실험의 ‘가장자리 부분’에서만 나타났고, ‘면의 중심’ 실험 조건에서는 어떠한 불량도 보이지 않았다. 어떤 경우에도, 실험 반응은 부품의 수명에 공헌하는 Weibull 가정에 따라 각 패키지마다 축적되었다. 각각의 실험으로 만들어진 최상의 관측은 제로 불량임을 알아야 한다. 이러한 경우, 파라미터들을 측정하기 위한 전통적인 방법(Maximum Likelihood Estimators)이 적용되지 않았고, 그래서 전자부품 형상 파라미터 (β)에 대한 최악의 HP 역사적 수치, 스케일 파라미터 (θ)에 대한 수치의 가정에 따라 실험 내에서 제로 불량의 50% 기회가 추정된다고 평가되었다.
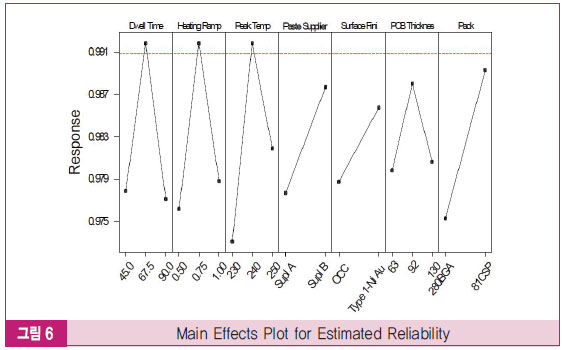
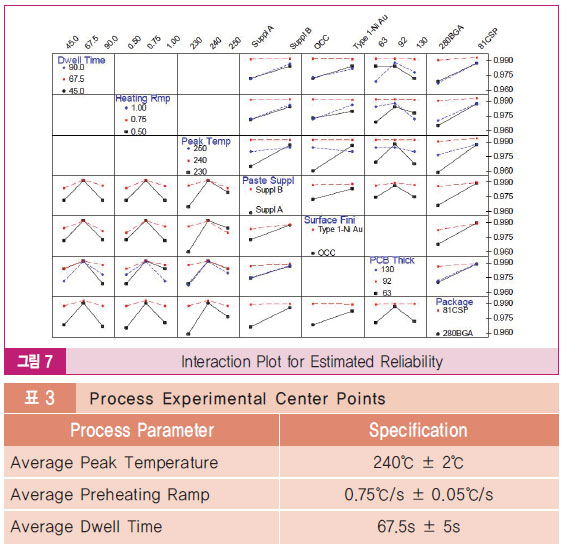
1820 사이클에서 99% 신뢰성의 초기 수치가 요구되고 있으며, 다행히도 열 프로파일의 중앙 부분내 평가된 신뢰성은 이산 요인들(그림 6 및 그림 7 참조) 레벨의 독립적인 수치가 초과되었다. 심지어 실험 요인들의 서로 다른 레벨 사이에서 수치 차이가 있음에도 불구하고, 극한적인 레벨 사이에서 만족할만한 차이가 없었다. 그런데, 중앙 부분이 가장자리 부분보다 더 활성화되었음을 의미하는 중요한 굴곡이 있다.
염료 침투 테스트는 ATC 내에서 지속적으로 테스트되지 않은 다른 패키지에 대한 실험적인 가장자리 부분의 소형 샘플이 만들어졌다. 결과는 LQFP 타입 부품에 대한 11 부품 테스트에서 제로 불량이었다. 그런데, 불량이 실험적인 가장자리 부분 내에서 테스트된 44개(3개의 동일한 보드)의 TSOP 부품들 중 4개에서 나타났다. 리드 패키지에 대한 데이터는 비공식적으로 분석되었다. 그래서 가장자리 부분에서 소수의 불량들은 실험적인 중앙 부분 내의 보다 신뢰할만한 솔더 접합부만큼 적합하게 보였다.
요약 및 결론
무연 솔더링 전환은 극도의 신뢰성을 요구하는 복합한 PCA의 변화를 의미하는 것은 아니다. 조사는 검증되었다. 이전의 장비 설정이 무연 솔더의 고온 요구에 대응할 수 있는 능력이 있다. 중간 및 고도의 복잡한 어셈블리에 대한 기본적인 무연 SMT 프로세스는 이전 SnPb 프로세스 파라미터를 이용하면서 발전되었다. 신뢰할 만한 두 번째 레벨 상호접합이 SnPb 프로세스 장비 설정과 무연 재료들과 호환이 가능했다. 어셈블리 프로세스는 수용 가능한 품질 레벨의 수율을 낸다. 무연 솔더링 접합부 형상은 잘 알려진 SnPb의 밝은 접합부와 다르다. 모든 실험 조건에서 접합부는 둔하고 거칠어 보였다. 그러나 이 형상은 접합부 특성에 영향을 미치지 않는다. 비록 부품 들뜸이 2번의 리플로우 사이클 이후 평균 250℃의 피크 온도에서 나타나지 않았더라도, 품질 보장을 위해 그리고 부품의 내재성을 보장하기 위해 추가적인 작업이 요구될 것이고, 그래야만 최종 어셈블리의 품질과 성능을 보장할 수 있다.
소프트웨어 프로그램의 일부 조정이 필요하지만 SnPb 프로세스에 사용되었던 검사기 설정이 여전히 무연 솔더 접합부 검사에 적용될 수 있는지 판단되었다. X-Ray 라미노그래피를 이용한 무연 솔더 접합부에서 솔더 보이드 증가가 나타났다.
일정 부분은 수용할만한 사이즈 범위 내라고 평가되었고, 반면 다른 부분들은 SnPb 접합부의 오늘날 수용 가능한 카테고리 IPC A-610(12.2.12)을 충족시키지 못한다. ATC 결과에서는 SnPb 접합부와 비교한 열 피로 부분에서 무연 솔더 접합부가 잠재적으로 더욱 방해한다고 나타내었다. 모든 이산 요소들의 설정 시간 안에 프로세스 중앙 부분에서의 동작이 평균 신뢰도 >99%을 생성할 것이라는 만족할 만한 분석물을 도출할 수 있었다. 그래서 고도의 복잡한 어셈블리의 신뢰할만한 무연 SMT 프로세스는 상응 중앙부분에서 설정된 실험 프로세스 파라미터에 의해 이루게 되었다(표 3 참조).
다음 단계들
무연 프로세싱과 관련한 변화는 여전히 연구 중이다. 전체 프로세스의 특성과 증진이 일관된 품질과 성능의 제품을 보장하도록 요구될 것이다. Rework, 쓰루홀 솔더링, 인-서킷 테스트 등과 같은 또 다른 프로세스에서 무연 솔더링이 미치는 영향에 대해서도 연구가 많이 진행되었다. 무연 솔더링 기술의 요구와 PCB 디자인의 복잡성에 상응한 기술발전이 프로세스에서 필요하다. 또한, 무연 프로세스와 부품 공급업체들의 무연 부품으로의 전환이 어떠한 영향을 끼칠지를 정확하게 이해하는 게 중요하다. 리드-프레임 혹은 어레이 마감재도 무연 전용으로 전환해야 할 뿐만 아니라 패키지도 반드시 고온에 견딜 수 있어야만 한다. 초창기 연구 결과에 기반하여 일부 부품에서는 품질 및 신뢰성(lead-free 1.27 mm pitch CBGAs)을 충족시키지 못하는 위험에 직면해 있을 수도 있음을 알 수 있었다. 또한 추가적인 테스트로는 여러 번의 고온 노출 이후의 장기적인 장비-세트의 안정성이 요구될 것이다.
