50㎛ 두께 스텐실의 원형 개구, 응력 20% 감소
전단 속도 높으면, 샘플 점도가 낮아져 양호한 개구 충진
ICA(Isotropic Conductive Adhesive)의 성공적인 프린트는 90㎛ 피치에서 일관된 인쇄가 이뤄졌고, 이를 가지고 50㎛ 피치까지 인쇄되었다. 본딩 재료 증착 도중의 유체 유동 역학 측면에서 마이크로-엔지니어링 스텐실의 성능은 다중 물리 시뮬레이션과 모델링(multi-physics simulation and modeling)을 활용하여 개선시켰다. 페이스트 롤링의 유변학적 테스트도 수행되었다. 현재 개발된 전산모델은 가능한 공정 취약성 식별에 도움이 되는 언더필 특성을 갖는 마이크로시스템 어셈블리 프로세스의 신뢰성을 예측하기 위해 사용되었다. 개발된 패키징 프로세스의 구현 가능성을 입증하기 위해 엔드유저용 프로토타입 칩이 어셈블리되었다.
영국 공학자연과학연구재단(EPSRC)의 후원을 받은 MAT21 프로젝트는 마이크로시스템 및 플립칩 기술을 대량 수탁생산 업체의 어셈블리 라인에 사용할 수 있도록 하는 것을 목표로 한다. 이 기술은 플립칩 애플리케이션을 기반으로 두고 있으며, 미래의 MEMS 기술 시장을 고려해 최첨단 어셈블리 및 패키징 프로세스를 향한 발걸음으로 간주할 수 있다. 프로젝트는 현재 이용 가능한 것보다 1차 크기의 길이 스케일로 스텐실 인쇄를 사용하여 초미세 서브-100㎛ 피치 연결을 위해 상업적으로 실행 가능한 프로세스를 제공하고자 한다. 두 대학(Heriot-Watt과 Greenwich)의 프로젝트 컨소시엄은 마이크로 시스템 제조, 재료 과학 및 전산 모델링과 관련된 연구 프로그램에 동참했다. 컨소시엄에는 전자제품 패키징 관련 여러 업체들이 참여하였다.
본고에서는 보고된 중요한 결과는 20㎛ 피치에서 10㎛까지의 반복 가능한 개구 크기와 10㎛ 웹까지의 차세대 전기 주조 스텐실의 개발을 포함하고 있다.
실버 충진 등방성전도접착제(ICA, Isotropic Conductive Adhesive)의 성공적인 프린트는 90㎛ 피치에서 일관된 인쇄가 이뤄졌고, 이를 가지고 50㎛ 피치까지 인쇄되었다. 본딩 재료 증착 도중의 유체 유동 역학 측면에서 마이크로-엔지니어링 스텐실의 성능은 다중 물리 시뮬레이션과 모델링(multi-physics simulation and modeling)을 활용하여 개선시켰다. 페이스트 롤링의 유변학적 테스트도 수행되었다. 현재 개발된 전산모델은 가능한 공정 취약성 식별에 도움이 되는 언더필 특성을 갖는 마이크로시스템 어셈블리 프로세스의 신뢰성을 예측하기 위해 사용되었다. 개발된 패키징 프로세스의 구현 가능성을 입증하기 위해 엔드유저용 프로토타입 칩이 어셈블리되었다.
서문
마이크로시스템 제조의 빠른 성장률(연간 30%)은 전세계 제조 산업계를 빠르게 성장시키고 있다. 전자기기 소형화와 고성능화 추세는 기술과 사회 모두를 크게 변화 시켰다. 예를 들어 고성능 컴퓨팅 시스템, 휴대전화 및 시청각 기기들이 대표주자들이다. 센싱과 작동과 관련한 마이크로시스템 기술 연구는 많은 대학과 소형 부품을 생산하는 소수의 회사들이 진행해 왔다. 일반적으로 마이크로시스템 부품은 대량 생산되는 상용 기기에 적용하는 방법을 찾지 못했다. 비용 효율적인 패키징과 표준 마이크로전자산업계의 어셈블리는 중요한 걸림돌이 존재하고 있기 때문이다(자동차 에어백의 가속도계에서의 사용 예외). 도전 과제는 이제 그러한 기술을 상용적인 CEM(Contract Electronic Manufacturing) 어셈블리 라인에 접목시키는 것이다. 이를 달성하기 위해서는 시스템 내에 마이크로디바이스를 통합을 위해 플립칩 본딩 기술을 사용해 호환 가능하고, 비용 효율적이고, 프로세스 루트가 필요하다. 플립칩은 전자기기 내의 인쇄회로기판에 고밀도 어셈블리 구현을 위한 본딩 기술로, 가장 빠르게 성장하고 있다. 플립칩 상호연결기술의 확산은 증발, 전기도금, 접착제 디스펜싱, 솔더 제팅, 스터드 범핑 및 스텐실 프린팅과 같은 전자 제조 산업계에 의해 발전되어 왔다. 각 프로세스는 기술 잠재력, 제조비용 그리고 테스트 측면에서 유리한 속성을 가지고 있다. 그러나 SMT을 기반으로 하는 전통적인 CEM 어셈블리에서는 대부분 스텐실 프린팅을 사용하는 성능, 설비 및 소모품 중심으로 구축되었다.
스텐실 프린팅은 플립칩 상호연결에 있어서 가장 경제적인 솔루션으로 입증되었다. 스텐실 프린팅은 전도성 접착제의 침전이 가능하여 저온 본딩의 조력자로써의 역할도 수행한다. MAT21(MicroSystems Assembly Technology for the 21st Century) 프로젝트는 저비용 플립칩 어셈블리를 활용하여 마이크로시스템 기반 부품을 통합하는 프로세스 루트를 확인하기 위해 결성되었다. 프로젝트에서는 기판에 접착제를 인쇄하기 위해 마이크로시스템 기술을 채택하였고 초미세 개구(<50㎛)의 스텐실을 제조하였다. 스텐실을 통해 접착용 범프가 인쇄된 기판은 서브-100㎛ 피치에서 마이크로시스템 칩(MEMS, MOEMS 등) 상호연결이 가능한 플립칩 어셈블리 기술이 활용된 마이크로시스템 디바이스 결합에 사용될 것이다.
해당 프로젝트의 목표는 다음과이 잡았다.
▶ 서브-100㎛ 피치에서 서브-50㎛ 직경의 범프를 인쇄할 수 있는 전기주조 스텐실 제조.
▶ 본딩 재료의 증착 동안의 유체 유동역학의 관점에서 미세 가공된 스텐실의 성능을 예측하기 위한 수치 모델링 기술의 개발 및 검증.
▶ 새로운 전도성 접착제로 플립칩 본딩을 기반으로 하는 후처 리 공정이 없고, 환경 친화적인 저온(T<100℃) 어셈블리 기 술을 구현하여 저온의 유기체 및 적절한 멤브레인 기판에 마이크로시스템 칩을 결합.
▶ 언더필 특성으로 이 마이크로시스템 어셈블리의 신뢰성을 예측하기 위해 현재 모델의 사용과 확대 그리고 프로세스 약점을 확인.
▶ 일반 프로세스의 산업계에 대한 권장사항은 상업용 제품군 에 다양한 유형의 마이크로시스템 부품과 마이크로시스템 기술의 통합.
그림 1에서는 프로젝트의 3단계를 보여 주고 있다.
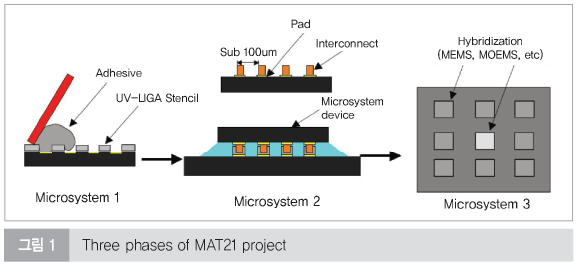
Sub-100㎛ 피치 스텐실 프린팅 - 첨단 스텐실 제조
스텐실의 목적은 솔더페이스트, 전도성 접착제 또는 다른 유사한 물질을 개구 오프닝을 통해 해당 기판 상에 이송하는 것이다. 통상적인 스텐실 제조 기술력은 130~150㎛ 피치 이하로 확실하게 인쇄가 가능한 스텐실을 생성하는 게 쉽지 않다.
화학 에칭 단계의 언더커팅(undercutting) 가공물은 미세 피치를 가능하게 하는데 필요한 미세한 웹 간격의 생성을 억제한다. 레이저 커팅은 원하는 직경의 개구를 없앨 수 있지만, 호일과 레이저 간의 상호작용으로 완벽하게 규정되고 반복적인 개구 형성을 허용하지 않는다. 또한 레이저 커팅은 순차적인 프로세스로 진행된다. 그래서 피치가 줄어들고, 개구의 수가 늘어나면 제조 시간이 비 경제적으로 증가한다. 전기주조 스텐실을 생산하는 현재의 제조 방법은 여전히 서브-100㎛ 스텐실 제조에 적합하지 않다.
도금된 금속 웹(개구 간의 금속 공간)의 불균일한 두께 분포는 스텐실 내에서 약한 반점을 유발한다. 그래서 웹을 약 60㎛으로 제한했다. 또한 리소그래피 단계에서는 서브-50㎛ 직경 개구 제작용 적절하게 정확한 금형을 만들지 않았다.
그림 2의 (a)와 (b)에 나타난 스텐실은 반복적이고 저렴한 비용의 새로운 미세 가공 프로세스를 사용하여 제작되었다. 이 프로세스는 현재 Heriot Watt University에서 특허를 취득했으며 MicroStencil Limited라는 회사를 통해 상용화되었다. 완벽하게 수직적인 측면은 생성되었다. 적용 포토레지스트 타입 및 노광 소스의 높은 시준(collimation)이 활용된 고유의 프로세스 때문이었다. 스텐실은 전기주조 프로세스 동안 레지스트 측벽에 따라 근접한 개구와 함께 제조된다.
새로운 전기주조 프로세스는 전체 스텐실에 걸쳐 균일한 분포가 가능해 원하는 금속 특성을 생성한다. 스텐실을 제조하는데 사용되는 맞춤형 설비는 고도로 시준된 노광 건(highly collimated exposure gun)과 닥터 블레이드 기계(doctor blade machine)가 포함된다. 레지스트는 나이프-에지(knife-edge)와 마이크로포지셔너(micropositioner)로 구성된 스프레딩 설비(spreading machine)로 코팅된다. 마이크로포지셔너는 정확하고 균일한 두께의 포토 레지스트가 웨이퍼 전체에 걸친 증착을 가능하게 한다. 나이프 코팅은 스핀 코팅보다 두꺼운 포토 레지스트의 평면 레이어에 적용하는 것이 좋다. 이는 두꺼운 포토 레지스트의 높은 점도, 솔벤트 증발 및 스핀 코팅 공정에서 웨이퍼의 가장자리 부문에 생성된 비딩 효과 때문이다.
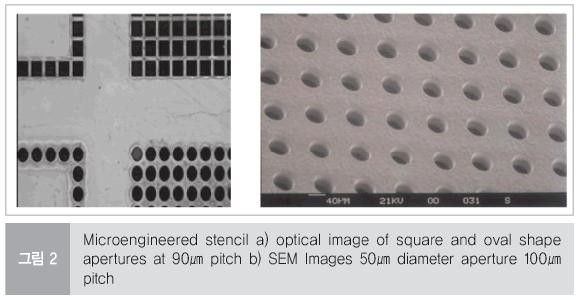
새로운 전기주조 공정은 스텐실의 표면 거칠기(surface roughness)를 부분적으로 제어할 수 있다. 일관된 안정적인 프린팅 결과를 얻기 위해서는 페이스트가 스텐실 표면 전체에 걸쳐 고르게 롤링되어야 한다. 롤링 운동은 스퀴지의 구동력과 스텐실 표면의 저항으로 인해 발생한다. 스퀴지 힘과 횡 방향 운동은 프린팅 공정 동안에 스텐실 표면을 세척한다. 그 예로써, 그림 3에서는 매끄러운 스텐실의 표면과 거친 스텐실의 비교를 보여주고 있다.

스텐실 변형 모델링
파라미터화된 스텐실의 유한요소모델(FEM, finite element model)은 스텐실 응력 수준과 프레임 및 프린팅 힘에 기인되는 변형을 조사하기 위해 설계되었다. 프로젝트의 주된 관심사는 탄성 변형(결국에는 패드에 인쇄물의 오정렬을 유발할 수 있는)을 통해 스텐실에 유발될 수 있는 손상의 수준이었다. 스텐실 피치, 개구 모양, 개구 직경 및 힘의 크기는 50㎛ 두께 스텐실에서 매우 작은 피치 치수로 소형화되는 추세 특색에 맞게 모델링되었다.
모델은 개구 피치 200㎛ 이하의 개구 피치를 지닌 80㎟ 스텐실에서 20㎛ 변형만 유도되었으며, 개구 직경과 프레임 장력은 각각 50㎛와 38N/㎝로 일정하게 유지되었다. 200㎛ 이하로 피치가 줄어들면 미만의 피치를 줄이면 평면 변형의 비선형 증가 결과가 나온다(그림 4의 (a) 참조). 시연된 최고의 응력 수준은 웹 중간, 개구부 사이에 집중되었다. 그림 4에서 보는 바와 같이 서버-100㎛ 피치 범위로 이동할 때 변형이 더욱 크게 증가하기 시작했다. 스텐실에서 탄성 변형만을 모델링 연구에서 감지한다는 점이 중요하다.
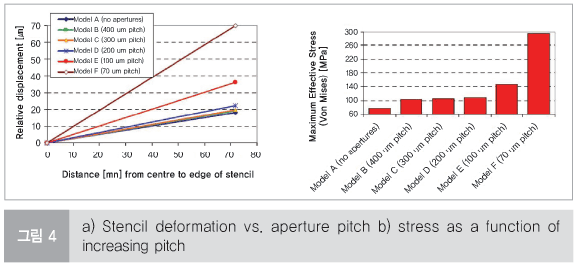
그림 5의 (a)는 개구 직경이 감소되고 피치가 100㎛로 일정하게 유지될 때 유효 응력의 비선형 감소를 나타내고 있다. 원형 개구 모양이 스텐실에 유도된 응력을 사각형 개구 모양과 비교해 18% 감소시킴을 발견했다(그림 5의 (b) 참조).
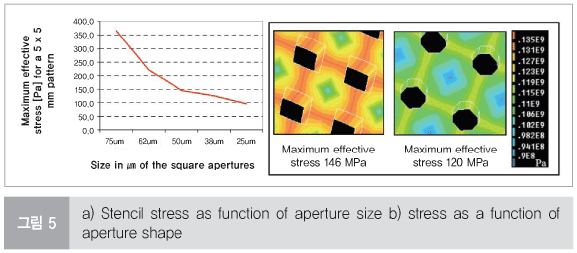
ICA 및 솔더 페이스트의 유동학적 특성
유동학은 응력을 받았을 때 물질의 흐름과 변형에 관한 과학이다. 유동학 / 흐름 거동은 스텐실 프린팅 공정 동안 재료의 성능과 상관관계가 있다. 에폭시 수지에 불규칙적인 모양의 은(silver) 파티클(약 80% 중량)로 이루어진 등방전도성접착제(ICA)는 미세 피치 프린팅과 연속적인 저온 경화에 적합한 재료로 조사되었다. 은 플레이크는 전기적 연결을 제공하는 반면, 수지 접착제는 경화 시 영구적인 구조 결합을 제공한다. 경화 전에, 수지는 유체 상태이고, 전도성 접착제의 벌크 성질은 전단 담화(shear thinning, 전단변화율이 클수록 점도가 감소하는)와 같은 비-뉴톤 유체 특성을 나타낸다.
접착제의 조성은 전기적 상호연결 형성과 구조적 결합뿐만 아니라 유체 특성 및 자체 인쇄 성능을 규정하는데 필요한 구성성분을 제공하는 중요한 요소이다. 거시적 규모(macroscopic scale)에서, 접착제는 고체 입자 함량, 크기, 형상 분포 및 입자 간 힘을 무시하고 균질한 연속체로 간주될 수도 있다. 접착제는 점도 및 밀도와 같은 벌크 거시적 특성에 의해 분류될 수 있다.
Reologica Stress Tech 제어 응력 및 변형 유량계는 ICA 유동학적 특성을 조사하고 기존 솔더 페이스트와 비교하는데 사용되었다. 0.5㎜의 샘플 두께는 직경 40㎜인 두 개의 평평한 평판 사이에 끼워졌다(그림 6 참조). 샘플의 변형은 제어 응력 또는 제어 변형 모드에서 측정할 수 있었다.

정상전단유량측정(Steady shear rheometry)에는 다른 전단 조건에서의 점도 측정이 포함되어 있다. 전단 속도 변화에 대한 샘플의 민감도를 평가하였다(전단 박화, 요변성(thixotropy), 이력 등). 전단 박화 특성(전단될 때 재료의 점도 감소)은 스텐실 개구 내로 페이스트가 들어가는 것을 돕는데 필수적이다. 실험에서는 25℃에서 수행되었으며 상대 습도가 모니터링되었다. 프린팅 공정 동안 솔더페이스트와 ICA는 0.01/s ~ 1000/s의 전단 속도 범위에서 진행하였다. 본고에서 조사된 전단 비율이 느리지만, 개구 충진 및 페이스트 방출 도중의 유동 특성을 예측하는데 사용할 수 있다.
그림 7에서는 두 가지 유형의 솔더페이스트(X2 & T3)와 전도성 접착제 샘플(P1)에 대한 전단 비율의 함수로 점도를 나타내고 있다. 샘플 T3는 점도가 가장 높고 X2와 P1가 그 뒤를 따랐다. 실험 데이터의 추가 분석은 식 (1)에 표시된 Cross Model을 사용하여 수행되었으며, 여기서 η는 점도, η∞는 무한 전단 속도에서의 점도, η0은 제로 전단 비율에서의 점도, K는 구조적 연계의 깨짐 그리고 m은 무한 상수이다.
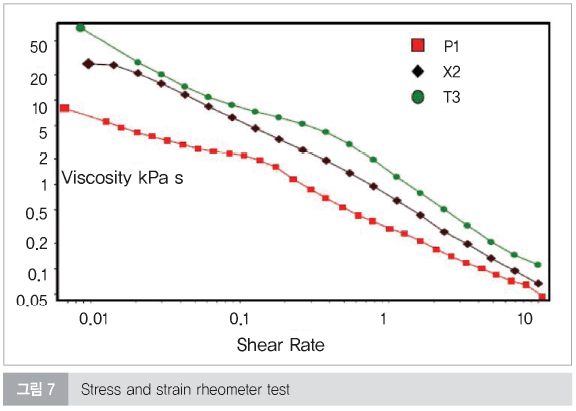
전단 박화의 정도는 1 방향으로 나아가는 전단 박화 유체를 나타내는 m: m의 값을 의미하는 반면, m은 0 방향을 향하는 뉴튼 유체(Newtonian liquids)를 나타낸다.

표 1에 나타낸 바와 같이, 식 (1)을 통해서 K, m 및 상관 계수 r을 포함하는 η0 및 η∞를 추측하였다. 표 1에서 솔더 페이스트 샘플 (X2 및 T3)에 대해 측정 된 점도는 등방 전도성 접착제 (P1). 상수 m에 기초하여, 샘플 P1 및 X2는 샘플 T3에 비해 높은 전단 박화 정도를 나타냈다. 샘플 X2와 T3 사이에서, T3의 제로 전단 점도는 X2에 비해 훨씬 높았다. 제로 전단 점도 값으로부터, 샘플 T3는 두 개의 다른 샘플에 비해 유동에 대한 훨씬 더 높은 내성을 보였다. 그러나 P1과 T3의 무한 전단 점도는 X2에 비해 낮았다. 점도의 드롭은 플로우 방향으로 입자가 구조적으로 재배치되는 것을 잘 보여 주는데, 이는 스텐실 인쇄 공정 중에 개구 충진을 촉진한다. 모든 샘플은 크로스-모델에 매우 적합함을 보여주었다.

프린팅 프로세스 최적화를 위해 적용된 전산 유체 역학(CFD)
전산 유체 역학(CFD, Computational fluid dynamics)은 스텐실 프린팅 공정에서 움직이는 스퀴지 블레이드 앞에 접착제 페이스트의 거시적인 벌크 모션을 시뮬레이션하는데 사용되었다. 그림 8의 (a)는 시뮬레이션 될 형상을 상세화한 모습이고, 그림 8의 (b)는 스텐실을 관통한 속도 벡터의 결과를 자세히 보여주고 있다. 계산 역학 코드인 PHYSICA가 이 시뮬레이션에 사용되었다.
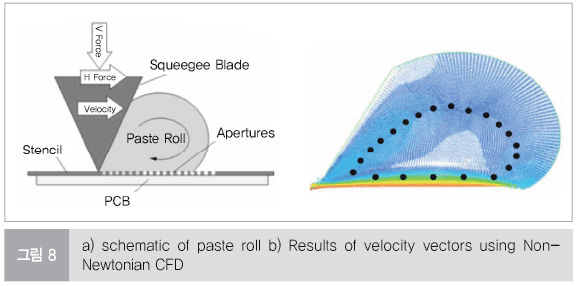
비-뉴턴 유체역학(Non-Newtonian fluid dynamics)은 앞의 섹션에서 자세히 설명한 것처럼 크로스 모델 구성법칙을 사용하여 나비에-스트로크 방정식(Navier Stokes equations)을 풀어서 페이스트 유동학을 특성화하여 시뮬레이션했다. 압력, 속도, 전단 비율 및 점도 분포는 페이스트 재료 전체에 걸쳐 결정될 수 있다. 그림 9에서는 블레이드 각도가 60°이고 속도가 1, 2, 3 및 4㎝/s인 경우 스텐실 표면을 따라 페이스트에서 예측된 압력 분포를 보여준다. 개구 충진 공정이 스텐실 표면에 인접한 이 영역에 마주 치는 페이스트 거동 및 재료 특성에 의존하기 때문에, 페이스트 롤의 베이스를 따라 얻어진 이러한 분포는 특히 흥미롭다.
특히 큰 압력 경도는 주석-납과 ICA 샘플 양쪽에 대한 블레이드 팁에 가장 가까운 영역에서 관찰되었다. 2개의 페이스트 샘플 간에 생성된 압력에는 상당한 차이가 존재해 있었다. ICA에 나타난 압력은 주석-납 솔더에 관찰된 압력보다 훨씬 높았다. 블레이드 팁 영역에서 가장 낮은 점도를 가지고 높은 압력을 가하는 것은 개구 충진을 촉진하는데 도움이 된다.

접착제 인쇄 결과
초기 인쇄 시험은 3인치 웨이퍼에서 제작된 적은 규모 프로토타입 스텐실을 사용하여 수행하였다. 그림 10에서 보는 바와 같이 전도성 접착제의 큰 어레이는 50㎛ 피치까지 낮췄고, 90㎛ 피치로 일관되게 인쇄되었다. 좋은 외형은 스텐실의 연속적인 클리닝 없이 원형 및 사각형 개구를 반복적으로 보였다.
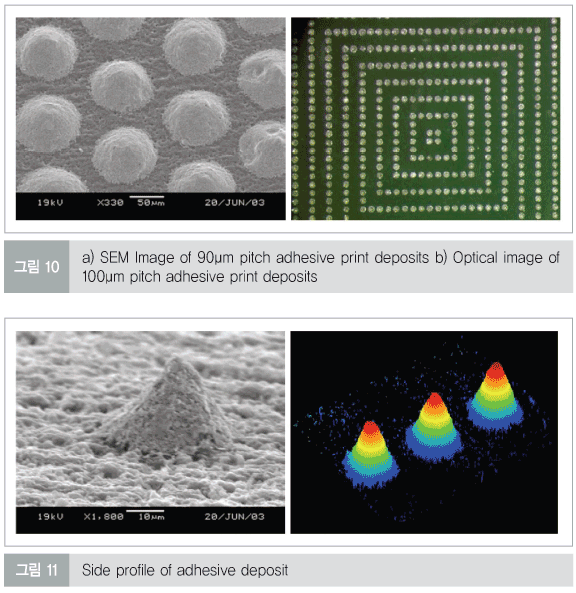
침전의 물리적 특성(높이 및 체적)은 SEM 및 Zygo NewView 5200 스캐닝 백색 광 간섭계 시스템을 사용하여 측정하였다. 개구 직경의 함수로서 증착 높이의 선형 변화를 측정하였다.
솔더페이스트 침전과 달리 침전은 원뿔 형태(그림 11 참조)로 되어 있으며 전형적으로 상부가 평평했다. 접착제는 솔더페이스트와 같이 개구에서 완전히 방출되지 않는 경향이 있다. 대부분의 경우, 기판 상에 침전된 것 보다 더 많은 접착제가 개구에 남아있다. 프린팅 공정의 이 인공물은 마이크로 디스펜서 팁의 어레이와 같은 움직이는 스텐실에 의해서 유발되었다. 개구 벽의 표면적이 개구를 관통해 노출된 기판의 표면적보다 크면, 접착제의 일부분이 기판 상에 남고 나머지는 스텐실 개구 내에 남아있게 된다. 50㎛ 두께의 스텐실의 경우, 이 거동은 200㎛ 미만의 개구 직경에서 나타난다. 기판의 표면적이 개구부의 표면적보다 훨씬 크다면, 침전 방출은 비교적 평평한 상부를 보일 것이고, 스텐실의 두께와 거의 동일할 것이다. 이 간소한 설명에서는 개구의 충진 및 방출 특성에 영향을 미치는 기판 및 개구 측변의 습윤 특성을 고려하지 않았다. 그림 12에서는 인쇄 높이와 개구 직경의 차이를 보여주고 있다.

신뢰성 모델링
보다 높은 신뢰성을 보장하는 핵심 프로세스 파라미터를 조사하기 위해 열적-기계적 계산을 수행하였다. 그림 13에서는 조사를 위해 사용된 플립칩 어셈블리를 보여주고 있다. 열 사이클링 하에서 재료 내의 열적 불일치는 ICA 접합부에 응력 발생 및 피로 손상 결과를 초래할 것이다. 조사된 파라미터의 예는 다음과 같다; 언더필 특성, 침전된 ICA 페이스트의 체적 및 디바이스 범프에 따른 ICA의 습윤 높이. 계산에 사용된 손상 파라미터는 솔더페이스트 내에 축적된 소성 변형이었다. 이 값이 높을수록 크랙발생과 증식의 가능성이 늘어난다.
시뮬레이션에서는 언더필의 CTE(20~65ppm)가 줄어들고, Young’s Modulus(1~5GPa)이 늘어나면, 접합부의 소성 변형이 줄어드는 것을 보여주었다. 범프 필러의 측벽을 습윤시키는 접착제의 양을 최소화하는 것도 소성 변형을 줄이는데 도움을 주었다. 가장 중요한 변수는 침전된 접착제의 체적이다. 접착제의 체적이 많을수록 소성 변형이 줄어들었다. 얇은 기판 또한 접착제의 소성 변형을 줄여 접합부의 수명을 늘리는데 도움이 되었다.
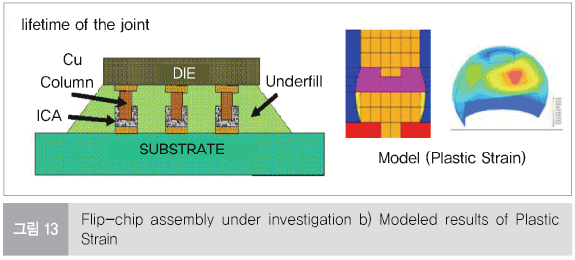
Microemissive Display(Microsystem 3)의 패키지 테스트 칩
그림 1에서 보는 바와 같이 MAT21 프로젝트의 3단계는 엔드-유저 디바이스 패키징을 위해 진화된 어셈블리 프로세스의 실현 가능성을 입증하는 데 그 목적이 있다. 프로젝트 파트너 중 하나인 Microemissive Displays(MED)는 풀 컬러 유기발광다이오드(OLED) 어레이를 직접 마이크로 칩 상에서 제조할 수 있는 기술을 개발했다. OLED 어레이는 320 × 240 픽셀 마이크로 디스플레이로 작동했다. 현재 MED 패키지는 몰드 플라스틱 모듈 내에 자체 디스플레이 다이가 있지만, 이 회사는 이 디바이스를 플립칩 본딩할 수 있는 가능성을 염두에 두고 있다. 칩을 플렉시블 기판에 직접 어테칭하면, 공정 단축과 생산 재료 절감을 실현할 수 있다. MED 칩은 대량 생산 시 저온 어셈블리 요구 사항을 포함하여 MAT21 프로젝트에 지정된 대부분의 기준을 충족했다.
코이닝된 골드 스터드 범프는 그림 14의 (a)와 같이 테스트 다이에 본드되었다. ICA는 기판 상에 연속적으로 침전시켰다. 그런 다음 다이는 보드에 직접적으로 플립칩으로 본드시켰다. Celestica의 팀에 의해 해결된 문제 중 하나는 언더필이 디바이스의 디스플레이 영역으로 직접 유동하지 않다는 점을 확인한 것이었다. 디스플레이 영역을 시뮬레이션하기 위해 캐비티가 존재한 FR-4 보드를 제작했다.
패키지의 모서리에 적용될 수 있고, 그 이후 표면장력 효과를 사용하여 칩과 기판 사이에서 유동되는 적합한 언더필을 확인하였다. MED 디바이스의 경우, 디스플레이가 켜지는 오픈 영역이 있다. 언더필은 칩과 보드 간의 상호연결부 주위로 유동되지만, 디스플레이용 오픈 캐비티에 도달할 때는 유동을 멈춘다(그림 14의 (b) 참조). 많은 MEMS 및 MOEMS 디바이스의 표면에 있는 복잡하고 섬세한 3D 구조는 언더필 공정으로 인해 쉽게 손상된다. 이 직접적인 칩 어테치 공정은 언더필이 이러한 섬세한 장치를 손상시키지 않도록 하는 적절한 방법을 보여 주고 있다.
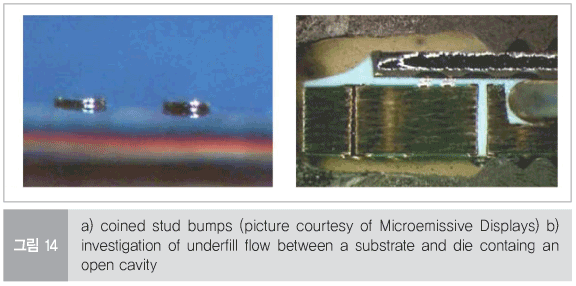
패키지화된 마이크로 시스템 시스템의 안정성을 보장하기 위해 기계 및 전기적 특성 분석이 수행되어야 할 필요가 여전히 있다.
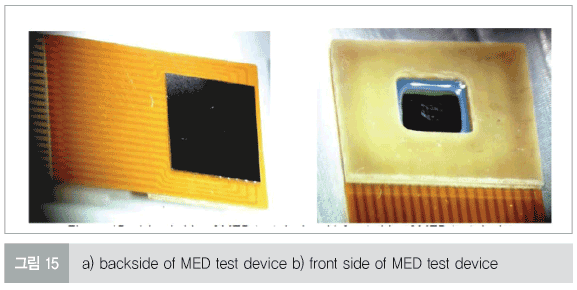
결론
매우 잘 규정된 개구 모양과 부드러운 측벽을 지닌 50㎛ 두께의 새로운 스텐실이 개발되었다. 스텐실 개구는 최소 10㎛ 가공 웹을 지닌 직경으로 10㎛~1000㎛까지 가공되었다. 프레이밍 이후 그리고 인쇄 공정 중 스텐실 내에서의 응력 모델링 테스트를 통해 스텐실 내에서 나타나는 탄성 변형이 있음을 확인하였다. 원형 개구의 이용은 응력을 20% 가량 감소한다.
유변학적 특성 조사에서는 솔더페이스트의 점도가 ICA의 점도보다 훨씬 높다는 것을 보여 주었다. 모든 샘플들은 Cross 모델 기법을 적용했을 때 높은 전단 박화 정도를 보였다. 그러나 전단 속도가 증가함에 따라 3개 샘플 모두의 점도가 낮아져 인쇄 공정 중에 관찰된 양호한 개구 충진이 설명되었다. 그러나 더 낮은 전단 속도에서 각 시료의 점도는 재료의 방출 과정에 미치는 커다란 영향들이 상당히 다양했다. 이 방출의 차이는 인쇄 결과에 나타났으며, 솔더페이스트에 비해 개구에 더 많은 접착제가 남아 있었다.
