모아레 기술 이용, 휨과 BGA 틸트 확인
균일한 온도와 비균일 온도로 비교
초기 패키지 평탄도는 부품 제조공정과 설계의 여러 측면에 의해 영향을 받을 수 있다. 그러나 온도에 따른 평탄도의 변화는 패키지에 사용된 상이한 재료 간의 CTE 불일치에 의해 주로 발생한다. 따라서 재료 CTE는 패키지 디자인에서 중요한 요소가 된다. 패키지 휨을 분석하거나 모델링 할 때 패키지가 모든 면에서 균등하게 열을 받는다고 가정하지만, 생산라인에서는 그렇지 않다. 그래서 온도 균일성이 패키지의 휨에 어떻게 영향을 미칠 수 있는지 이해하기 위해 패키지 휨과 서로 다른 열을 가한 사례 연구를 실시하였다.
PCB 어셈블리에서 신뢰성 있는 표면실장 장착기술을 얻기 위해서는 온도에 따른 패키지 휨 변화를 아는 것이 중요하다. 부품-부품 혹은 부품-보드 표면은 서로 평평한 상태를 유지해야 한다. 그렇지 않으면 HIP(head-in-pillow), 오픈, 브릿지, 인장 등과 같은 표면실장 불량이 발생할 수도 있다. 초기 패키지 평탄도는 부품 제조공정과 설계의 여러 측면에 의해 영향을 받을 수 있다. 그러나 온도에 따른 평탄도의 변화는 패키지에 사용된 상이한 재료 간의 CTE 불일치에 의해 주로 발생한다. 따라서 재료 CTE는 패키지 디자인에서 중요한 요소가 된다. 패키지 휨을 분석하거나 모델링 할 때 패키지가 모든 면에서 균등하게 열을 받는다고 가정하지만, 생산라인에서는 그렇지 않다. 그래서 온도 균일성이 패키지의 휨에 어떻게 영향을 미칠 수 있는지 이해하기 위해 패키지 휨과 서로 다른 열을 가한 사례 연구를 진행하였다.
사례 연구에 사용된 패키지는 더 큰 폼팩터를 가지므로 각 패키지 내에서 불균일의 영향을 보다 쉽게 정량화할 수 있었다. 작고 얇은 패키지에서는 열이 패키지 재료를 관통해 전도하고 고르지 않은 열원을 보강하는 경향이 있어서 패키지 온도 변화 문제가 덜 발생한다. 멀티 패키지-멀티 패키지 폼팩터는 실제 생산 조건과 동일한 리플로우 프로파일을 적용하였고 가열 및 냉각 동안 그림자 모아레 기법으로 휨을 측정하였다. 균일하게 가열된 패키지와 패키지 표면 사이의 온도 불균일한 패키지를 비교할 수 있도록 패키지의 가열을 조정하였다. 휨은 패키지가 가열 및 냉각하는 동안에 역학적으로 측정하였다. 불균일한 온도 확산의 역할이 패키지 휨에 어떻게 영향을 미치는지에 대해 알아보았다.
서문
열적 휨 측정 툴은 부품 혹은 툴 자체의 가열 환경 테스트 하에서의 영역에 나타나는 열적 및 물리적 조건을 모방하는 콘셉트에 맞춰 설계하였다. 가장 일반적으로 이들 툴은 리플로우 프로파일의 열 조건을 모방하는 데 사용하였다. 휨 테스트는 열적 휨 측정 툴 내부에서 다양한 유형의 샘플(패키지, PCB, 소켓, 커넥터, 웨이퍼)의 온도에 따라 수행하였다. 여기서는 SMD, 특히 BGA에 중점을 두어 테스트하였다. 이 글을 작성한 시점에서 BGA 및 LGA는 리플로우를 거친 후 허용 가능한 휨 레벨이 규정된 유일한 업계 표준 디바이스들이다. JEITA(ED-7306)[1]은 BGA의 경우 피치 및 볼 높이를 기준으로 BGA 및 LGA에 허용되는 휨 레벨을 규정하고 있다. 유사하게, JEDEC(JESD22-B112A)[2]는 JEDEC SPP-024A[3]에 의해 보완된 BGA의 열 변형을 측정하는 방법을 정의하고 있으며, 볼 피치 및 볼 직경에 기초하여 BGA에 허용되는 휨 레벨을 나타내고 있다.
BGA 패키지가 가열될 때, BGA 내의 상이한 재질들은 자체 재질 특성, 즉 열팽창계수(CTE)와 일치하는 값에서 가로 방향으로 팽창될 것이라고 믿어지고 있다. 일반적인 BGA 구조물에는 상이한 CTE 값의 재질들이 포함되어 있다. 상이한 특성의 재료가 물리적으로 서로 부착되어 있기 때문에 이 같은 다양한 가로 팽창이 제한되고 재료 간의 CTE 불일치가 면외(out-of-plane) 형상 변경 또는 휨을 유발할 수 있다. 휨과 관련해 CTE 불일치가 일반적으로 고려되고 있지만, 패키지 내부의 온도차도 휨에 유사한 영향을 끼칠 수 있다. 이 온도차는 리플로우 프로세스 동안 어느 정도 감지할 수 있으나, 다양한 변수에 의해 작용한다. 방열판이 장착된 대형 BGA를 예로 들어보면, 일반적으로 패키지 상단이 볼 사이드보다 온도가 높게 감지될 수도 있다. 리플로우 오븐 내부의 부품에 관한 실제 온도차는 본고에서 다루지 않았다. 그러나 열적 휨 측정에 대한 일반적인 관행이 리플로우 오븐 내부의 현장 측정을 포함하지 않기 때문에 휨 측정 설비 자체 내에서 휨에 대한 온도차의 영향을 이해하는 것이 중요하다. Anselm[4]의 논문에서는 이 연구를 수행하기 위해 몇 가지 근거를 제시했으며, 온도차와 관련하여 휨 측정 툴과 실제 생산 사이의 잠재적 오프셋을 논의하였다. 그 생산 조건에서는 5~10℃의 온도차가 존재했었고, 휨 측정 툴에서는 16℃ 차이를 보였다.[4] 최신 휨 측정 툴을 사용하면 온도차를 보다 효과적으로 제어할 수 있어서 약 20℃ 및 ≤5℃의 온도차이로 휨의 비교가 가능하다.
Anselm 논문[4]에서는 또한 리플로우 동안에 보드 상의 샘플 평탄도 혹은 틸트(tilt)에 대해 의문을 제기했다. 부품의 휨을 관찰하는 것만으로는 HiP(head-in-pillow)와 같은 표면실장 결함을 이해하기에 충분하지 않다는 주장이 있었다. 휨과 함께, PCB에 대한 샘플의 상대적 틸트이 추적되어야 한다. 구체적으로, ‘보드에 대한 부품의 평탄도는 디바이스의 무게 중심 또는 리플로우 동안 솔더 조인트의 습윤 거동의 변화에 ??영향을 받을 수 있다.[4]’고 명시되었다. 논문 후반부에는 ‘…페이스트의 습윤은 부품에 균일하지 않게 힘을 분산할 수 있다. Cu 밸런스 문제, 라우팅 기술 또는 부품 비대칭 때문에 PCB 내 X/Y 열적 증감은 부품의 솔더페이스트 4분면(quadrant)을 먼저 습윤시켜 디바이스에 균일하지 않은 습윤력을 초래할 수 있다. 이 현상이 발생한다면, 습윤력은 무게 중심를 극복하고, 리플로우 동안 한쪽의 가장자리가 아래로 당겨지는 반면, 다른쪽 가장자리는 페이스트 침전물로부터 들어 올려진다.’[4]고 설명했다.
본 연구에서 온도차는 부품의 한쪽에서 발생하는 솔더 볼 붕괴를 유발하기 위해 사용하였다. 본 연구에서 생성한 차이는 리플로우의 ‘리딩 에지(leading edge)’에 있는 리플로우 오븐에서 나타나는 것보다 과도하게 하였다. 본 연구는 리플로우 가열 동안 부품의 틸트 및 상단 휨을 측정하고 정량화하는 데 사용될 수 있는 광학 측정 및 리플로우 에뮬레이션 기술을 보여주는 콘셉트로 사용하는 것이다. 리플로우에서 부품 틸트을 실제로 테스트하려면 실제 부품, 보드, 솔더페이스트, 페이스트 적용을 위한 스텐실 및 현실적인 리플로우 에뮬레이션이 가능한 열적 휨 측정 툴이 필요하다.
테스트 방법
BGA 휨 및 온도 균일성 연구
이 테스트의 목표는 서로 다른 상단 조건 하에서 BGA 샘플의 휨을 측정하는 것이다.
본 연구에서는 표 1에 나타난 바와 같이 2개의 BGA 샘플을 사용하였다. 샘플들은 고객 정보를 보호하기 위해 일반적 사항만 설명하였다. 원래 총 4개의 샘플이 이번 연구에서 고려되었지만, 온도 균일성 차이로 인한 휨의 변화와 관련하여 단지 2세트의 샘플만 통계적으로 관련된 정보를 보여주기로 하였다.
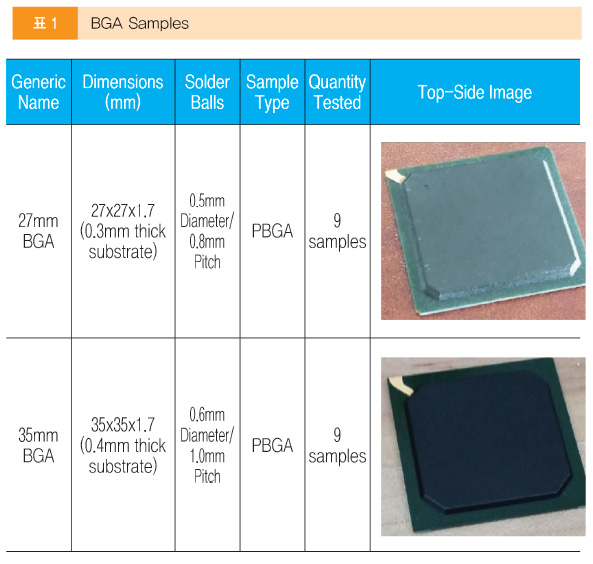
테스트 파라미터는 일반적으로 JESD22-B112A의 지침을 따랐다.[2] 또한 다음의 파라미터는 테스트 동안 제어하였다 :
▶ 솔더 볼 없이 볼면을 위로 향하도록 하여 부품을 측정했다.
▶ 모든 샘플은 리플로우 사이클을 거치지 않은 ‘신규’ 제품이다.
▶ 어떠한 샘플도 예열하지 않았다.
▶ 샘플 표면에 백색의 고온용 페인트를 칠했다.
▶ 데이터는 30℃~250℃ 측정하였고, 다시 30℃에서 측정하였다.
▶ 샘플 지지대는 2mm 두께의 투명한 석영 유리판을 사용하였다.
▶ 그림자 모아레 측정 기술을 적용하였다.
▶ 평균 가열 속도는 약 0.5℃/sec였지만 Δ20℃에서 약간 느리게 하였고, Δ5℃에서는 약간 빠르게 하였다.
온도 균일성과 샘플 타입이 테스트에 있어서 유일한 독립 변수였다. 샘플 타입은 이미 표 1에 설명하였다. 온도 균일성을 테스트하기 위해 내부/외부 하단 히터 존이 있으며, 상단 히터 독립제어의 멀티-존 IR 히팅 오븐을 사용하였다. 상단 IR 히터를 포함한 오븐과 시스템은 단파 IR 전구와 어두운 색의 루비 석영 튜브를 조합하여 사용하는 콘셉트로 특허 출원 중이다. 가시광선을 걸러 내고 그림자 모아레 설정의 격자유리(grating glass)를 통해 IR 에너지를 샘플 상단으로 유도하는 개념이다. 목표는 ‘비-균일한’ 리플로우 내에 최대 250℃의 리플로우 온도에서 약 20℃의 온도 차이에 도달하는 것이고, ‘균일한’ 리플로우의 경우에 ≤5℃의 총 샘플 온도 변화를 유지하는 것이다.
비-균일한 리플로우는 상부 히팅 존을 비활성화하고, 중앙 하단 히터에 열을 집중시키고 샘플과 격자 사이의 짧은 작동 거리를 사용하여 구현하였다. 균일한 리플로우는 상부 히팅존을 사용하고, 외부 하단 히터를 향해 더 많은 열을 집중시키고 측정할 때까지 격자 작동 거리까지 샘플을 늘리기 위한 ‘히팅 동안 낮게’ 기능을 사용하여 실시하였다.
휨 연구 결과는 정량 분석을 위해 표면의 3D 렌더링뿐만 아니라 3S 휨을 사용하여 정량화하였다. 3S Warpage는 2단계로 결정된 동일평탄도 및 부호와 같은 크기로 정의된 새로운 게이지 선택이다.[5] 먼저, 표면의 신호 세기를 계산하였다.

여기서 x의 m = 픽셀 수와 y의 n = 픽셀의 수, e 및 f는 각각 표면의 2차 다항식 피팅의 x2 및 y2 계수이다. 신호 세기가 25% 미만이면, 과도기적인 외형이라고 여겨지는데, 이는 (양) 방향 혹은 (음) 방향으로 명확하게 부를 수 없다. 이 경우 3S 휨은 TX로 보고되며, 여기서 X는 동일평탄도이다. 신호 세기가 25% 이상이며, 기호는 식 (1)과 동일한 변수를 사용하여 JEDEC Full-field Signed Warpage와 동일한 방법을 사용하여 결정된다.

여기에서 방정식의 숫자 값은 버리고, 단지 신호만 유지한다.
BGA 틸트 및 솔더 볼 무너짐
이 테스트의 목적은 PCB에 솔더되는 BGA 샘플의 상면 휨과 틸트 모두를 측정하는 테스트 방법을 검증하는 것이다. 또한 이 테스트는 액상 온도를 지난 후 솔더 볼의 무너짐에 있어서 가로측 온도 변화의 영향에 관한 기준점으로 사용한다. 이 연구는 BGA 리플로우 어셈블리에서 실제로 동작하는 다른 기계적 힘을 고려하지 않고 온도 변화의 결과로 틸트에 중점을 두었다.
표 1에 설명된 35mm BGA를 연구에 사용하였다. 이 경우 샘플은 솔더 볼을 두고 ‘라이브 버그’ 또는 볼 다운 위치에서 테스트한다. 하나의 BGA는 온도 추적에 사용하였고, 2개의 샘플은 2개의 상이한 열이 가해진 후의 휨 및 틸트를 테스트하였다. BGA는 유리의 상단이 검은색으로 칠해진 2mm 두께의 석영 유리에 놓았다.
검은색 페인트가 칠해진 유리 표면은 두 가지 용도로 사용된다. 검은색 페인트는 IR 에너지를 흡수하여 유리를 가열하고 BGA의 솔더 볼을 통해 전도하는 데 사용된다. 또한, 유리는 비교적 평평하고 열적으로 안정적인 기준 표면 역할을 하며 평평한 ‘PCB’ 역할을 한다. 부품 표면은 생산 시나리오에 보다 사실적으로 표현하기 위해 어떤 식으로도 색을 칠하지 않았다.
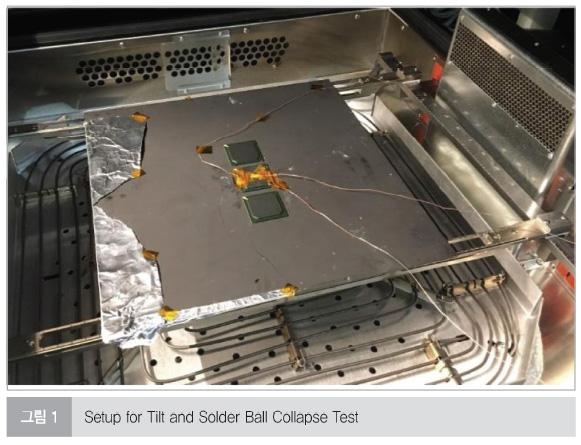
그림 1은 이 테스트 셋업 이미지를 보여주고 있다. 대략 20℃의 가로면 불균일성을 생성하기 위해, 은박 조각을 검은 유리의 밑면에 부착하여 BGA 바로 아래의 유리 부분의 약 1/4을 덮었다. 이 은박은 IR 에너지가 테스트 BGA의 한 면으로 전달되는 것을 차단하여 두 면 사이의 온도차를 발생시키는 역할을 한다. 중앙 하부 히터와 상부 히터로부터 열이 가해지고, 하부 히터의 출력은 최대 전력의 약 55%로 설정하였다. 이 저전력은 불균일한 낮은 히팅의 정도를 제어한다. IR 열이 검은색 유리의 바닥에 직접 가해지기 때문에, 중심부에 낮은 열을 집중시키는 것 또한 불균일성을 최대화하는 데 도움이 되었다. 한편, 상부 히터는 부품 상부를 균일하게 가열하여 과도한 가로측 불균일을 방지한다. 이들 요소, 특히 오븐 출력 및 은박지 커버리지의 밸런스는 더미 부품으로 반복적인 균일성 테스트를 통해 결정하였다. 그림 1에서 볼 수 있듯이 써머커플을 초기 설정과 실제 테스트 중에 부품의 3곳에 놓았다. 부품 측면의 2개 써머커플은 핵심 가로측 온도차를 측정했으며, 중심부의 3번째는 차이가 부품을 통해 고른 틸트로 표현되었음을 확인시켜주었다.
데이터 수집에 사용된 그림자 모아레 기법은 유리 표면과 BGA 상단 사이에서 나타내는 바와 같이, 불균일한 높이가 존재하는 표면에는 전통적으로 사용되지 않는다. 그러나 소프트웨어 개선을 통해 이 데이터 세트를 전체적으로 해석할 수 있었다. 이 경우 유리 표면이 기준 면으로 사용되며, 온도에 따른 표면의 휨 및 틸트 모두에 대해 BGA의 상부가 표시될 것이다. 그림자 모아레와 불연속 표면을 활용하는 기술은 ‘그림자 모아레 광학 측정을 사용한 다이 틸트 측정; 불연속 및 세미-반사 표면을 위한 새로운 기술[6]’에는 완전히 정의되지 않을 것이다.
기준 유리와 관련한 BGA 상면 형상의 결과는 3S 변형을 제공하고 기판 표면과 관련한 부품 표면의 각도를 계산함으로써 정량화되었다. 부품과 기판 사이의 각도를 계산하는 방정식은 아주 단순한 기하학구조이다:

여기서 a는 대각선 끝점보다 높은 z 값, b는 대각선 끝점보다 낮은 z 값, L은 사용자 지정 이미지 치수를 기준으로 한 대각선 길이이다. 유리가 기준면으로 사용되더라도 BGA의 몰딩된 상부 표면만 3S 휨과 각도 계산에 사용하였다. 3D 표면 렌더링 및 수평 중심선 2D 플롯을 통해 데이터가 제공될 것이다. 마지막으로, 유리와 관련하여 BGA의 틸트로부터 표면 휨을 분리하기 위해, 1차 다항식 표면 피트를 데이터 세트에 적용하였다. 1차 다항식 데이터는 주로 표면의 상대적 틸트를 나타낼 것이다.
BGA 휨 및 온도 균일성 연구 결과
5℃ 및 20℃의 온도 프로파일에 있어서, 상단/하단 온도 균일성 리플로우 프로파일을 그림 2와 그림 3에서 보여주고 있다. 이들 리플로우 프로파일의 상단/하단 온도 균일성은 몇 가지 진행되는 리플로우 프로파일 실행에서 최적화되었다. 그림 2와 그림 3은 리플로우 프로파일 실행의 전형적인 예이다. 써머커플 Process 1은 BGA의 몰딩된 면에 부착되었고, Process 2는 데드 버그 설정(dead bug setup)에서 부품의 상단에 있는 볼 면이었다.
피크 온도에서의 측정을 위해 ‘5℃’ 실행의 경우에 본 연구에서 사용된 실제 온도 균일성 값은 3℃와 7℃ 사이였으며, 더 낮은 온도 지점에서 점진적으로 더 균일하였다.
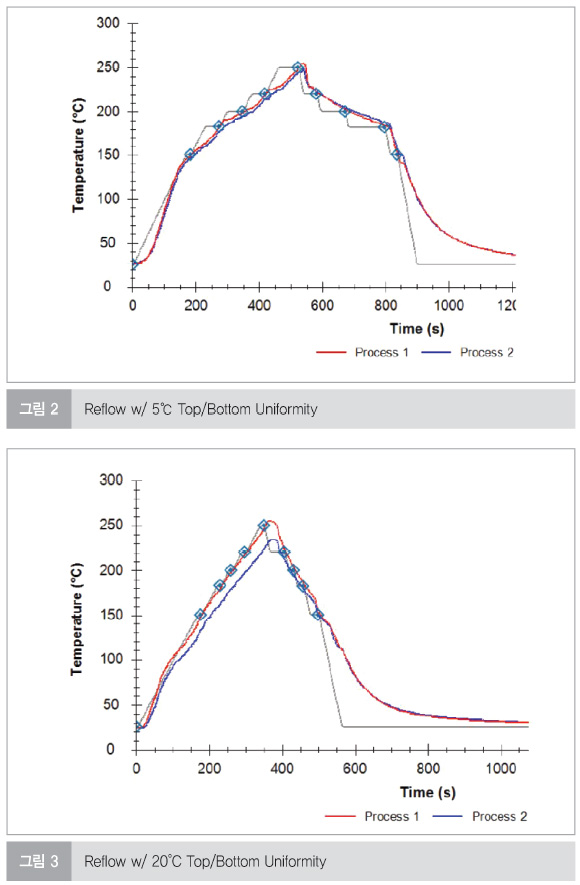
유사하게도, ‘20℃’의 경우에 피크 온도에서의 온도 불균일성은 24℃로 높았으며, 특히 프로파일의 냉각 측에서 특히 더 낮은 온도에서 더 적은 변화를 나타냈다. 온도 균일성은 전체 실행 후에 확실히 변했고, 프로파일 피크 근처에서 최대를 보였으며, 5℃ 및 20℃ 라벨은 결과를 간단히 설명하는 데 사용하였다.
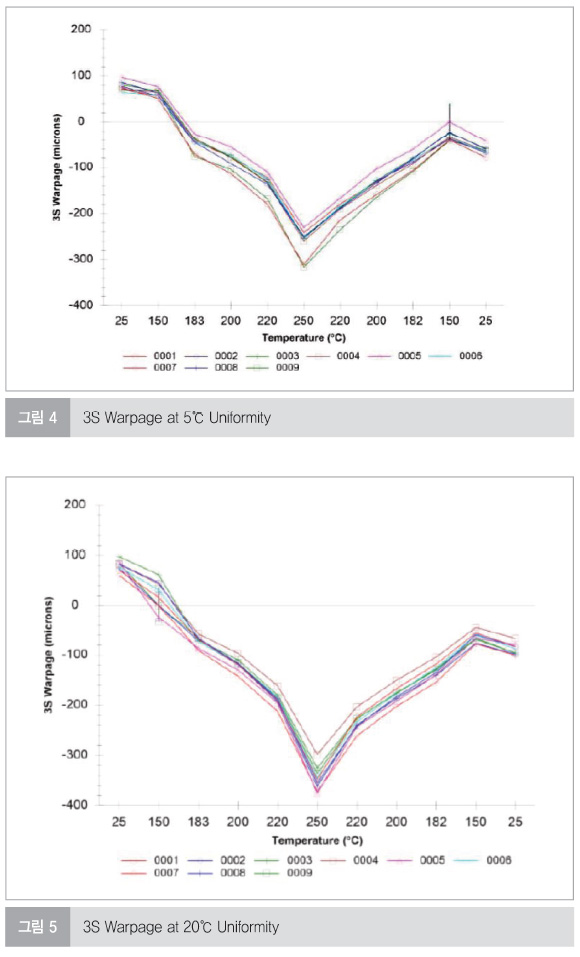
27mm BGA 휨 결과
5℃ 및 20℃의 실행에 대한 3S 변형 값은 그림 4와 그림 5에 표시하였다.
예상 한 바와 같이 일부 샘플 간 변화가 보이므로, 각 테스트에 사용된 9개 샘플 모두를 각 온도에서 동일한 평면성을 평균하여 데이터를 요약하였다. 그림 6은 이 데이터를 보여주고 있다.

모든 온도와 프로파일 유형에 걸쳐 모든 샘플의 3D 렌더링을 보여주는 것은 이 보고서에서 실용적이지 않지만, 3D 변형 형태의 대표적인 예를 표 2에 요약하였다.
35mm BGA 휨 결과
5℃ 및 20℃ 실행에 대한 3S 변형 값은 그림 7과 8에 표시했다.

이전과 같이 일부 샘플 간 차이가 보이고, 그림 9에서는 전체 9개 샘플 모두의 각 온도에서 동일평면성을 평균하여 요약한 데이터를 보여주고 있다.

BGA 휨과 온도 균일성에 대한 연구 토론
휨 결과에서 가장 흥미로운 세부 사항은 패키지 구조가 2개 부품 간에 외부적으로 유사하게 나타나고 휨 값이 비슷한 경향을 보이는 반면, 상단/하단 온도 균일성의 효과는 두 샘플의 경우에 완전히 반대의 방식으로 작용한다는 것이다.
27mm BGA의 경우 높은 온도 변화는 최대 온도에서 더 많은 휨 레벨을 초래한다. 그러나 35mm BGA의 경우 온도가 위에서 아래로 더 균등하게 가해졌을 때 휨 수준이 가장 높다는 점에서 완전히 반대이다. 약간의 샘플 변화가 보이지만, 2개의 열 조건이 샘플에 부정적 및 긍정적으로 휨에 영향을 끼친다는 전체 경향은 일치하였다.
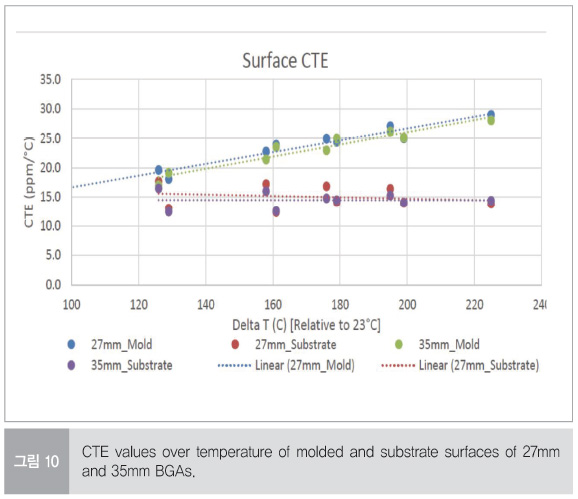
두 샘플에 대한 휨 조건의 차이를 더 이해하기 위해 27mm 및 35mm BGA의 상단(몰딩 면) 및 하단(기판 면)에 대한 표면 변형률 및 CTE 테스트를 실시하였다. 여기에서 균형 가열(balanced heating, Δ5℃)을 사용하였다. 이 측정은 온도에 따른 표면 변형률을 측정하여 재료 CTE를 계산하는 데 일반적으로 사용되는 DIC(Digital Image Correlation) 기술을 사용하여 수행하였다. 그림 10에서는 두 가지 샘플 유형의 몰딩 및 기판 면 온도에 따른 CTE를 보여주고 있다.
선형 회귀(linear regression)를 각 데이터 세트에 추가하였다. 또한 x-축은 절대 온도가 아니라 실온과의 온도 차라는 점을 주의했다. 그림 10에서 얻은 결론은 두 샘플이 해당 표면의 CTE에서 실질적인 차이가 없다는 점이다. 몰딩된 표면은 더 팽창하고 더 뜨거워지므로 온도차가 더 클수록 전체 팽창의 차이가 더 커졌다. 세로 확장의 차이로 인해 휨이 발생하므로 DIC 결과 및 FEA 시뮬레이션의 결과에 따르면 가열해도 균일한 휨이 발생할 수도 있다. 실제 휨 테스트에서는 이러한 현상이 항상 그렇지 않음을 증명했다. 패키지에 있어서 몰딩 CTE와 기판 CTE의 비교는 전체 샘플의 팽창을 지나친 단순화한 것이다. 약 3~3.5 ppm/℃로 알려진 낮은 팽창률을 지닌 실리콘 다이를 포함하여 둘 다 서로 다른 물질을 함유하고 있기 때문이다.[7]
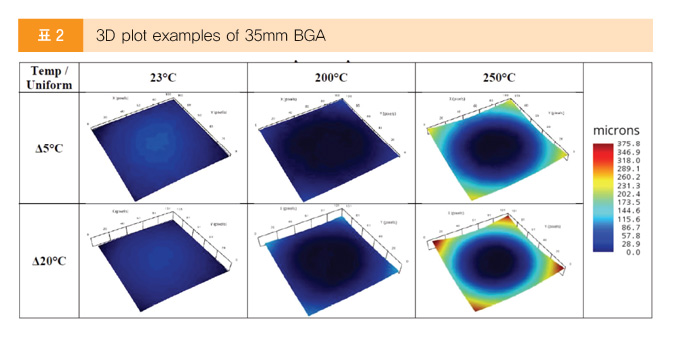
패키지 휨의 차이에 대한 답을 찾기 위해 각 샘플 중 하나를 반으로 잘라 패키지 다이를 확인했다. 두 패키지 모두 비슷한 두께의 단일 다이였다. 그러나 35mm BGA의 다이는 X와 Y에서 거의 두 배나 큰 다이를 가졌다. 다이 크기인지 아니면 패키지 구조 내의 다른 차이가 서로 다른 휨 거동을 유도했는지 확실하지 않았다.
BGA 틸트 및 솔더볼 무너짐 결과 및 토론
리플로우 동안 BGA의 상면 측정에 대한 개념 증명은 이들 결과와 불연속적인 표면에 그림자 모아레 데이터를 사용한 이전 연구의 조합으로 하였다.[6]
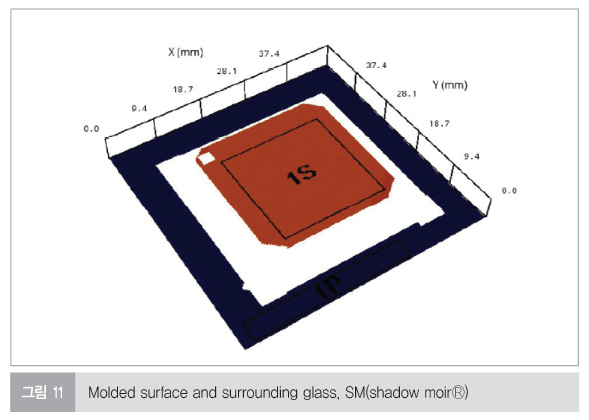
그림 1의 설정을 참조하여, 검은 유리 위에 놓여있는 라이브 버그 위치에서 BGA의 그림자 모아레 이미지를 촬영하였다. 이 경우 검은 유리는 평평한 PCB 표면 역할을 하였다. 전통적으로, 그림자 모아레는 BGA 몰딩 영역과 주변 BGA 기판 사이의 높이 변화 또는 주변 BGA 기판과 검은 유리 사이의 높이 변화를 측정할 수 없다. 그러나 일부 초기 높이 추정치에 기반을 둔 새로운 소프트웨어 접근법[6]은 그림자 모아레 기법을 사용함에도 급격한 모든 높이 변화의 높이를 측정하는데 사용될 수 있다. 유리로 주변이 둘러싸인 몰딩된 표면을 그림자 모아레 기법으로 측정한 것을 그림 11에 표시하였다.
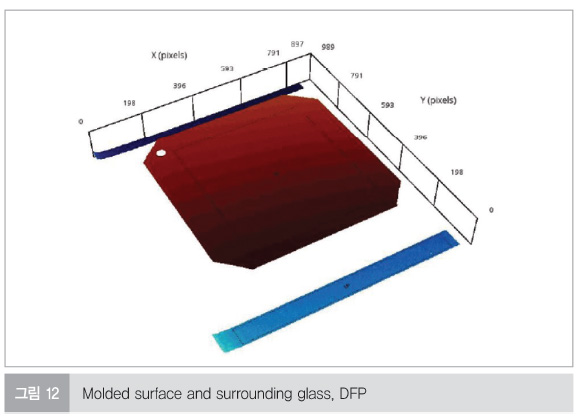
몰딩된 표면의 대략적인 높이는 단계별 높이를 측정하는 고유한 기능을 지닌 DFP(Digital Fringe Projection) 기술로 확인하였으나, 테스트에 사용한 반복에서 FOV(field of view)를 넓히는 데 한계가 있다[8]. 이 경우 몰딩된 표면에서 주변 유리까지의 단계별 높이는 두 개의 서로 다른 샘플에서 그림자 모아레로는 2234미크론, DFP의 경우에는 2174미크론으로 측정되었다. 그림자 모아레 기법으로 데이터의 상대적인 틸트를 측정하기 위해, 절대 높이는 실제로 필요하지 않았다. DFP 측정은 무결성 검사(sanity check)에 더 적합하다.
유리 상에서 몰딩된 상부 표면을 측정한 결과는 패키지 자체의 휨에 의해 주로 좌우되며, 유리 상의 패키지 고정 또는 틸트가 이유가 아니었다. 패키지의 전체 이동 또는 패키지의 틸트가 실제 솔더링 상황에서 더욱 중요해질 수 있다는 점을 유의해야 한다. 2개의 열 가동에는 평평한 상단 및 하단을 가열하도록 설계된 2개의 샘플이 각각 포함되었으나, 샘플의 왼쪽에 비해 오른쪽 온도가 더 높았다. 제어 써머커플을 첫 번째 프로파일과 두 번째 프로파일 사이에 왼쪽에서 오른쪽으로 교체하였다. 샘플이 더 높은 전체 온도에 도달하고, 틸트에 미치는 영향을 확인하기 위한 목적이었다. 그래서 Process 1은 리플로우 1(그림 13 참조) 내의 왼쪽과 리플로우 2(그림 14 참조)의 오른쪽이 있다.
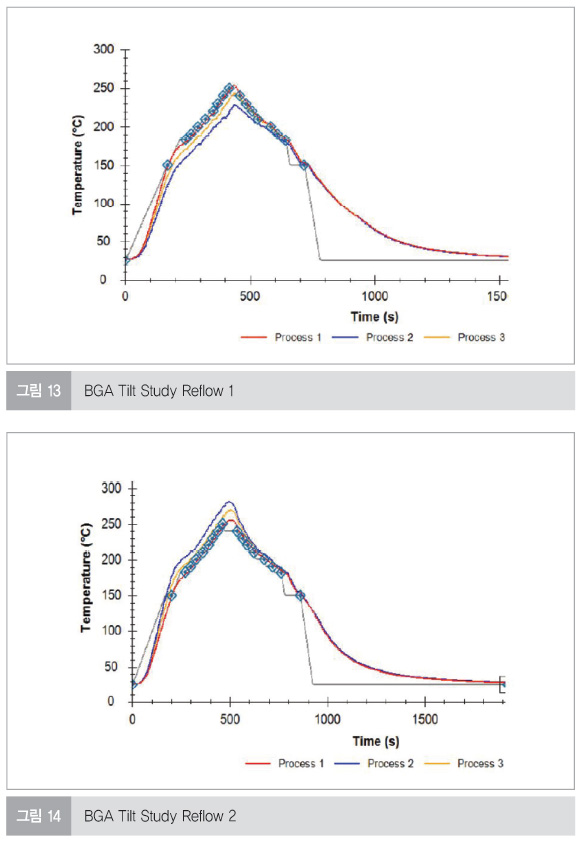
3S 휨은 그림 15에서 보여주고 있으며, 그림 16에서는 2번의 열 사이클에 걸쳐 4개의 총 샘플에 대한 틸트의 각도가 나와 있다. 이 데이터는 유리 기반과 관련하여 기준면을 보여준다. 비록 샘플의 휨은 전체 외형과 틸트에 관한 주요 요인이다.
휨은 상단에서 하단까지의 온도 균일성 연구에서 샘플의 기판 면 상의 전체 추세와 일치하였다. 전반적으로 틸트 각도 정보를 명확하게 해석하기는 어렵다. 솔더가 액화되기 시작하면서 샘플이 매우 명확하게 틸트 메커니즘을 따르지 않은 것처럼 보인다. 더 높은 틸트 수가 일반적으로 액상 온도 주변에서 볼 수 있었으나, 전체적인 추세로는 불분명하다. 그러나 게이지가 중심점과 가장자리 지점을 사용하여 대각선을 지나서 기울이는 근본이기에 샘플을 지나서 왼쪽에서 오른쪽으로 기울이기 위해 이 게이지를 사용하는 데 본질적인 문제가 존재한다. 유리 기준면의 몰딩된 BGA 표면의 예는 그림 17 및 그림 18에서 실내 및 최대 온도로 표시되어 있다.
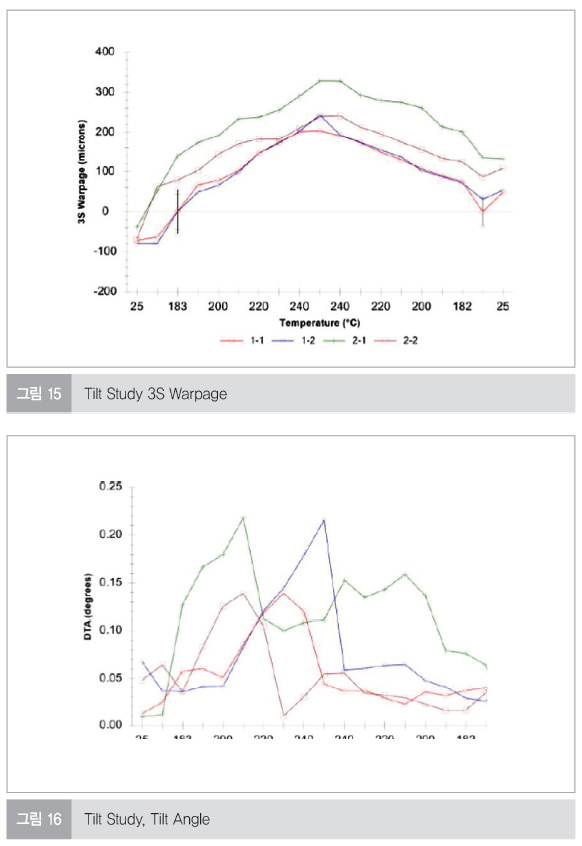

BGA 틸트를 더 이해하기 위해, 몰딩된 표면은 주변 유리의 기준면에 여전히 있지만 1차 평면에 적합하다. 이는 표면의 휨을 없애고, 몰딩과 유리 표면 사이의 상대적인 틸트만 남는다. 1차 표면을 사용하여 샘플 데이터 세트 중 하나에서 수평 중심선 플롯을 추출하였다. 수평 중심선 플롯은 그림 19에서 보는 바와 같이 샘플의 왼쪽에서 오른쪽으로 그린 2D 선이다. 이러한 플롯을 해석하는 동안, 유리에서 BGA까지의 절대 높이가 이들 표면에 반드시 정확한 것이 아니라는 점을 유념해야 한다. 대신에 선 플롯의 틸트 변화에 초점을 맞췄다. 또한 2차 리플 로우을 수행하였으므로, 나열된 온도는 샘플의 왼쪽이 차갑다는 것을 나타낸다. 결과적으로 솔더 액상이 조기에 보일 것이다.
동일한 데이터가 그림 20에서와 같이 수평 중심선을 따라 각도로 표시될 수 있다.
그림 20에서, BGA의 좌측면이 210℃에 있을 때 더 뜨거워진 BGA의 우측면의 영향은 최대화된 BGA 틸트에서 볼 수 있다. 이 경우 우측면은 솔더의 액상점을 통과한 230℃~235℃ 정도이다. 좌측면이 220℃에 도달할 때 틸트가 크게 줄어들고, 이론적으로도 연화되고, 약간 낮아진다.
냉각 사이클 동안의 좌우 온도 차이가 여전히 존재하지만 냉각 면에 대한 틸트 효과는 훨씬 덜 두드러졌다.
요약
온도 상승에 따른 BGA 패키지 휨에서 상단에서부터 하단까지의 온도 균일성이 중요한 역할을 할 수 있다. 온도 균일성이 휨에 미치는 영향은 패키지 디자인에 따라 다르다. ‘균등’ 및 ‘비균일’ 리플로우 사이클을 통해 샘플을 실행할 때, 유사하게 2개의 패키지는 변동하는 열 조건에 반하는 반응이 나타났다. 두 PBGA 샘플의 다이 크기가 눈에 띄게 다르다는 것이 발견되었지만 온도 불균일에 대한 차이에 대한 설명은 명확하지 않았다.
표면 실장 패키지의 상면을 측정하는 실용적인 방법은 그림자 모아레 기법을 사용하여 설명하였다. 측정을 통해 패키지의 기본 PCB에 대한 휨 및 상대적인 틸트를 측정할 수 있었다. 동일한 개념이 Digital Fringe Projection을 포함한 다른 측정 기술에도 적용될 수 있다. 테스트 결과, BGA의 선단에 열을 가하고 특히, 1차 다항식 피팅을 사용하여 휨의 영향을 제거한 후 뜨거운 면으로 향하는 틸트를 측정할 수 있는 것으로 나타났다. 다른 요인들이 패키지에 적용되기에 실제 SMT 조건에서의 패키지 거동이 다를 수 있다.

