최신 2D/3D X-Ray 검사기는 BGA, QFN 및 3D 패키지 내의 불량을 발견하는 파워풀한 툴이다. 또한 동일한 의심스러운 부품에 있어서 빠르고, 확실한 방법을 제공한다. 최근 몇 년 동안, 밀봉형-투과기 X-선 소스, 고품질 디지털 이미지 증배관(imaging intensifiers), 인체공학적 기능을 포함한 X-Ray 테크놀로지의 눈부신 발전은 한 단계 더욱 향상된 수준의 새로운 X-Ray 검사기를 가져왔으며, X-Ray 검사기가 보다 효율적이고, 빠르며 신뢰할 수 있게 하였다.
PCB 집적화와 고밀집화가 진행되고 또한 3D 디바이스가 폭 넓게 적용됨에 따라, 기본적인 제조 공정 중과 PCB 위에 실시되는 일련의 프로세싱 모든 디바이스를 검사하려는 강력한 요구가 현재 강조되고 있다. 더욱 복잡해지고 더욱 밀집된 패키지에는 패키지뿐만 아니라 PCB 내부 양쪽에서 불량을 내포할 경우가 더 많아졌다. 적용 부품 수 증가로 자체 비용이 증가함에 따라 잠재적으로 유망한 기업이 비양심적인 개인과 조직이라는 멍에를 쓸 수도 있다.
최근 몇 년 동안 2D/3D X-Ray 검사기 시스템의 성능이 상당한 발전해 왔다. 새로운 X-선 소스, 디텍터 및 인체공학적 기능들이 검사 프로세스의 효율성과 생산성을 향상시키고 있다.
본고에서는 실제 현장에서 발생하는 예를 들면서 X-Ray 검사기를 이용하여 BGA, QFN 및 3D 패키지 내의 불량을 찾는 방법에 대해 리뷰할 것이다. 보이드, 크랙, 쇼트, 오픈 조인트 및 HIP(Head in Pillow)를 논의할 것이다. 3D 패키지를 조사하기 위해 2D와 3D(CT) X-Ray 검사기 우열의 비교는 예를 들어 나타낸다. 마지막으로는 가성불량을 검출하기 위한 X-Ray 검사기 적용을 논의한다.
서문
전통적으로, 2D X-Ray 검사기의 활용은 중요하고, 동시에 디바이스 생산과 일련의 PCB 어셈블리 모든 측면을 조사함에 있어서 비파괴 방법론을 제공한다. 최근 BGA, QFN, CSP 및 플립칩과 같은 어레이 에어리어 패키지 사용의 증가는 전형적인 광학 기반 검사기를 비효율적으로 만들었다. PCB와의 접합부분이 패키지 아래에 숨어있기 때문이다. 광학을 이용하기 위해서는 어셈블리를 사실상 파괴하여 검사해야 하고, 물리적으로 제거될 필요가 있는 앞단의 디바이스를 측정하는 것을 의미한다. 게다가 디바이스를 물리적으로 제거하는 프로세스 동안, 중요한 정보가 손상되거나 혹은 추가적인 불량을 양산할 수 있다.
X-Ray 검사는 또한 패키지를 열어보지 않아도 개별 패키지 내부의 와이어 및 다이 어테치 품질을 측정하는데 사용된다. 이 기술은 밀폐된 패키지 상태를 유지하면서 가성불량 부품을 검출하는데 매우 편리하다.
시스템 집적화가 증가함에 따라, 패키지-인-패키지(PiP), 패키지-온-패키지(PoP) 등과 같은 새로운 3D 패키지가 표준 리드프레임 패키지를 대체하고 있다. 새로운 패키지들은 서로 다른 톱면, 다층-레벨 와이어 본딩 및 상호접합부 위에 다층 다이들이 적층되어 결합된다. 궁극적인 목표는 어셈블리의 전체 성능을 한층 높이는 회로기판의 밀집도를 더욱 집적화시키는 것이다. 이러한 새롭고 더욱 고도화된 디바이스들은 디바이스 어셈블리, 테스트 및 PCB 상의 일련의 어셈블리 동안 검사와 품질 컨트롤 프로세스이라는 자체적인 요구사항을 충족시켜야만 한다. 일부의 경우, 이처럼 고도로 집적화된 패키지는 전통적인 2D 오블리크 앵글(2D oblique angle) X-Ray 검사기뿐만 아니라 3D CT(Computer Tomography) 기술의 적용이 요구되고 있다. 이는 현대적인 X-Ray 시스템에 의해 제공되는 2D와 3D CT 검사 모드 간의 전환이 신속하고, 간단하게 되어 쉽게 한다. 실용적으로, 현대적인 X-Ray 시스템의 애플리케이션 범위는 전자기기 검사기가 주요 그룹 중의 하나로 지정되어 매우 넓어졌다. 또한 X-Ray는 의료기기뿐만 아니라 또 다른 기계적이고 광학 디바이스 검사에 유용한 툴이다.

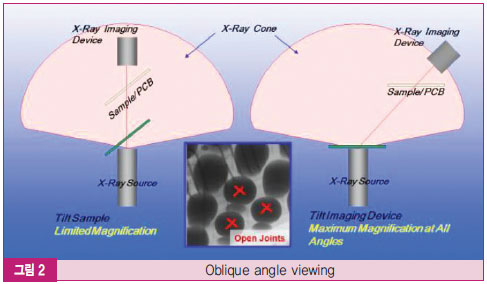
X-Ray 시스템의 기본
2D X-Ray 검사 시스템은 X-선 마이크로스코프가 필수적이다(그림 1 및 그림 2 참조). X-선의 넓은 콘(cone)은 소스(X-선 튜브)에 의해 방사된다. 검사는 X-선 방출 콘 내부에서 샘플을 움직이면서 실시된다. 모든 재료는 자체 밀집도, 원자번호 및 두께에 따라 X-선 방사량을 다르게 흡수한다.
더 두껍거나 혹은 더 밀도가 높은 재질은 더 많은 X-선을 흡수할 것이다. 더 많은 X-선을 흡수했음을 의미하는 보다 더 어두운 에어리어의 회색 음영으로 구성된 결과 이미지는 X-Ray 이미징 장치(보통 매우 높은 품질의 디지털 이미지 증배관(image intensifier) 혹은 평판 패널)에 의해 등록된다. X-선 소스에 더 근접한 샘플은 더 높은 배율수준을 보인다(그림 1 참조). 오블리크 앵글 뷰에서의 검사 성능은 크랙 및 오픈 접합과 같은 불량을 발견하는데 중요하다. 오블리크 혹은 앵글 뷰를 실현하기 위해 이용되는 기술은 일반적으로 두 가지 방법이 있다. ‘샘플 기울이기’ 혹은 ‘이미징 장치 기울이기’가 그것이다. 그림 2에서 보는 바와 같이, 기울어진 이미징 장치 구조는 사선의 각도에서 최대 배율을 얻을 수 있다는 커다란 장점을 가지고 있다.
최신의 X-Ray 머신은 특정 검사 지점 주위에서 360° 회전하면서 동시에 이미지를 얻을 수 있도록 이미징 장치가 거의 70° 기울어져 있다. 이미징 장치가 대상체 주위를 회전하고 모든 방향으로부터 측정하는 동안에 소프트웨어와 하드웨어의 정교한 조합은 FOV(field of view)의 중앙 내에서 관심 있는 지점(불량 발생이 의심스러운 곳)을 유지한다. 이 방법의 추가적인 이점은 샘플을 고정시킬 필요가 없으며, 샘플을 조작하는 동안 낙하, 손상 및 충돌의 위험이 없다는 점이다.
최근 몇 년 동안, X-선 소스 및 디지털 디텍터 테크놀로지는 급격하게 발전해 왔다. 미세한 100나노미터(0.1 미크론)급의 초정밀 인식 기능은 2D 모드뿐만 아니라 12,000X의 시스템 배율 레벨 내에서도 가능하다. 이들의 발전은 더욱 자세하고 미세한 검사를 가능케 하고, 잠재 불량의 검출력도 그 만큼 커졌다. 밀봉형 투과기, 필라멘트-프리(filament-free) X-선 튜브 테크놀로지와의 결합은, 실제 생산 환경 내에서 장비 멈춤 시간을 줄이는 유지보수-프리(maintenance-free) 혹은 유지보수 최소화(minimal maintenance) 작업을 실현하는 더 높은 성능 수준을 제공한다.
최신의 이미징 시스템은 2.0M-pixels, 30 frame/sec 및 65,000 그레이스케일 레벨, 24인치 UHD(ultra-high-definition) LCD 관찰모니터로 구성되어 실시간 디지털 검사성능을 제공한다. 여기에서 중요한 포인트는 이미지 품질의 향상과 증진된 인식 기능이 좀 더 빠르고, 더욱 효과적이면서 더 신뢰할만한 검사 공정을 제공한다는 것이다.
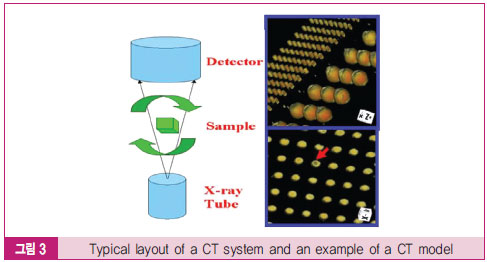
3D CT(Computerized Tomography)
CT(Computerized Tomography)는 하나의 X-Ray 이미징 방법이다. 대상물이 X-선 빔 내에서 360° 회전함으로써 촬영한 여러 장의 개별 2D X-Ray 이미지들을 이용하여 대상물의 3D 가상 모델을 생성하는데 수학적 지오메트릭 프로세싱(mathematical geometric processing)이 이용되고 있다.
CT 시스템의 간략도는 그림 3에서 보여주고 있다. CT 모델이 생성된다면, 3D 모델의 실시간 조작에서 전체 모델 내에서 특정한 2차원적인 평면을 작업자가 조사하도록 허용하는 ‘virtual microsectioning’도 가능하다. 이 경우, 다른 부분으로부터 분리되어져서 패키지 내부의 서로 다른 레이어 및 서로 다른 특징들이 관찰될 수 있다. 이로 인해 다층 상호접합에 의해 감춰져 존재할 수 있는 디바이스 혹은 패키지 내부의 특징을 완벽하게 조사하거나 혹은 불량 검출을 가능하게 한다. 예를 들면, 그림 3에서 보여주는 바와 같이 다층 디바이스 내부에 소형의 100미크론 솔더 범프는 보다 큰 500미크론 BGA 볼에 의해 가려질 수도 있다.
최신의 2D/3D X-Ray 검사시스템은 짧은 시간에 2D에서 3D CT 모드로 전환될 수 있다. 두 가지 기술들이 결합되어 이용된 설비는 파워풀한 비-파괴분석 기능을 제공한다.
BGA 및 QFN 패키지 내의 불량
보이드, 쇼트, 크랙과 같은 일반적인 BGA 불량 그리고 HIP(head-in-pillow) 혹은 HOP(head-on-pillow)는 일반적으로 리플로우 동안 발생한다. 오블리크 앵글의 성능은 크랙 및 HOP 불량 검출에 중요하다. 55~70°의 뷰잉 앵글(viewing angles)을 이용한다. 보이드 및 쇼트들은 톱-다운 뷰(top-down view)를 이용하여 쉽게 관찰된다. 그러나 보이드의 위치를 확인하기 위해서 오블리크 앵글 2D 뷰잉과 3D CT가 매우 유용하다. 그림 4의 앵글 뷰에서는 개별 접합의 신뢰도를 떨어뜨리고, 필드에서 실패 확률을 더욱 높일 가능성이 있는 접합 인터페이스에 밀집된 보이드들을 볼 수 있다.
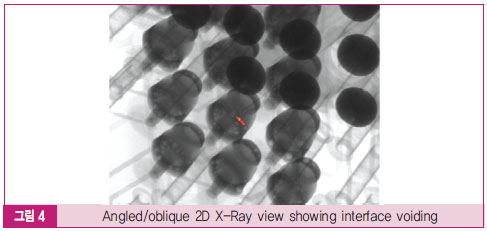
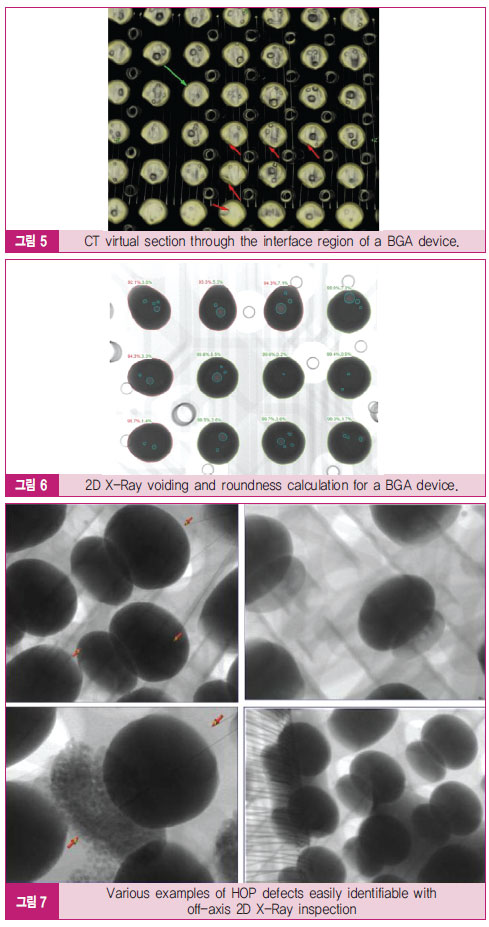
3D CT 기술은 그림 5에서 보는 바와 같이 보이드의 정확한 위치가 발견된 디바이스들을 가상으로 슬라이싱하거나 혹은 크로스섹셔닝을 할 수 있다.
그림 5에서 보는 바와 같이, 많은 양의 계면 보이드가 뚜렷이 보이고, 빨간 색 화살표로 표시된 많은 BGA 볼들이 일그러졌거나 손상되었다. 최근 2DX 머신에는 직경, 보이드 분포 양, 모양 및 BGA 볼 어레이의 정밀 측정을 위해 전자동 루틴이 적용된 특색을 보이고 있다. 그림 6에서와 같이, 원하는 BGA 볼의 형상 혹은 원형 모양(각각의 볼에서 동반한 첫 번째 수치)과 다른 BGA 볼의 불량을 바깥테두리에 빨간색으로 표시되었다. 두 번째 수치는 각각의 BGA 볼에 대한 총 보이드 퍼센트지를 나타내고 있다. 작업자가 허용 가능한 수준을 설정하면, 설비는 특정 값일 때 자동으로 외부로 신호를 보낸다.
HOP(Head-on-pillow)라고 잘 알려진 HIP(Head-in-pillow) 불량은 리플로우 동안 발생한다. 솔더 페이스트가 BGA 볼에 완전하게 젖어들지 않았음에도 PCB 패드에는 젖어든다.
비록 HOP가 최초에는 전기 전도율을 보이지만, 기계적인 강도가 부족하고 최종적으로는 불량이 된다. HOP 불량이 함유된 대부분의 BGA 디바이스의 경우, 초기부터 작동하지 않는다. HOP 불량은 무연 솔더페이스트의 전환으로 더욱 넓게 퍼지기 시작했다. 고온의 리플로우 온도에 의해 유발되는 더욱 심해진 보드 휨과 솔더 볼 이동 때문이다. HOP 불량에 영향을 주는 다양한 요소들로는 솔더 볼 합금, 리플로우 프로파일 타입, 리플로우 피크 온도 및 솔더 페이스트 화학재 등을 꼽을 수 있다.
인라인 X-Ray 검사기(AXI) 혹은 낮은 성능의 2D 설비를 적용했을 때, HOP 불량이 검출하기 어렵지만, 이들 불량은 오블리크 앵글 뷰잉이 장착된 최신의 고성능 2D X-Ray 시스템을 이용하여 신속하고 쉽게 식별될 수 있다(그림 7 참조). 게다가 검사 프로세스는 완벽하게 비파괴로 진행된다.
BGA 중앙에서 존재하는 HOP 불량을 확인하는 다른 실제적인 방법으로는 종단면 절단의 SEM(scanning electron microscope) 혹은 광학적 실험이 있다. 그러나 이 방법은 PCB 및 BGA 부품을 파괴해야만 한다.
그림 7에서는 HOP 불량의 다양한 예들을 보여주고 있다. 이들 불량이 HIP 혹은 더 나은 HOP로써 언급되는지를 확실하게 보여주고 있다. 결함 있는 BGA 솔더 볼이 리플로우 후 싱글 접합이 형성되는 대신에 리플로우된 솔더 페이스트 위에 놓일 수 있다. 그림 8은 BGA 디바이스를 관통하여 HOP 불량을 노출한 3D 영상을 보여주는 가상 CT 마이크로-섹션이다.

HOP 불량 검출을 위한 전통적인 방법으로는 작업자가 55~70°의 오블리크 각도로 설정하는 수동적인 검사방법이 있다. 매우 신뢰할만하지만 이 방법은 시간이 오래 걸리고, 작업자의 집중력이 필요하다. 다음 단계로써, 전자동 HOP 검사 루틴은 작업자가 수동으로 BGA 내부의 각 개별적인 솔더 접합 위치를 검사할 필요 없이 의심스러운 HOP 불량을 확인할 수 있도록 발전되어 왔다. 루틴은 전체 BGA 디바이스를 스캔한다; 정교한 인공지능 알고리즘은 모든 BGA 솔더볼을 분석하고, 스크린 상에 색칠하여 씌워 디스플레이함으로써 작업자가 HOP 불량을 주시할 수 있도록 하는 것이 핵심이다. 이는 솔더 접합 고결성에 추가적인 신뢰를 제공하고, HOP 불량 예방에 도움을 주는 매우 중요한 발전이다.
리드리스(leadless) 패키지의 QFN 타입은 또한 저렴한 비용, 낮은 프로파일, 월등한 전기적 및 열적 파라미터 때문에 더욱 더 대중화되어 가고 있다. 앞서 설명된 장점들 때문에 무선기기, 자동차 전장, 통신 및 많은 다른 애플리케이션에서 널리 이용되고 있다. 가장 대중적으로 많이 알려진 게 QFN이지만, 동일하거나 비슷한 패키지 타입 또한 다른 이름으로 사용된다. 가장 대중적인 대용품은 LGA(Land Grid Array)이다.
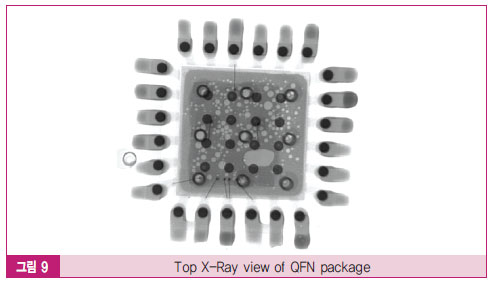
그림 9에서 보는 바와 같이, 패키지 termination들은 디바이스의 아래에 모두 위치해 있다. 이 같은 구조는 전통적인 AOI 검사기를 비현실적으로 만든다. BGA 디바이스의 경우, SEM 혹은 광학 측정기를 위한 종단면 검사가 대안이긴 하지만, 이 방법은 디바이스 및 PCB를 파괴하여 영구적으로 피해를 입힌다.
최신의 2D X-Ray 시스템은 신속하고, 효과적이며 비파괴적인 QFN 검사 방법을 제공한다. 상대적으로 경험이 적은 작업자는 빠르게 평가할 수 있으며, 생산환경 내에서 분석을 정량화할 수 있다. 좋은 배율, 해상도, 명암 감도의 결핍을 지닌 낮은 X-Ray 검사 시스템을 이용하여 높은 각도의 오블리크 뷰잉으로 분석하는 것은 수월하지 않고, 신뢰성도 낮을 것이다.
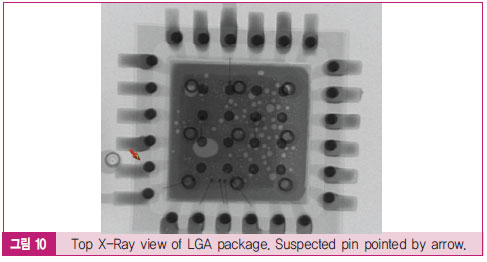
그림 10에서는 의심스러운 핀을 빨간색 화살표가 표시하고 있는 QFN 패키지의 낮은 배율 이미지를 보여주고 있다. X-Ray 시스템의 높은 해상도와 명암 감도 때문에 가능한 결점이 이러한 낮은 배율 이미지에서 조차 또렷이 식별된다.

오블리크 뷰와 더 높은 배율의 시스템은 그림 11에서 보는 바와 같이 자세하게 오픈 핀을 분석할 수 있다. 그러나 낮은 배율의 오블리크 뷰에서 조차도 그림 12에서 보는 바와 같이 충분히 불량을 확인할 수 있다.
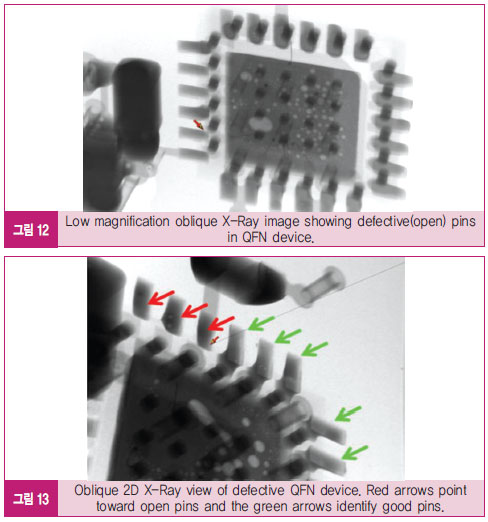
불량 핀들이 낮은 배율 레벨에서 식별될 수 있다는 점은 X-Ray 검사 프로세스가 빠르고, 효율적이며, 신뢰할만하게 한다. 그림 13은 서로 다른 QFN 디바이스의 오블리브 각도의 2D X-Ray 뷰를 나타내고 있다. 빨간색 화살은 우수한 핀들(녹색 화살)과 비교하여 오픈 핀 경향이 있음을 지적하고 있다.
과열을 예방하기 위해 디바이스의 바깥쪽으로 많은 양의 열을 방출할 필요가 있을 때, 어떤 경우에는 추가적으로 측면 접합의 품질, 중앙 커다란 패드 내의 보이드 상태 또한 중대하다는 점을 지적하는 것이 중요하다. 예를 들면 그림 9에서는 고출력 애플리케이션에서 방전과 관계가 있거나 혹은 이유가 되는 중앙 에어리어 내의 심각한 보이드 발생을 보여주고 있다.
3D 패키지들
서브시스템이 집적화되는 트렌드가 지속됨에 따라, PiP, PoP, SiP 및 플립칩 디바이스를 포함한 최첨단 3D 패키지들은 표준 리드-프레임 패키지들을 대체해가고 있다. 이러한 많은 신형 패키지들은 더 높은 회로밀집도와 향상된 전기적 성능 요구를 충족하지만, 늘어난 복잡성은 디바이스 패키징 과정과 일련의 어셈블리 동안의 검사 및 품질 컨트롤 프로세스라는 새로운 도전에 직면하게 했다. 전통적으로, 2D X-Ray 검사기의 적용은 디바이스 생산 및 PCB 프로세싱의 모든 측면에서 중대한 비파괴검사를 가능하게 한다. 그러나 3D 패키지 검사에 있어서 2D X-Ray 영상은 제한적일 수 있다. 디바이스 내의 모든 레이어들이 촬상된 하나의 판에서 동시에 보이기 때문이다. 분석적으로, 와이어본드의 다층 다이들과 다층 레이어들이 X-Ray 이미지 내에서 각각 겹쳐 보일 수 있기 때문에 작업자들에게 혼란을 줄 수 있다.
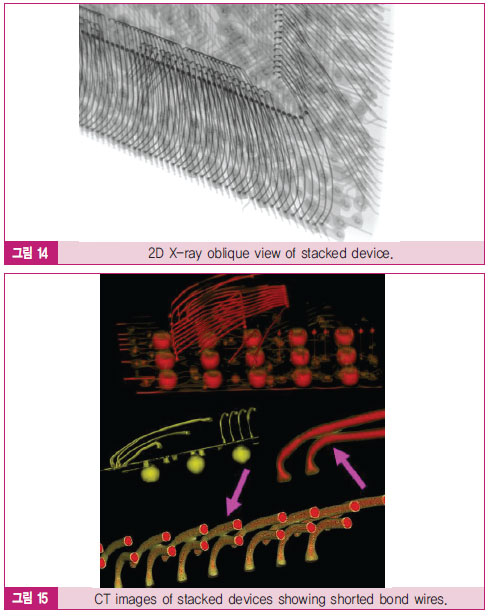
그림 14의 2D X-Ray 영상에서 보는 바와 같이, 적층 디바이스의 2개의 와이어 본딩 레이어들은 쇼트 혹은 오픈 접합을 찾는 분석에서 쉽게 구분할 수 없다.
그림 15는 다양한 적층 디바이스를 보여주는 CT 영상이 결합된 사진이다. CT 기술은 작업자에게 의심스러운 부분만 별도로 분리할 수 있도록 해주며, 가상 마이크로-섹션닝을 이용하여 잠재불량을 조심스럽게 검사할 수 있도록 한다. 그림 15에서 보는 바와 같이, 쇼트된 와이어들은 CT를 이용하여 쉽게 식별되는데, 이는 2D 방법을 이용해서는 쉽고 신뢰할만한 결과를 얻을 수 없다.
파워풀한 CT 기술의 또 다른 예들은 그림 16과 그림 17에서 보여주고 있다.
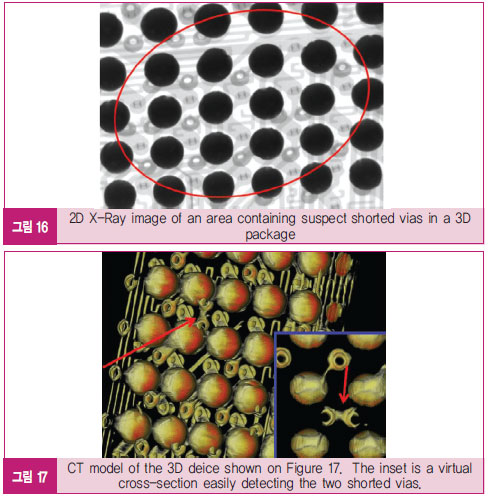
3D 디바이스를 검사한 결과, 그림 16에서 보는 바와 같이 2D X-Ray 이미지에서 가려져 있던 부분 내에서 쇼트된 비아를 가지고 있음을 알 수 있었다. 2D X-Ray 이미지의 복합성 때문에 불량을 확실하게 식별하는 것은 매우 어렵다. 동일한 패키지의 CT 이미지는 그림 17에서 보여주고 있다. CT 이미지는 또한 꽤 복잡하지만 마이크로-섹셔닝 기능은 쇼트된 비아를 별도로 띄워서 쉽게 검사할 수 있게 한다. 그림 17의 하단에 삽입 된 이미지는 CT 이미지를 가상적으로 마이크로-섹션 한 영상을 보여주고 있다.
가성 전자부품들
서플라이 체인을 통한 가성 전자부품들의 문제는 최근 몇 년 동안 증대되고 있으며, 대부분의 보드 어셈블리 업체들은 이들을 수용함으로써, 명성을 잃고 있으며, 비용부분에서도 큰 손실을 보고 있다. 저가의 가성부품는 별도의 테스트를 통해 구별하기 어렵다는 치명적인 경향이 있다. 또한, 가성부품은 릴의 끝단에서 일부 우수한 샘플들을 제공함에 따라 심지어 더욱 구분을 어렵게 만든다.
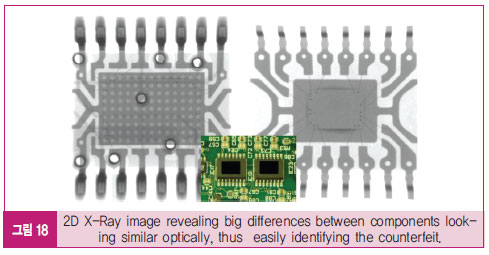
그림 18에서 보는 바와 같이, 실제 및 가상 부품은 광학적으로 매우 비슷하게 보일 수 있지만 X-Ray 영상에서는 큰 차이를 보인다. 최신의 2D X-Ray 검사기를 가성부품을 확인하는데 빠르고 효과적인 방법을 제공한다. 비접촉이고 고 배율을 제공함으로써 해상도와 대비 민감도는 작업자가 다이 실장을 분석하면서 내부 와이어링과 우수한 샘플로 책정된 것과 비교함으로써 가상 부품을 확인하는데 쉽고 확실하게 해 준다.
결론
최신 2D/3D X-Ray 검사기는 BGA, QFN 및 3D 패키지 내의 불량을 발견하는 파워풀한 툴이다. 또한 동일한 의심스러운 부품에 있어서 빠르고, 확실한 방법을 제공한다. 최근 몇 년 동안, 밀봉형-투과기 X-선 소스, 고품질 디지털 이미지 증배관(imaging intensifiers), 인체공학적 기능을 포함한 X-Ray 테크놀로지의 눈부신 발전은 한 단계 더욱 향상된 수준의 새로운 X-Ray 검사기를 가져왔으며, X-Ray 검사기가 보다 효율적이고, 빠르며 신뢰할 수 있게 하였다.
