기술발전으로 저온 무연솔더 성능 개선
적용 가능성 높지만 추가적인 신뢰성 테스트 필요
Sn3Ag0.5Cu 페이스트 합금에 대한 저온 페이스트 합금을 조사한 예비 결과는 유망해 보인다. 제한된 외부 테스트 데이터와 결합된 현재까지 제한된 내부 테스트는 이러한 새롭게 추가된 저온 솔더가 Sn3Ag0.5Cu(SAC305)보다 성능이 동등하거나 우수하다는 것을 나타냈다. 추가적인 테스트 및 평가가 필요하다. 새로운 합금이 추가된 저온 솔더와 추가되지 않는 솔더 간의 차이를 확인하려고 하고 있으며, 낙하/충격 및 더 높은 변형률의 단조 굽힘 테스트를 실시하고 있다.
초록
전자 산업계는 기존 Sn3Ag0.5Cu(SAC305) 솔더에 비해 경제적이면서 제조 공정에 적용이 가능하며 성능을 신뢰할 수 있는 저온 SMT 솔더 재료(합금 성분)를 사용함으로써 큰 ??이점을 얻을 수 있다. 본고에서는 가능한 많은 장점과 몇 가지 단점/과제에 대해 논의한다.
최근까지 Sn/Bi 기반의 솔더는 높은 변형률(드롭 쇼크) 애플리케이션에 부정적인 결과를 초래하는 것으로 조사되어서 이들 합금을 사용하지 않고 있다. 새로운 합금 ‘추가’를 통한 기술 개선으로 많은 애플리케이션에서 SAC305의 가능한 대안으로 Sn/Bi 합금을 재검토하는 문이 열고 있다.
우리는 3개의 저온 솔더와 1개의 SAC305(대조군으로 사용) 솔더페이스트 재료의 제조 가능성과 신뢰성을 테스트했다. 저온 솔더 재료 중 2개는 Sn/Bi/Ag계로 추가된 제품이고, 나머지 1개는 Sn/Bi/Ag1% 제품이었다.
테스트와 관련 결과에 대해 설명하였다. 그리고 마지막으로 이러한 자료의 전망, 적용 및 가능한 영향(이 평가를 기반으로 함)에 대한 향후 조치도 함께 논의할 것이다.
서문
일반적인 SAC305 리플로우 프로파일은 235℃~245℃ 범위의 피크 온도를 가지고 있다. 주석/비스무스 또는 주석/비스무스/은 솔더 합금은 165℃~195℃ 범위의 피크 온도를 사용할 수 있다. 이는 50℃ 이상의 Δ 피크 온도 차이를 의미한다. 명백한 에너지 비용 절감 외에도 저온 솔더(LTS, low temperature solder) 재료를 사용하면 다른 많은 이점이 있다. 본고의 뒷부분에서 이를 설명하고, 더불어 익히 알려진 위험과 알려지지 않은 위험에 대해서도 논의한다.
주석/비스무스 또는 주석/비스무스/은 합금은 업계에 잘 알려져 있으며 TV 및 일부 가전제품과 같이 충격, 낙하, 진동 또는 고온에 노출되지 않는 소비재 제품에 일상적으로 사용되어왔다. 이 합금은 SAC305보다 깨지기 쉽고 크리프 저항성이 더 높다. 따라서 낮은 변형률 응력(온도 변화)에는 적합하지만 높은 변형률 응력(충격, 낙하, 진동, 굽힘 등)에는 적합하지 않다.
일부 솔더 재료 공급 업체는 변형률 신뢰성 측면에서 SAC305에 필적할만한 저온 합금 버전을 개발하기 위해 수년 동안 노력해 왔다.
다년간의 노력으로, 최근 합금을 더욱 연성(延性)화하고 크랙 저항력을 높이는 미량의 ‘도펀트’ 재료가 포함된 ‘비밀’ 레시피를 개발하여 목적에 근접했다. 다른 논문1에서는 구리, 니켈, 망간 및 안티몬과 같은 미량의 원소를 추가하여 격자 및 그레인 구조에 대한 도펀트 효과에 대해 논의하였으므로, 여기서는 자세히 설명하지 않겠다. 하지만 요점은 일부 공급 업체가 대량의 합금(낮은 융점을 유발하는)을 유지하면서 저온 솔더만의 장점을 살리는 적절한 레시피를 찾은 것 같다는 것이다.
우리가 고려한 또 다른 핵심 요소는 진지한 평가를 수행하기 전에 이러한 유형의 재료 공급 업체가 한 곳 이상이어야 한다는 점이었다. 우리는 단일 업체에서만 사용할 수 있는 독점적인 프로세스 또는 재료를 사용하지 않는 경향이 있다.
장점들
저온 솔더(LTS)의 가능한 장점은 다음과 같다.
▶ 보드 및 부품 뒤틀림 감소
▶ 헤드인필로우 감소
▶ 낮은 잔류 응력
▶ 패드 크레이터링(Pad Cratering) 감소
▶ CTE 기하학적 영향(스케일 계수) 감소
- 더 작은 랜드 패드 / 풋프린트 허용
▶ 저렴해진 재료 비용
- PCB
- 부품
▶ 열 노출 감소
- 열에 민감한 부품류 적용 가능
- 반도체류 적용 가능
▶ 낮은 전력소모 및 유지관리 비용
- 프로파일에 따라 전력소모가 20~25% 절감되는 것으로 추정
- 오븐 가동 부품의 낮은 유지보수 비용
▶ 하이브리드 어셈블리 가능
- 한쪽에는 SAC305, 다른 쪽에는 저온 솔더 적용
▶ 보이드 감소
~ 50% 보이드 감소 관찰
단점들
여타의 새로운 재료와 마찬가지로, 재료가 일정 기간 사용되기 전까지 밝혀지지 않은 알려지지 않은 위험이 존재한다. 알려진 위험 중 일부는 다음과 같다:
▶ 패키지 휨 - 고온 균열(Hot Tearing)
- 210℃ 이상에서 평평해지도록 설계된 대형 BGA 패키지의 솔더 조인트에서 ‘고온 균열’을 일으킬 수 있다. 패키지가 완전히 평평해지지 않고 리플로우 주기 동안 뒤틀린 상태를 유지하기 때문에 나타난다. 이에 대한 한 가지 해결책은 갭 차이를 보완하기 위해 더 많은 솔더페이스트를 사용하는 것이다. 저온 솔더 합금은 공격적으로 습윤되는 경향이 없어서, 브리지 없이 단위면적당 더 많은 솔더를 허용할 수 있다. 산업계가 이러한 합금을 대규모로 수용하는 방향으로 움직이면, 패키징 업체가 대응하려고 노력할 것이고, 그렇다면 ‘저온 솔더합금(LTS)’ 버전이 나올 수도 있다.
▶ 재작업
- 솔더 와이어 : 사용이 매우 제한적이며(알려진 소스가 하나뿐이며 아직 시판되지 않음) 부서지기 쉽다.
- 솔더 포트 크랙 : 비스무스는 냉각시에 팽창하기에 일부 솔더 포트(웨이브 솔더)에 크랙을 유발할 수 있다.
▶ 넓은 액상(液相)/고상(固相) 범위
- 컨베이어 리플로우 오븐에서 배출되는 어셈블리가 138℃ 미만임을 보장하기 위해 매우 빠른 냉각이 필요하다는 것을 관찰했다.
▶ 플럭스 잔류물
- 리플로우 후 상당한 양의 플럭스 잔류물이 관찰되었다. 시간이 지나면 이점이 개선될 수 있다.
▶ 더 많아진 슬럼프와 낮은 습윤
- 테스트에서는 대조군 재료보다 약간 더 많아진 슬럼프(뜨겁고 차가운)를 보여 주었으나, 이것은 다시 말하지만 페이스트의 숙성도와 관련이 있을 가능성이 더 크다. 그러나 합금 자체는 SAC305만큼 공격적으로 습윤하지 않으며 특정 상황에서 문제가 될 수 있지만, 여전히 허용 가능한 것으로 나타났다. 경우에 따라, 낮은 습윤은 PIH(Paste in Hole) 애플리케이션에서 이점이 될 수 있다.
실험 및 결과
재료 테스트
테스트된 재료의 정보는 표 1에서 보여주고 있다.

재료 ‘A’는 대조군 SAC305 재료였다. 재료 B와 D는 ‘도핑된’ 합금이며, 재료 C에는 추가된 도펀트가 없었다.
어셈블리 조건
모든 테스트 보드는 솔더 스크린프린팅 전에 베이킹, 검사 및 라벨링 공정을 거쳤다. SPI 공정, SMT 어셈블리 그리고 리플로우 프로세스를 순서대로 수행하였다.
저온 솔더용 리플로우 프로파일
165℃의 낮은 피크 온도를 사용할 수 있지만(적절한 경우 사용해야 함), SAC305 BGA에서 섞이는 것을 유도하기 위해 더 높은 온도인 190℃를 사용했다. 솔더페이스트 및 BGA 볼 인터페이스는 이러한 온도에서 확산을 이끄는 충분한 상 변화를 보이고, 그 후에 BGA 볼과 솔더페이스트가 섞인다.
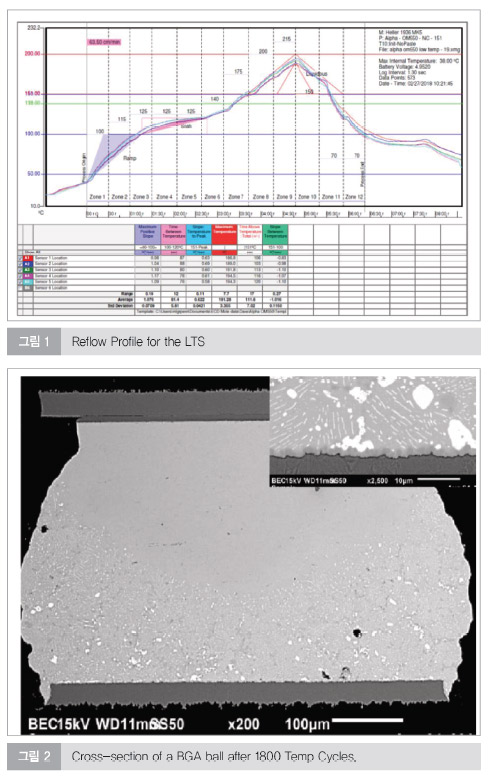
그림 2에 표시된 SnBi 페이스트와 BGA의 혼합은 약 50%이었다. 이는 Time 0 시점과 모든 솔더 조인트의 특성에 맞먹는 수준이며, 혼합 범위 40~60%에 속하는 수준이라고 판명했다.
테스트 방법론
다음의 제조 가능성 및 신뢰성에 초점을 두고 테스트를 수행하였다.
제조 가능성 :
- 솔더페이스트 체적
- 프린팅 누락
- 핫 슬럼프 / 콜드 슬럼프
- 솔더 볼과 2개의 습윤 테스트
- X-ray 검사 및 육안 검사
신뢰성 :
- ATC(Accelerated Thermal Cycling, 0~100℃)-JEDEC 9701
- 4점 단조 굽힘 테스트(4 Point Monotonic Bend Test)-JEDEC 9702
제조 가능성 - 솔더 페이스트 체적
6개의 서로 다른 개구 비율(0.4~1.1 범위)의 솔더페이스트 체적을 측정 및 분석했다. 개구는 8~22mil(0.20mm~0.56mm) 범위였으며, 5mil(0.13mm) 두께의 스텐실을 사용하였다.

그림 3에서는 재료 D가 일관되게 (충분하지만) 다소 적은 체적을 가지고 있음을 보여주고 있다. 모든 재료는 회사 내부 사양을 통과했다.
그림 4에서와 같이 재료 D는 일관되게 (충분하지만) 다소 적은 체적을 가지고 있음을 나타냈다. 모든 재료는 내부 사양을 통과했다.
그림 5를 통해 재료 D가 일관되게 (충분하지만) 다소 적은 체적을 가지고 있음을 알 수 있었다. 모든 재료는 내부 사양을 통과했다.
그림 6의 결과를 통해, 재료 D는 일관되게 (충분하지만) 다소 적은 체적을 가지고 있음을 알게 되었다. 모든 재료는 내부 사양을 통과했다.
그림 7에서 보는 바와 같이, 재료 D는 일관되게 (충분하지만) 다소 적은 체적을 가지고 있었다. 모든 재료는 내부 사양을 통과했다.
그림 8에서는 재료 D가 일관되게 (충분하지만) 다소 적은 체적을 가지고 있음을 보여주고 있다. 모든 재료는 내부 사양을 통과했다.
제조 가능성 테스트 - 프린팅 누락
이 테스트에서 직경 6~16mil(0.15mm~0.40mm)의 원형 개구가 테스트 보드의 3개 위치에 프린팅하였고, 누락된 프린팅 위치가 있는지 검사했다. 각 개구에 대한 프린팅 누락의 수를 계산하였다. 6mil(0.15mm) 개구에서 전부 프린팅될 것이라고 기대하지는 않았다. 직경 8mils(0.20mm)~16mils(0.40mm)의 개구에 프린팅 누락이 없었으므로, 모든 재료는 통과했다.
제조 가능성 - 습윤 테스트 1
이 테스트에서, 대형 Cu 패드에 페이스트 원형을 프린팅하였고, 리플로우 후 직경을 측정했다. 직경 항목에서 이 테스트에 대한 사양 합격/불합격 기준이 없었다. 재료의 습윤 특성을 수치화하기 위해 사용하였다. 저온 솔더는 제어된 재료만큼 습윤되지 않았다. 이러한 특성은 PIH(Paste in Hole) 애플리케이션에서 이점이 될 수 있다.
제조 가능성 - 습윤 테스트 2
이 테스트에서, 90%에서 120%까지의 패드 길이에서 5% 간격의 직사각형 패드 위에 페이스트를 증착했다. 그런 다음 패드를 완전하게 뒤덮을 수 있는 최소의 비율을 찾았다.
표 3에서 보는 바와 같이, 저온 재료는 Sn3Ag0.5Cu 페이스트 재료만큼 습윤되지 않았다.
제조 가능성 - 콜드 슬럼프
이 테스트에서는 0.075mm(3mils) ~ 0.300mm(12mils) 간격으로 여러 줄을 프린팅하고, 각 간격에서 브리지 된 선의 수를 세었다. 페이스트 모두 비슷하게 수행하였으나 저온 솔더 재료는 조금 더 슬럼프를 주었다. 전체 순위는 다음과 같다:
Rank 1 - Material D(3개 보드의 평균 브리지 120개)
Rank 2 - Material A(3개 보드의 평균 브리지 125개)
Rank 3 - Material B(3개 보드의 평균 브리지 185개)
Rank 4 - Material C(3개 보드의 평균 브리지 196개)
제조 가능성 - BGA 보이드
재료 사이에서 현저한 성능 차이 없이 테스트 한 모든 솔더페이스트의 BGA 볼에서 약 1%~10% 사이의 보이드가 관찰되었다. BGA 볼이 완전하게 용융되지 때문에 ‘수용’ 상태를 크게 변경하지 않았다.
제조 가능성 - QFN 보이드
한 가지 놀라운 결과는 QFN/BTC 부품 하에서 저온 페이스트 재료가 얼마나 잘 수행되는지 였다. 대조군 SAC305 페이스트 재료의 보이드는 평균 9.9%였지만, 저온 재료는 페이스트 ‘C’의 경우가 1.8%, 페이스트 ‘B’가 5.9%, 페이스트 ‘D’는 8.4%였다. 이러한 결과는 그림 16, 그림 17, 그림 18, 그림 19에 나와 있다.
신뢰성 ? 4점 단조 굽힘 테스트
JEDEC 9702 권장 절차에 따라 각 페이스트 유형의 4개 보드 상에서 4점 단조 굽힘 테스트를 수행했다. 단일 35×35 데이지체인 BGA를 62mils(1.6mm) 두께의 각 4 레이어 테스트 보드에 장착했다.
변형 비율은 4mm/sec의 일정한 목표 헤드 속도로 구동되어 5k με/sec(초당 마이크로 스트레인)과 8k με/sec 사이의 변형율 응답을 불러왔다.
하나의 재료(재료 ‘D’)에는 대량의 재료 불량에 앞서 데이지체인이 열린 곳에서 두 개의 비정상적인 판독 값이 있었다. 이는 패키지 주변에서의 약화이거나 손상된 솔더 조인트일 수 있다. 이 작은 샘플 세트는 초기 1 단계 근사치를 얻기 위한 것이었다.
후속 테스트를 계획하고 있다. 3배의 변형률(15K με/sec)로 8개의 보드를 테스트할 것이다. 또한 모든 재료에 대한 낙하 테스트를 수행할 예정이다. 페이스트 간의 차이는 페이스트 재료 간의 차이보다 적었으나, 여전히 성능 순위를 매길 수 있었다. 첨가된 Material ‘B’는 Sn3Ag05Cu 대조군을 약간 능가했고, 다른 물질은 대조군과 비슷하거나 약간 낮았다. Material D의 범위가 가장 넓었다.
다음으로는, 응력 및 연속성 응답 곡선에서 실선은 변형 측정(센서가 하단에 배치되었기 때문에 반대로 생성)이고 점선(각 보드에 상응하는 색상)은 데이지체인이다. 점선(데이지체인)은 회로에 장애가 발생하면 빠르게 ‘Open’된다. 신호 샘플링은 지정된 속도인 500/sec의 4배인 2K/sec이다.
그림 20에서 보는 바와 같이, 테스트 한 4개의 보드 중 2개가 대량 재료보다 먼저 불량이 나타났다. 이 재료는 가장 높고 가장 낮은 응답 범위(각각 9311με 및 7313με)를 보였다. 조기 불량을 이해하려면 추가적인 평가가 필요하다.
그림 21에서는, 하나의 보드(검은색으로 표시됨)에서 약간 이른 시점에 불량이 발생했다(대량 불량 이전). 이는 손상된 솔더 조인트일 수도 있다. 아울러, 약간의 솔더 합금 구성의 차이에 의해 나타낼 수도 있다. 이러한 현상을 확인하려면 더 많은 정보가 필요하다.
그림 22에서는, 연속성 오류는 테스트한 모든 보드의 대량 불량과 직접적으로 일치함을 보여주고 있다. 흥미롭게도 이들 보드는 보드 랜드 패드-to-보드 인터페이스에서 대부분 불량이 나왔지만, 이 재료는 가장 강력한 반응을 보이지 않았다.
그림 23에서는, 샘플 ‘B’ 보드가 대조군 재료와 유사한 거동을 보였지만 하나(파란색)의 보드는 대량 솔더 불량보다 약간 앞서 오픈되었음을 보여주고 있다.
표 4에서는, 재료 간의 차이는 각 재료 내부의 차이보다 적었음을 나타내고 있다. 이는 통계적 차이가 거의 없거나 전혀 없음을 나타낸다. 재료 ‘D’의 슬로프와 범위를 추가로 연구하여 이것이 전형적인 현상인지 아니면 이상 현상인지 확인해야 한다. 추가 테스트가 진행 중이다.
그림 24에서 보는 바와 같이, Material ‘B’가 가장 좋은 성능을 보였고 Material ‘D’가 가장 나빴다.
불량 모드는 염료침투분석(Dye & Pry), X-section 후에 분석하였으며, 2개의 주요 불량 모드가 존재했다. 대조군 Sn3Ag0.5Cu 재료는 대부분 보드 랜드 패드 아래에서 불량이 나왔고(그림 25의 Type 5 불량 모드로 표시), 일부 보드 재료를 많이 끌어당긴(패드 크레터링(pad cratering)과 유사한 현상) 반면에 저온 재료는 기판 측면의 많은 솔더 접합부에서 IMC(intermetallic) 바운더리를 뚫는 경향이 있었다(그림 25의 Type 4 불량 모드 참조).
흥미롭게도 가장 강력한 포인트는 전통적으로 보드 랜드 패드와 보드 간의 접합이었다. 제한된 이번 테스트에서 대조군 재료는 가장 강한 반응을 보이지 않았다. 이것은 SAC-305 리플 로우 프로파일의 더 높은 공정 온도가 패드-to-보드 강도에 영향을 미친다는 것을 의미할 수도 있다.
Type 1 - Failure between component substrate and pad
Type 2 - Failure IMC between ball and component pad
Type 3 - Failure within solder
Type 4 - Failure IMC between ball and board pad
Type 5 - Failure between pad and board (Pad Cratering)
신뢰성 - ATC 테스트
ATC(가속온도주기) 테스트를 수행하기 위해 JEDEC 9701의 권장 절차를 따랐다. 다중의 데이지체인과 0 Ohm 부품을 4-레이어 PCB에 장착했다. 보드는 62mil(1.6mm) 두께였으며 각 솔더 재료에 18~20개의 보드가 사용되었다. 보드는 10분 램프/dwell 시간과 함께 0~100℃의 40분 온도 사이클을 적용하였다. 다음 4개의 부품에 대한 200 사이클 간격의 전기 연속성을 측정했다.
▶ 1196 PBGA, 35×35mm, 1.0mm 피치, SAC305 (u309)
▶ 196 PBGA, 15×15mm, 1.0mm 피치 SAC305 (u1)
▶ 64 CBGA, 9×9mm, 0.8mm 피치, SAC305 (u300)
▶ 2512 박막 세라믹 0Ohm 레지스터 (R350)
본 고 작성 시점에, 2512 박막 세라믹 0Ohm 레지스터 이외의 특정 부품에서 아주 작은 불량으로 4200 사이클에 도달했다. 솔더페이스트 ‘D’ 보드는 다른 페이스트 기판과 동시에 어셈블리되지 않았기 때문에 본고 작성 시점에서 특정 불량 없이 1000번의 온도 사이클만 완료했다.
그림 28에서 보는 바와 같이, 저온 합금(비스무스 함유)은 상대적으로 낮은 변형률 테스트 동안 대조군 재료 ‘A’를 약간 능가했다.
환경 영향 및 잠재적 비용 절감
50도 이상의 피크 온도 델타와 전체적으로 낮은 온도 프로파일로, 리플로우 프로세스 동안 에너지 소비가 매우 감소한다는 점이 분명히 밝혀져야 한다. 이러한 저온 솔더는 SAC305에 비해 리플로우 전력소모 비용을 20~25% 절감하는 것으로 추정된다.
또한 이들 저온 솔더를 사용하면 CO2 배출량을 주당 1.1미터 톤까지 줄일 수 있을 것으로 추정된다.[1] 이는 연간 평균 휘발유 차량(미국에서 운전) 10대에 해당한다.
결론
Sn3Ag0.5Cu 페이스트 합금에 대한 저온 페이스트 합금을 조사한 예비 결과는 유망해 보인다. 제한된 외부 테스트 데이터와 결합된 현재까지 제한된 내부 테스트는 이러한 새롭게 추가된 저온 솔더가 Sn3Ag0.5Cu(SAC305)보다 성능이 동등하거나 우수하다는 것을 나타냈다.
추가 테스트 및 평가가 필요하다. 새로운 합금이 추가된 저온 솔더와 추가되지 않는 솔더 간의 차이를 확인하려고 하고 있으며, 낙하/충격 및 더 높은 변형률의 단조 굽힘 테스트를 실시하고 있다.

