본 발명은 리플로우 처리장치 및 리플로우 처리방법에 관한 것으로서 챔버의 천정벽 부분에는 샤워 헤드가 재치대에 대향하도록 설치되고 있고 샤워 헤드의 하면에는 다수의 가스 토출구멍이 설치되고 그 중앙부근에는 가스 토출구멍의 사이에 센서가 배치되고 있는 리플로우 처리 동안 센서에 의해 레지스트 패턴의 막두께 또는 선폭을 측정해, 리플로우 처리의 종점 검출을 실시하는 기술을 제공한다.
배경 기술
액티브·매트릭스형 액정표시장치는 박막 트랜지스터(TFT)를 형성한 TFT 기판과 컬러 필터를 형성한 대향 기판의 사이에 액정을 끼워 넣어 보완하고 화소마다 선택적으로 전압을 인가할 수 있도록 구성되고 있다. 여기서 이용되는 TFT 기판의 제작 과정에서는, 포트리소그래피 공정에 의한 포토레지스트 등의 감광성 재료의 패터닝이 반복해 행해지기 때문에 포트리소그래피 공정마다 마스크 패턴이 필요하다. 그러나 최근에는 액정표시장치의 고집적화와 미세화의 진전에 수반하여 그 제조 공정이 복잡화하고 있어 제조 코스트가 증가하는 경향에 있다. 거기서, 제조 코스트를 저감하기 위하여 포트리소그래피를 위한 마스크 패턴의 형성 공정을 통합시켜 전체의 공정수를 삭감하는 것이 검토되고 있다. 마스크 패턴의 형성 공정수를 삭감하는 기술로서 패턴 형성된 레지스트에 유기용제를 침투시키는 것으로 레지스트를 연화시켜, 패턴 형상을 변화시키는 것에 의해 마스크 패턴의 형성 공정을 생략할 수 있는 리플로우 프로세스가 제안되고 있다(예를 들면, 일본국 특개2002-334830호 공보:특허 문헌 1). 이러한 리플로우 프로세스에는 챔버 방식의 리플로우 처리 장치를 이용하는 것이 제안되고 있다(예를 들면, 일본국 특개 2003-158054호 공보:특허 문헌 2). 리플로우 기술에서는 포트리소그래피공정의 회수를 삭감할 수 있을 뿐 아니라 레지스트의 소비량을 절감 할 수가 있다고 하는 메리트도 가지고 있다.
종래의 리플로우 처리에 있어서는 리플로우 처리 장치의 챔버 내에서 기판 표면의 레지스트를 용제 환경에 폭로하는 시간에 의해 리플로우 처리의 종점을 관리하고 있다. 그렇지만, 리플로우 처리는, 일단 건조해 고체화 한 레지스트에 용제를 침투시켜 다시 연화시키는 프로세스인 것으로부터, 레지스트의 재질, 사용하는 용제의 종류, 용제 농도, 용제를 포함한 기체의 공급량과 배기량의 밸런스, 처리 온도 등의 조건에 의해 레지스트의 유동 속도(즉, 리플로우 처리 속도)에 차이가 생긴다. 따라서 시간관리만에 의해 리플로우 처리의 종점을 정확하게 파악하는 것은 곤란하고, 리플로우의 정도에 격차가 생겨, 유동화·변형한 레지스트에 의한 피복이 불충분하게 되거나 반대로 리플로우가 너무 진행되어 불필요한 영역까지 레지스트로 피복되어 버린다, 혹은 용제를 무단으로 소비해 버리는 등의 문제가 생기는 일이 있다. 또, 특허 문헌 2와 같은 챔버 방식의 리플로우 처리 장치의 경우 챔버내에서 용제의 유량이나 농도에 일정한 분포가 생기기 쉽기 때문에 기판면내에서 리플로우 속도에 차이가 생겨, 처리 얼룩이 발생하는 원인이 되고 있다.
발명의 내용
효 과
본 발명에 의하면, 리플로우 처리 장치에 있어서, 레지스트의 변형의 정도를 검출하는 측정부를 구비하였으므로 상기 측정부에 의해 리플로우 처리의 진행 정도를 모니터함으로써, 리플로우 처리의 종점 검출을 용이하게 실시하는 것이 가능하게 된다. 또, 상기 측정부에 의한 측정 결과를 리플로우 처리 조건에 반영시키는 것으로, 리플로우 처리 조건을 최적화할 수가 있다. 따라서, 기판면내에서 리플로우 처리 결과의 균일화나, 기판간에서의 리플로우 처리 결과의 균일화를 도모하는 것이 가능하게 된다.

발명의 실시를 위한 구체적인 내용
그림들을 참조하면서, 본 발명의 바람직한 형태에 대해서 설명한다. 그림 1은 본 발명의 리플로우 처리 장치가 탑재된 리플로우 처리 시스템의 전체를 나타내는 개략 평면도이다. 여기에서는, LCD용 유리 기판(이하, ‘기판’, G)의 표면에 형성된 레지스트막을 현상 처리 후에 연화시켜 변형시키고 하층막을 에칭할 때의 에칭 마스크로서 재사용하기 위한 리플로우 처리를 행하는 리플로우 처리 유닛과 이 리플로우 처리에 앞서 표면 개질 처리를 행하는 애드히젼유닛트를 구비한 리플로우 처리 시스템을 예로 들어 설명함으로 한다. 리플로우 처리 시스템(100)은, 도시하지 않는 기판 반송 라인을 개재시켜, 외부의 레지스트 도포·현상 처리 시스템이나 노광 장치, 에칭 장치, 어싱 장치 등의 사이에 기판(G)의 복수를 행할 수 있도록 구성되고 있다.
리플로우 처리 시스템(100)은, 복수의 기판(G)을 수용하는 카세트(C)를 재치하는 카세트 스테이션(반입출부, 1)과 기판(G)에 리플로우 처리 및 이것에 선행해 행해지는 표면 개질 처리를 포함한 일련의 처리를 가하기 위한 복수의 처리 유닛을 구비한 처리 스테이션(처리부, 2)과 리플로우 처리 시스템(100)의 각 구성부를 제어하는 제어부(3)를 구비하고 있다. 또한 그림 1에 있어서 리플로우 처리 시스템(100)의 긴 방향을 X방향, 수평면상에 있어서 X방향과 직교하는 방향을 Y방향으로 한다.
카세트 스테이션(1)은 처리 스테이션(2)의 한쪽의 단부에 인접해 배치되고 있다. 카세트 스테이션(1)은 카세트(C)와 처리 스테이션(2)의 사이에 기판(G)의 반입출을 행하기 위한 반송 장치(11)을 구비하고 있고 카세트 스테이션(1)에서 외부에 대한 카세트(C)의 반입출을 한다. 또, 반송 장치(11)는 카세트(C)의 배열 방향인 Y방향을 따라 설치된 반송로(10)상을 이동 할 수 있는 반송 아암(11a)을 가지고 있다. 반송 아암(11a)은 X방향에의 진출·퇴피 및 회전 가능하게 설치되고 있고 카세트(C)와 처리 스테이션(2)의 사이에 기판(G)의 수수를 행할 수 있도록 구성되고 있다.
처리 스테이션(2)은 기판(G)에 대해서 레지스트의 리플로우 처리, 그 사전 처리로서 표면 개질 처리 등을 행하기 위한 복수의 처리 유닛을 구비하고 있다. 이것들 각 처리 유닛에 있어서 기판(G)은 1매씩 처리된다. 또, 처리 스테이션(2)은 기본적으로 X방향으로 연장하는 기판(G) 반송용의 중앙 반송로(20)를 가지고 있고 중앙 반송로(20)를 사이에 두고 그 양측으로 각 처리 유닛이 중앙 반송로(20)에 임하도록 배치되고 있다. 또, 중앙 반송로(20)에는 각 처리 유닛과의 사이에 기판(G)의 반입출을 행하기 위한 반송 장치(21)가 구비되어져 있고 처리 유닛의 배열 방향인 X방향으로 이동 할 수 있는 반송 아암(21a)을 가지고 있다. 또한 반송 아암(21a)은 Y방향에의 진출·퇴피, 상하 방향에의 승강 및 회전 가능하게 설치되고 있고 각 처리 유닛과의 사이에 기판(G)의 반입출을 행할 수 있도록 구성되고 있다.
처리 스테이션(2)의 중앙 반송로(20)를 따라 한쪽 측에는, 카세트 스테이션(1)의 측으로부터, 애드히젼유닛(AD, 30) 및 리플로우 처리 유닛(REFLW, 40)이 이 순서로 배열되어 중앙 반송로(20)를 따라 다른 쪽 측에는 3개의 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c)이 일렬로 배열되고 있다. 각 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c)은 수직 방향으로 다단에 적층 배치되고 있다. 애드히젼유닛(AD, 30)은, 리플로우 처리에 앞서, 기판(G)에 대해 예를 들면 HMDS(헥사메틸실라잔), TMSDEA(N-트릴시릴리디에틸아민) 등의 시릴화별로 대표되는 표면 개질 처리제를 포함한 환경을 형성하고 레지스트의 유동을 억제하기 위한 표면 개질 처리를 행한다. 이들의 표면 개질 처리제는 소수화 처리 작용을 갖고 소수화 처리제로서도 알려져 있다.
리플로우 처리 유닛(REFLW, 40)은 기판(G)상에 형성된 레지스트를 유기용매, 예를 들면 시너 환경로 연화시켜 마스크 패턴 형상을 변화시키는 리플로우 처리를 행한다. 리플로우 처리 유닛(REFLW, 40)의 상세한 것에 대해서는 후술한다.
3개의 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c)에는, 각각 기판(G)에 대해서 가열 처리를 실시하는 핫 플레이트 유닛(HP), 기판(G)에 대해서 냉각 처리를 실시하는 쿨링 플레이트 유닛(COL)이, 다단에 겹쳐져 구성되고 있다. 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c)에서는 표면 개질 처리 후 및 리플로우 처리 후의 기판(G)에 대해서 필요에 따라서 가열 처리나 냉각 처리가 행해진다.
그림 1에 나타나는 바와 같이 리플로우 처리 시스템(100)의 각 구성부는, 제어부(3)의 CPU를 구비한 컨트롤러(90)에 접속되어 제어되는 구성으로 이루어져 있다. 컨트롤러(90)에는 공정관리자가 리플로우 처리 시스템(100)을 관리하기 위해서 커멘드의 입력 조작 등을 실시하는 키보드나, 리플로우 처리 시스템(100)의 가동 상황을 가시화해 표시하는 디스플레이등으로 이루어지는 유저 인터페이스(91)가 접속되고 있다. 또, 컨트롤러(90)에는 리플로우 처리 시스템(100)으로 실행되는 각종 처리를 컨트롤러(90)의 제어에서 실현하기 위하여 제어 프로그램이나 처리 조건 데이터 등이 기록된 레시피가 격납된 기억부(92)가 접속되고 있다. 그리고 필요에 따라서 유저 인터페이스(91)로부터의 지시등에서 임의의 레시피를 기억부(92)로부터 호출해 컨트롤러(90)에 실행시키는 것으로 컨트롤러(90)의 제어 하에서 리플로우 처리 시스템(100)에서의 원하는 처리를 행한다. 또, 상기 레시피는 예를 들면, CD-ROM, 하드 디스크, 플렉시블 디스크, 플래시메모리 등의 컴퓨터 독취 가능한 기억 매체에 격납된 상태의 것을 이용하거나 혹은, 다른 장치로부터 예를 들면 전용회선을 개재시켜 수시 전송시켜 이용하거나 하는 것도 가능하다.
이상과 같이 구성되는 리플로우 처리 시스템(100)에 있어서는 우선, 카세트 스테이션(1)에 있어서, 반송 장치(11)의 반송 아암(11a)이 이미 레지스트 패턴이 형성된 기판(G)을 수용하고 있는 카세트(C)에 액세스 해 1매의 기판(G)을 꺼낸다. 기판(G)은 반송 장치(11)의 반송 아암(11a)로부터 처리 스테이션(2)의 중앙 반송로(20)에의 반송 장치(21)의 반송 아암(21a)에 인도되어 이 반송 장치(21)에 의해 애드히젼유닛(AD, 30)에 반입된다. 그리고 애드히젼 유닛(AD, 30)에서 리플로우 처리에 앞서 표면 개질 처리가 행해진 후, 기판(G)은 애드히젼유닛(AD, 30)으로부터 반송 장치(21)에 의해 꺼내져 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c)의 어느 쪽인가에 반입된다. 그리고 각 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c) 에 있어서 냉각처리가 실시된 기판(G)은 리플로우 처리 유닛(REFLW, 40)에 반입되어 거기서 리플로우 처리가 행해진다.
리플로우 처리 종료 후는 필요에 따라서 각 가열·냉각 처리 유닛(HP/COL; 80a, 80b, 80c) 에 있어서 소정의 가열, 냉각 처리가 실시된다. 이러한 일련의 처리가 종료한 기판(G)은 반송 장치(21)에 의해 카세트 스테이션(1)의 반송 장치(11)에 인도되어 임의의 카세트(C)에 수용된다.
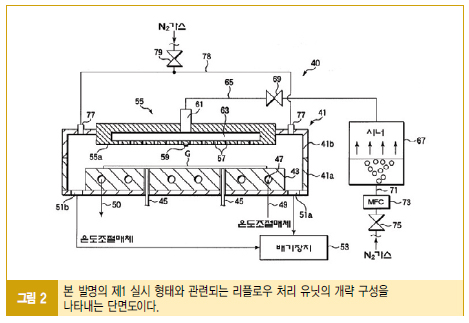
다음에, 본 발명의 제1 실시 형태와 관련되는 리플로우 처리 유닛에 대해서 상세하게 설명한다. 그림 2는 본 발명의 제1 실시 형태와 관련되는 리플로우 처리 유닛(REFLW, 40)을 나타내는 개략 단면도이다. 리플로우 처리 유닛(REFLW, 40)은 챔버(41)를 가지고 있고 챔버(41)는, 하부 용기(41a)와 하부 용기(41a)의 상부에 접해지는 상부 용기(41b)로 구성되고 있다. 상부 용기(41b)와 하부 용기(41a)라는 것은 개폐 기구에 의해 개폐 가능하게 구성되고 있어 열린 상태시에 반송 장치(21)에 의해 기판(G)의 반입출이 행해진다.
상기 챔버(41)내에는, 기판(G)를 수평에 지지하는 재치대(43)이 설치되고 있다. 재치대(43)는 열전도율이 뛰어난 재질 예를 들면 알루미늄으로 구성되고 있다. 재치대(43)에는 승강기구에 의해 구동되어 기판(G)을 승강시키는 3개의 승강 핀(45)이 재치대(43)를 관통하도록 설치되고 있다. 승강 핀(45)은 반송 장치(21)의 사이에 기판(G)을 수수할 때에는 재치대(43)의 표면으로부터 돌출하고 기판(G)을 재치대(43)로부터 들어 올려 소정의 높이 위치에서 지지하고 기판(G)의 리플로우 처리 중은 예를 들면 그 선단이 재치대(43)의 상면과 같은 높이가 되도록 하여 유지된다.
재치대(43)의 내부에는 온도 조절 매체 유로(47)가 설치되고 있고 온도 조절 매체 유로(47)에는 예를 들면 온조냉각수 등의 온도 조절 매체가 온도 조절 매체 도입관(49)을 개재시켜 도입되어 온도 조절 매체 배출관(50)으로부터 배출되어 순환하고 그 열(예를 들면 냉열)이 재치대(43)를 개재시켜 기판(G)에 대해서 전열기 이것에 의해 기판(G)의 처리면이 원하는 온도에 제어된다. 하부 용기(41a)의 바닥부에는 배기구(51a, 51b)가 형성되고 있어 있고 배기구(51a, 51b)에는 배기 장치(53)이 접속되고 있다. 그리고 배기 장치(53)를 작동시킴으로써 챔버(41) 내의 환경 가스가 배기된다. 챔버(41)의 천정벽 부분에는 샤워 헤드(55)가 재치대(43)에 대향하도록 설치되고 있다. 샤워 헤드(55)의 하면(55a)에는 다수의 가스 토출구멍(57)이 설치되고 있다. 또, 샤워 헤드(55)의 하면(55a)의 중앙 부근에는 가스 토출구멍(57)의 사이에 센서(59)가 배치되고 있다.
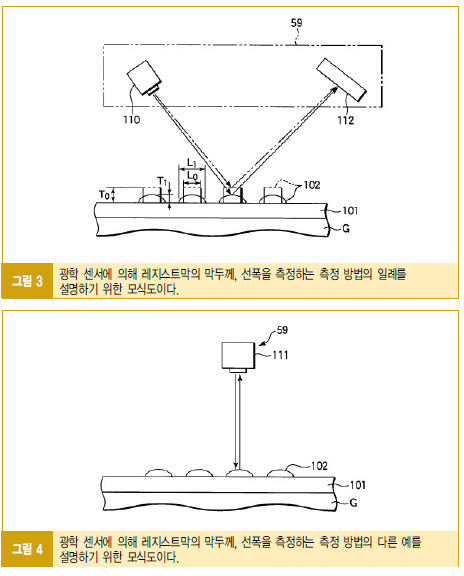
이 센서(59)는 광학 센서이고 그림 3에 나타나는 바와 같이 기판(G)의 피에칭 층(101)보다 상층에 설치된 패턴 형성된 레지스트막(102)에 조사부(110)로부터 소정 파장의 빛을 조사하고 그 반사광을 수광부(112)에 있어서 다파장 영역에서 검지하고 미리 계산한 이론 값으로부터 구해지는 스펙트럼의 프로 파일과 검지된 스펙트럼의 프로 파일을 조합함으로써 레지스트막(102)의 단면 형상, 막두께, 선폭 등을 측정하는 것이다. 그리고 센서(59)를 이용한 리플로우 처리의 종점 검출은 리플로우 처리에 의해 레지스트가 연화·유동화해, 레지스트막(102)이 그림 3 중 2점 쇄선으로 나타내는 리플로우 처리전의 상태로부터 실선으로 나타내는 상태에 변형한 것을 그 형상의 변화로부터 검지함으로써 행해진다. 즉, 리플로우 처리에 의해 레지스트막(102)의 막두께가 T0로부터 T₁에 감소하는 경우 또는 선폭이 L0로부터 L₁에 증가하는 경우 미리 리플로우 처리의 종점 설정 값으로서 막두께(T₁) 또는 선폭(L₁)을 프로세스 레시피의 일부로서 제어부(3)의 기억부(92)에 보존해 둔다. 그리고 보존된 이들 종점 설정값의 막두께(T₁) 또는 선폭(L₁)과 센서(59)로부터의 막두께 또는 선폭의 측정 데이터를 컨트롤러(90)가 조합해 측정된 막두께 또는 선폭이 종점 설정값의 막두께(T₁) 또는 선폭(L₁)에 이른지 아닌지를 판정함으로써 리플로우 처리의 종점 검출을 실시할 수가 있다. 또한 센서(59)로서는, 그림 4에 나타나는 바와 같이 조사부와 수광부가 일체로 형성된 조사·수광부(111)로부터 기판(G)의 표면에 향하여 소정 파장의 빛을 수직에 조사해 그 때의 반사광을 검지하는 방식의 것이라도 좋다.
샤워 헤드(55)의 상부 중앙에는 가스 도입부(61)가 설치되고 있고 가스 도입부(61)는 샤워 헤드(55)의 내부에 형성된 공간(63)에 연통하고 있다. 가스 도입부(61)에는 배관(65)이 접속되고 있다. 배관(65)에는 유기 용매 예를 들면 시너를 기화해 공급하는 버블러-탱크(67)가 접속되고 그 도중에는 개폐 밸브(69)가 설치되고 있다. 버블러-탱크(67)의 바닥부에는 시너를 기화시키기 위한 기포 발생 수단으로서 N₂가스 공급원에 접속된 N₂가스 공급 배관(71)이 배치되고 있다. N₂가스 공급 배관(71)에는 매스 플로우 컨트롤러(73) 및 개폐 밸브(75)가 설치되고 있다. 또, 버블러-탱크(67)는 내부에 저장되는 시너의 온도를 소정 온도에 조절하기 위한 온도 조절 기구를 구비하고 있다. 그리고 N₂가스 공급원으로부터 N₂가스를 매스 플로우 컨트롤러(73)에 의해 유량 제어하면서 버블러-탱크(67)의 바닥부에 도입함으로써 소정 온도에 온도 조절된 버블-탱크(67)내의 시너를 기화시키고 배관(65), 가스 도입부(61)을 개재시켜 챔버(41) 내에 도입할 수 있도록 구성되고 있다. 또, 챔버(41)의 천정벽에 있어서의 샤워 헤드(55)의 주위에는 복수의 퍼지 가스 도입부(77)가 설치되고 있고 각 퍼지 가스 도입부(77)에는 예를 들면 퍼지 가스로서의 N₂가스를 챔버(41)내에 공급하는 퍼지 가스 공급배관(78)이 접속되고 있다. 퍼지 가스 공급 배관(78)은 퍼지 가스 공급원에 접속되고 있고 그 도중에는 개폐 밸브(79)가 설치되고 있다. 이러한 구성의 리플로우 처리 유닛(REFLW, 40)에 있어서는

예를 들면 그림 5에 나타내는 스텝 S1~S7의 순서에 따라서 기판(G)표면에 패턴 형성된 레지스트에 대한 리플로우 처리를 실시할 수가 있다. 우선, 상부 용기(41b)를 하부 용기(41a)로부터 개방하고 그 상태로, 반송 장치(21)의 반송 아암(21a)에 의해, 이미 패턴 형성되어 표면 개질 처리가 된 레지스트를 가지는 기판(G)을 재치대(43)에 재치한다(스텝 S1). 그리고 상부 용기(41b)와 하부 용기(41a)를 접하게 하여 챔버(41)를 닫는다.
다음에 배관(65)의 개폐 밸브(69) 및 N₂가스 공급 배관(71)의 개폐 밸브(75)를 개방해 매스 플로우 컨트롤러(73)에 의해 N₂가스의 유량을 조절해 시너의 기화량을 제어하면서 버블러-탱크(67)로부터 기화된 시너를 배관(65), 가스 도입부(61)을 개재시켜 샤워 헤드(55)의 공간(63)에 도입하고 가스 토출구멍(57)으로부터 토출시켜 리플로우 처리를 개시한다(스텝 S2). 이것에 의해 챔버(41) 내가 소정 농도의 시너 환경이 된다. 챔버(41) 내의 재치대(43)에 재치된 기판(G) 상에는 이미 패턴 형성된 레지스트가 설치되고 있으므로 레지스트가 시너 환경에 노출됨으로써 시너가 레지스트에 침투한다. 이것에 의해 패턴 형성된 레지스트가 연화해 그 유동성이 높아지고 레지스트가 변형해 기판(G)표면의 소정의 영역이 변형 레지스트로 피복되어 새로운 에칭 마스크가 된다.
리플로우 처리 동안은 재치대(43)의 내부에 설치된 온도 조절 매체 유로(47)에 온도 조절 매체를 도입하는 것에 의해 그 열이 재치대(43)를 개재시켜 기판(G)에 대해서 전열되고 이것에 의해 기판(G)의 처리면이 원하는 온도 예를 들면 20℃에 제어된다. 샤워 헤드(55)로부터 기판(G)의 표면으로 향해 토출된 시너를 포함한 가스는 기판(G)의 표면에 접촉한 후 배기구(51a, 51b)에 향하여 흐르고 배기 장치(53)에 의해 챔버(41) 내로부터 배기된다.
리플로우 처리 동안 센서(59)에 의해 레지스트 패턴의 막두께 또는 선폭을 측정한다(스텝 S3). 다음에, 측정된 막두께 또는 선폭이 프로세스 레시피에 포함되는 종점 설정값의 막두께 또는 선폭에 이르렀는지 아닌지를 판정 한다(스텝 S4). 그리고 이 스텝 S4에서 측정 막두께 또는 측정 선폭이 종점 설정값의 막두께 또는 선폭에 이르렀다(Yes)라고 판단되었을 경우에는, 시너의 공급을 정지하고 리플로우 처리를 종료한다(스텝 S5). 한편, 스텝 S4로 측정 막두께 또는 측정 선폭이 종점 설정값의 막두께 또는 선폭에 이르고 있지 않다(No)고 판단된 경우에는, 다시 스텝 S3으로 돌아가, 막두께 또는 선폭의 측정과 스텝 S4의 판정을 실시한다. 이와 같이 해 리플로우 처리의 종점을 확실히 파악할 수 있다.
리플로우 처리 유닛(REFLW, 40)에 있어서의 리플로우 처리가 종료한 후는 배기를 계속하면서 퍼지 가스 공급배관(78) 상의 개폐 밸브(79)를 개방하고 퍼지 가스 도입부(77)를 개재시켜 챔버(41) 내에 퍼지 가스로서의 N₂가스를 도입하고 챔버내 환경을 치환한다(스텝 S6). 그 후, 상부 용기(41b)를 하부 용기(41a)로부터 개방해, 상기와 반대의 순서로 리플로우 처리 후의 기판(G)을 반송 아암(21a)에 의해 리플로우 처리 유닛(REFLW, 40)으로부터 반출한다(스텝 S7). 상기와 같이 1매의 기판(G)에 대한 리플로우 처리 유닛(REFLW,40)에서의 리플로우 처리가 종료한다. 이상과 같이, 기판(G) 상의 레지스트 패턴의 변형의 정도를 측정 가능한 센서(59)를 구비한 리플로우 처리 유닛(REFLW, 40)을 이용해 리플로우 처리의 진행 상황을 모니터하면서 리플로우 처리를 실시하는 것에 의해, 레지스트의 재질, 용제의 종류나 농도 등에 관련되지 않고 리플로우 처리의 종점을 확실히 파악할 수 있을 수가 있다. 따라서 유동화·변형한 레지스트에 의한 피복이 불충분하게 되거나 반대로 리플로우가 너무 진행되어 불필요한 영역까지 레지스트로 피복되어 버린거나 혹은 용제를 불필요하게 소비해 버리는 등의 문제를 회피할 수가 있다.
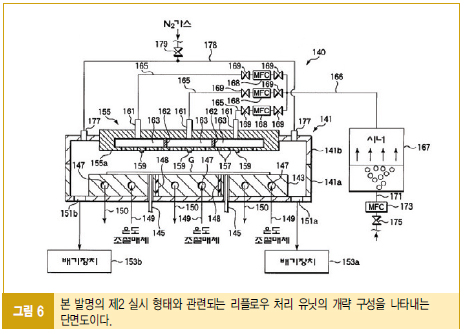
본 발명의 제2 실시 형태와 관련되는 리플로우 처리 유닛에 대해서 상세하게 설명한다. 그림 6은 본 발명의 제2의 실시 형태와 관련되는 리플로우 처리 유닛(REFLW, 140)을 나타내는 개략 단면도이다. 리플로우 처리 유닛(REFLW, 140)은 챔버(141)를 가지고 있고 챔버(141)는 하부 용기(141a)와 하부 용기(141a)의 상부에 접해지는 상부 용기(141b)로 구성되고 있다. 상부 용기(141b)와 하부 용기(141a)라는 것은 개폐 기구에 의해 개폐 가능하게 구성되고 있어 열린 상태 때에, 반송 장치(21)에 의해 기판(G)의 반입출이 행해진다.
상기 챔버(141 내에는 기판(G)을 수평에 지지하는 재치대(143)가 설치되고 있다. 재치대(143)는 열전도율이 뛰어난 재질 예를 들면 알루미늄으로 구성되고 있다. 재치대(143)에는, 승강기구(도시하지 않음)에 의해 구동되어 기판(G)을 승강시키는 3개의 승강 핀(145)이 재치대(143)를 관통하도록 설치되고 있다. 승강 핀(145)는 반송 장치(21)의 사이에 기판(G)을 수수 할 때에는 재치대(143)의 표면으로부터 돌출하고, 기판(G)을 재치대(143)로부터 들어 올려 소정의 높이 위치에서 지지하고 기판(G)의 리플로우 처리중은, 예를 들면 그 선단이 재치대(143)의 상면과 같은 높이가 되도록 하여 유지된다.
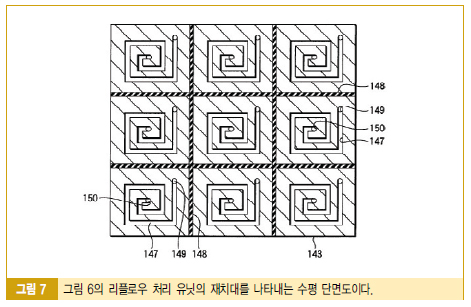
재치대(143)의 내부에는 그림 7의 수평 단면도에 나타나는 바와 같이 복수의 온도 조절 매체 유로(147)가 형성되고 있다. 각 온도 조절 매체 유로(147)는 예를 들면 합성 수지 등의 단열성을 가지는 재질로 이루어지는 격자 형상의 사이벽(148)에 의해 구분되어져 있고 각 영역에 있어서의 온도 조절이 응답성 좋게 행해지도록 되어 있다. 이들의 분할 형성된 온도 조절 매체 유로(147)의 구조는 재치대(143)에 대향 배치된 샤워 헤드(155)에 배치 설치된 9개의 센서(159)에 대응해 설치되고 있는 것이다. 각 온도 조절 매체 유로(147)에는 예를 들면 온도 조절 냉각수 등의 온도 조절 매체가 온도 조절 매체 도입관(149)을 개재시켜 도입되고 온도 조절 매체 배출관(150)으로부터 배출되어 순환하고 그 열(예를 들면 냉열)이 재치대(143)를 개재시켜 기판(G)에 대해서 전열기, 이것에 의해 기판(G)이 원하는 온도에 제어된다. 하부 용기(141a)의 바닥부에는, 배기구(151a, 151b)가 형성되고 있고 배기구(151a, 151b)에는 각각 배기 장치(153a, 153b)가 접속되고 있다. 그리고 이들의 배기 장치(153a, 153b)를 독립해 작동시키는 것으로 배기 밸런스(즉, 배기구(151a)와 배기구(151b)로부터 배기되는 기체의 유량 비율)를 조절하면서 챔버(141)내의 환경 가스를 배기할 수가 있다.
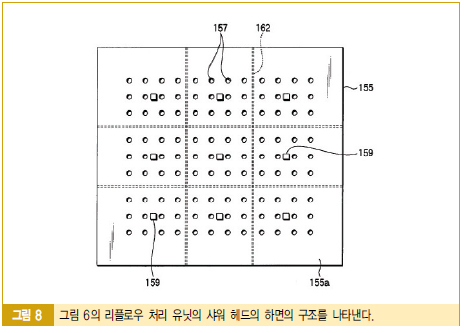
챔버(141)의 천정벽 부분에는 샤워 헤드(155)가 재치대(143)에 대향하도록 설치되고 있다. 그림 8은 샤워 헤드(155)의 하면(재치대(143)에 대향하는 면; 155a)을 나타내고 있다. 샤워 헤드(155)의 하면(155a)에는 다수의 가스 토출구멍(157)이 설치되고 있다. 또, 샤워 헤드(155)의 하면(155a)의 중앙 부근에는 가스 토출구멍(157)의 사이에 센서(159)가 배치되고 있다. 센서(159)는 광학 센서이고, 그림 3 및 그림 4에 나타내는 것과 동일한 구성을 가진다. 또, 샤워 헤드(155)의 상부에는 복수의 가스 도입부(161)가 설치되고 있어 각 가스 도입부(161)는 샤워 헤드(155)의 내부에 칸막이벽(162)에 의해 9개에 분할해 형성된 공간(163)에 각각 연통하고 있다. 각 가스 도입부(161)에는 각각 배관(165)이 접속되고 있는 즉, 배관(165)은, 공간(163)과 동수의 9개 배치되고 있게 된다. 각 가스 도입부(161)에 각각 접속된 각 배관(165)에는 매스 플로우 컨트롤러(MFC, 168) 및 그 전후의 개폐 밸브(169)가 설치되고 있어 타단측은 한 개의 배관(166)에 통합되어 유기용매 예를 들면 시너를 기화해 공급하는 버블러-탱크(167)에 접속되고 있다.
버블러-탱크(167)의 바닥부에는 시너를 기화시키기 위한 기포 발생 수단으로서 N₂가스 공급원에 접속된 N₂가스 공급 배관(171)이 배치되고 있다. N₂가스 공급 배관(171)에는 매스 플로우 컨트롤러(173) 및 개폐 밸브(175)가 설치되고 있다. 또, 버블러-탱크(167)는 내부에 저장되는 시너의 온도를 소정 온도에 조절하기 위한 온도 조절 기구를 구비하고 있다. 그리고 N₂가스 공급원으로부터 N₂가스를 매스 플로우 컨트롤러(173)에 의해 유량 제어하면서 버블러-탱크(167)의 바닥부에 도입함으로써, 소정 온도에 온도 조절된 버블러-탱크(167)내의 시너를 기화시켜 배관(166), 분기 한 각 배관(165), 각 가스 도입부(161)를 개재시켜 챔버(141) 내에 도입할 수 있도록 구성되고 있다. 이 때, 각 배관(165)에 설치된 매스 플로우 컨트롤러(MFC, 168) 및 그 전후의 개폐 밸브(169)에 의해, 시너를 포함한 기체를 독립해 유량 조절해 각 가스 도입부(161)를 개재시켜 각 공간(163)에 도입할 수 있게 되어 있다. 또, 챔버(141)의 천정벽에 있어서의 샤워 헤드(155)의 주위에는 복수의 퍼지 가스 도입부(177)가 설치되고 있고 각 퍼지 가스 도입부(177)에는 예를 들면 퍼지 가스로서의 N₂가스를 챔버(141) 내에 공급하는 퍼지 가스 공급 배관(178)이 접속되고 있다. 퍼지 가스 공급 배관(178)은 도시하지 않는 퍼지 가스 공급원에 접속되고 있어 그 도중에는 개폐 밸브(179)가 설치되고 있다.
이상과 같이, 제2 실시 형태의 리플로우 처리 유닛(REFLW, 140)에서는 복수(9개)의 센서(159)에 의해 기판(G) 표면을 세분화한 9개의 영역별로 모니터 하고 각 영역에 있어서의 모니터 결과, 즉, 각 영역에 있어서의 패턴 형성된 레지스트의 리플로우의 진행 상황에 따라 리플로우 조건을 세밀히 조절해, 리플로우 처리가 기판(G)의 면내에 있어서 균일하게 진행하도록 제어할 수 있다. 즉, 샤워 헤드(155)는 그 하면(155a)에 배치된 9개의 센서(159)에 대응하고 샤워 헤드(155) 내부에 공간(163)이 9개에 분할해 형성되고 있다. 따라서 각 매스플로어 컨트롤러(MFC, 168)을 이용해 공간(163)마다 개별적으로 유량을 제어하면서 시너를 포함한 기체를 공급함으로써, 각 공간(163)에 각각 연통하는 복수의 가스 토출구멍군으로부터, 다른 가스 유량으로 챔버(141)내에 시너를 포함한 기체를 도입할 수 있도록 구성되고 있다. 이와 같이, 샤워 헤드(155)로부터 이것에 대향하는 재치대(143)에 재치된 기판(G) 면내의 9개의 영역에 대해서, 각각 시너를 포함한 기체의 유량을 변화시켜 토출시킬 수가 있으므로 기판(G)면내에 있어서 리플로우 속도를 조절할 수가 있다. 또한 공간(163) 마다 기체의 유량을 개별적으로 제어하는 방법으로 대신해, 공간(163) 마다 기체안의 시너 농도를 변화시키는 것도 가능하다. 이 경우, 도시는 생략 하지만 복수의 배관(165)을 9개의 버블러-탱크(167)에 각각 접속하고 각 버블러-탱크(167)을 독립적으로 온도 조절하는 것에 의해 공급 기체안의 시너 농도를 변화시킬 수가 있다. 또, 버블러-탱크(167)에 대신해 배관(165)과 동일한 수의 기화기를 배치하고 캐리어 가스(N2가스) 안에 혼합하는 시너의 양을 조절하는 것에 의해 공급 기체 안의 시너 농도를 공간(163)마다 개별적으로 변화시켜도 괜찮다.
또, 본 실시 형태의 리플로우 처리 유닛(REFLW, 140)에서는 챔버(141)의 배기구(151a, 151b)에 각각 배기 장치(153a, 153b)를 접속하고 있으므로, 이들의 배기 장치(153a, 153b)를 독립해 작동시키는 것으로 챔버(141)로부터 배기되는 기체의 배기 밸런스를 조절할 수가 있다. 이것에 의해, 재치대(143) 상에 재치된 기판(G)의 표면을 따라 흐르게 되는 시너를 포함한 기체의 기류를 제어하고 기판(G)의 면내에서의 리플로우 속도를 조절할 수가 있다. 또한 상기 샤워 헤드(155)의 분할 구조에 대응해, 그림 7에 나타나는 바와 같이 재치대(143)의 온도 조절 매체 유로(147)도 9개에 분할되고 있으므로, 각 온도 조절 매체 유로(147)에 유통시키는 온도 조절 매체의 온도를 변화시키는 것에 의해 재치대(143)의 온도를 9개의 영역에서 각각 독립적으로 온도 조절할 수 있게 되어 있다. 따라서 재치대(143)에 재치된 기판(G)의 면내에 있어서의 온도 조절을 높은 정밀도로 세밀하게 실시함으로써 기판(G)면내에 있어서의 리플로우 속도를 조절할 수가 있다.
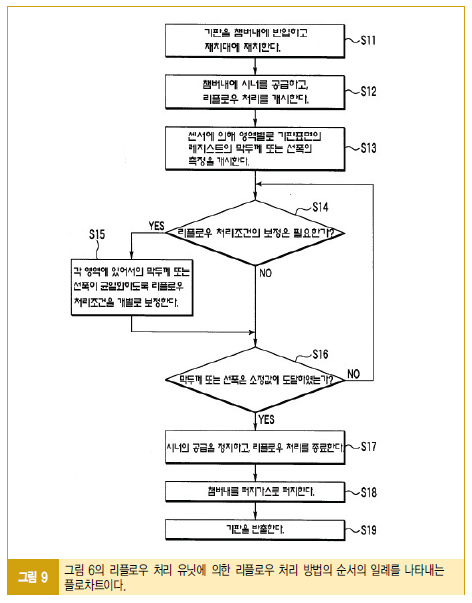
이러한 구성의 리플로우 처리 유닛(REFLW, 140)에 있어서는 예를 들면 그림 9에 나타내는 스텝 S11~S19의 순서에 따라서 기판(G)표면에 패턴 형성된 레지스트에 대한 리플로우 처리를 실시할 수가 있다. 우선, 상부 용기(141b)를 하부 용기(141a)로부터 개방하고 그 상태로, 반송 장치(21)의 반송 아암(21a)에 의해 이미 패턴 형성되어 표면 개질 처리가 된 레지스트를 가지는 기판(G)을 반입하고 재치대(143)에 재치한다(스텝 S11). 그리고 상부 용기(141b)와 하부 용기(141a)를 접하게 하여 챔버(141)를 닫는다.
다음에 각 배관(165)의 개폐 밸브(169) 및 N₂가스 공급 배관(171)의 개폐 밸브(175)를 개방해, 매스 플로우 컨트롤러(MFC, 173)에 의해 N2가스의 유량을 조절해 시너의 기화량을 제어하면서, 기화된 시너를 버블러-탱크(167)로부터 배관(166)에 이끌어, 각 배관(165)에 있어서 매스 플로우 컨트롤러(MFC, 168)에서 독립해 유량 컨트롤하면서, 각 가스 도입부(161)을 개재시켜 샤워 헤드(155)의 각 공간(163)에 각각 도입하고 다수의 가스 토출구멍(157)로부터 토출시켜, 리플로우 처리를 개시한다(스텝 S12). 이것에 의해 챔버(141)내가 소정 농도의 시너 환경이 된다. 챔버(141) 내의 재치대(143)에 재치된 기판(G) 상에는 이미 패턴 형성된 레지스트가 설치되고 있으므로, 레지스트가 시너 환경에 노출됨으로써 시너가 레지스트에 침투한다. 이것에 의해, 레지스트가 연화해 그 유동성이 높아져, 레지스트가 변형해 기판(G)표면의 소정의 영역(타겟 영역)이 변형 레지스트로 피복된다. 리플로우 처리 동안은 재치대(143)의 내부에 설치된 각 온도 조절 매체 유로(147)에, 개별적으로 온도 조절된 온도 조절 매체를 도입하는 것에 의해, 그 열이 재치대(143)를 개재시켜 기판(G)에 대해서 전열기, 이것에 의해 기판(G)의 면내 온도가 영역 별로 정밀하게 제어된다. 또, 샤워 헤드(155)의 각 공간(163)으로부터 기판(G)의 표면으로 향해 각각 유량 조절되면서 토출된 시너를 포함한 가스는 배기 장치(153a, 153b)를 독립적으로 작동시키는 것으로 소정의 배기 밸런스로 배기구(151a, 151b)에 향하여 흘러가므로 배기 밸런스를 조절함으로써, 기판(G)의 면내에서 표면에 접촉하는 시너량을 조절할 수가 있다. 리플로우 처리의 개시와 함께 9개의 센서(159)에 의해, 기판(G)의 9개의 영역마다 레지스트의 막두께 또는 선폭의 측정을 개시한다(스텝 S13).
다음에, 제어부(3)의 컨트롤러(90)이 기판(G) 상의 각 영역에서 리얼타임으로 측정된 레지스트의 막두께 또는 선폭의 측정 결과를 취득해, 미리 프로세스 레시피의 일부로서 기억부(92)에 보존해 둔 막두께 또는 선폭의 기준값과 각 영역별로 비교해, 리플로우 처리 조건의 보정이 필요할지 아닐지를 판단한다(스텝 S14). 여기에서는, 예를 들면 기판(G) 상이 있는 영역에 있어서의 측정 막두께 또는 측정 선폭이 상기 기준값으로부터 빗나가 있는 경우에 보정이 필요(Yes)하다고 판단하고, 상기 기준값 이내이면 보정은 불필요(No)하다고 판단한다. 그리고 어느 영역에서 보정이 필요한 경우(Yes)에는 그 영역에 있어서의 리플로우 처리의 진행이 기준값 이내가 되도록 리플로우 처리 유닛(REFLW, 140)에 있어서의 리플로우 처리 조건, 예를 들면, 시너를 포함한 기체의 유량, 시너 농도, 재치대(143)의 온도, 배기 밸런스 등을 조절해, 기판(G)의 면내에서 리플로우 처리가 균일하게 진행되도록 보정한다(스텝 S15).
스텝 S14로 보정이 불요하다고 판단된 경우, 또는 스텝 15로 보정을 한 경우에는 다음에, 측정된 막두께 또는 선폭이 프로세스 레시피에 포함되는 종점 설정값의 막두께 또는 선폭에 도달했는지 아닌지를 판정 한다(스텝 S16). 이 스텝 S16에서, 측정 막두께 또는 측정 선폭이 종점 설정값의 막두께 또는 선폭에 도달했다고(Yes) 판단된 경우에는 시너의 공급을 정지하고 리플로우 처리를 종료한다(스텝 S17). 한편, 스텝 S16에서 측정 막두께 또는 측정 선폭이 종점 설정값의 막두께 또는 선폭에 도달하고 있지 않다고(No) 판단된경우에는 다시 스텝 S14의 판정으로 돌아간다.
리플로우 처리 유닛(REFLW, 140)에 있어서 리플로우 처리가 종료한 후는, 배기를 계속하면서 퍼지 가스 공급배관(178)상의 개폐 밸브(179)를 개방하고 퍼지 가스 도입부(177)를 개재시켜 챔버(141) 내에 퍼지 가스로서의 N₂가스를 도입해, 챔버내 환경을 치환한다(스텝 S18). 그 후, 상부 용기(141b)를 하부 용기(141a)로부터 개방해, 상기와 반대의 순서로 리플로우 처리 후의 기판(G)를 반송 아암(21a)에 의해 리플로우 처리 유닛(REFLW, 140)으로부터 반출한다(스텝 S19). 이상과 같이 해, 1매의 기판(G)에 대한 리플로우 처리 유닛(REFLW, 140)에서의 리플로우 처리가 종료한다. 이상과 같이, 리플로우 처리 유닛(REFLW, 140)을 이용해 레지스트의 리플로우 상태를 리얼타임으로 모니터함으로써, 리플로우의 종점 검출이 용이하게 실시할 수 있을 뿐만 아니라, 기판(G)의 면내 각 영역에 있어서의 리플로우의 진행 상황이 균일하게 되도록 보정을 실시하는 것에 의해 리플로우 처리 후의 변형 레지스트의 형상을 기판(G)의 면내에서 균일화할 수가 있다.

리플로우 처리 유닛(REFLW, 140)에서는 예를 들면 그림 10에 나타내는 스텝 S21~스텝 32의 순서에 따라 어느 기판(G)의 리플로우 처리에 있어서의 막두께나 선폭의 측정 결과에 근거해 다른 기판(G)의 리플로우 처리 조건을 보정해 리플로우 처리 결과에 반영시킬 수도 있다.
우선, 레지스트 패턴을 가지는 1매째의 기판(G)를 챔버(141)에 반입해 재치대(143)에 재치하고(스텝 S21), 다음에 리플로우 처리를 개시한다(스텝 S22). 소정 시간 경과후, 리플로우 처리를 종료하고(스텝 S23), 다음에 리플로우 처리 종료시점으로써, 9개의 센서(159)에 의해 기판(G)의 9개의 영역마다 레지스트 패턴의 막두께 또는 선폭의 측정을 실시한다(스텝 S24). 이 측정 결과로부터 제어부(3)의 컨트롤러(90)에 의해 리플로우 처리 조건의 보정을 해 보정 후의 리플로우 처리 조건으로서 기억부(92)에 보존된다. 다음에, 챔버(141) 내에 퍼지 가스로서의 N₂가스를 도입하고 챔버내 환경을 치환한다(스텝 S25). 그 후, 1매 째의 기판(G)를 반송 아암(21a)에 의해 리플로우 처리 유닛(REFLW, 140)으로부터 반출한다(스텝 S26). 이상과 같이 해, 1매의 기판(G)에 대한 리플로우 처리 유닛(REFLW, 140)에서의 리플로우 처리가 종료한다.
다음에, 레지스트 패턴을 가지는 2매째의 기판(G)를 챔버(141)에 반입해 재치대(143)에 재치하고(스텝 S27), 다음에 챔버(141)내에 용제를 공급하고 리플로우 처리를 개시한다(스텝 S28). 이 때, 스텝 S24에서 구해진 1매 째의 기판(G)에 대한 리플로우 처리 종료시점에서의 레지스트의 막두께 또는 선폭의 측정 결과를 근거로 또 목적을 따른 적절한 리플로우 처리(예를 들면 기판(G)의 면내에서 균일한 리플로우 처리)를 실시할 수 있도록 보정된 리플로우 처리 조건에 의해 2매째의 기판(G)를 처리한다.
소정 시간 경과 후, 리플로우 처리를 종료하고(스텝 S29), 다음에 리플로우 처리 종료시점에서 9개의 센서(159)에 의해, 기판(G)의 9개의 영역마다 레지스트 패턴의 막두께 또는 선폭의 측정을 실시한다(스텝 S30). 상기 측정 결과는, 제어부(3)의 컨트롤러(90)에 보내진다. 상기 스텝 S30의 측정 결과를 근거로 리플로우 처리가 적정하게 행해졌는지 어떤지를 판정할 수도 있다. 또한 그 판정의 결과 리플로우 처리가 목적을 따른 적절한 것이 아닌 예를 들면 기판(G)의 면내에서의 균일성이 얻어지지 않는 경우에는, 컨트롤러(90)에 의해 재차 리플로우 처리 조건의 보정을 실시하고 보정 후의 리플로우 처리 조건을 기억부(92)에 보존하고 다음에 처리하는 기판(G)의 리플로우 처리 조건에 반영시킬 수도 있다.
다음에, 챔버(141)내에 퍼지 가스로서의 N₂가스를 도입해, 챔버내 환경을 치환한다(스텝 S31). 그 후, 2매 째의 기판(G)을 반송 아암(21a)에 의해 리플로우 처리 유닛(REFLW, 140)으로부터 반출한다(스텝 S32). 이상과 같이하여, 리플로우 처리 유닛(REFLW, 140)에서의 2매 째의 기판(G)에 대한 리플로우 처리가 종료한다.
3매 째 이후의 기판(G)에 대해서도 동일함에 대해 스텝 S27~스텝 S32의 처리를 실시하는 것에 의해 목적을 따른 적절한 리플로우 처리를 실시할 수가 있다. 또한 1매 째의 기판(G)에 대한 레지스트 패턴의 막두께 또는 선폭의 측정(스텝 S24)의 결과를 기본으로 보정된 리플로우 처리 조건을 2매 째 이후의 기판(G)의 처리로 일관해 사용하는 경우에는 2매 째 이후의 기판(G)의 처리시에는 스텝 S30의 레지스트 패턴의 막두께 또는 선폭의 측정은 생략해도 괜찮다. 물론, 1매의 기판(G)을 처리할 때마다 스텝 S30의 측정을 실시하고 그 결과를 다음의 기판(G)의 리플로우 처리 조건에 반영시킬 수도 있다.
또한 본 발명은 상기 실시 형태로 한정되지 않고 여러 가지 변형 가능하다. 예를 들면, 상기 설명에 있어서는 LCD용 유리 기판상에 패턴 형성된 레지스트의 리플로우 처리를 예로 들었지만, 다른 플랫 패널 디스플레이(FPD) 기판이나, 반도체 기판등의 기판에 패턴 형성된 레지즈트의 리플로우 처리를 행하는 경우에도 본 발명을 적용할 수가 있다. 또, 센서(59, 159)를 이용한 리플로우 처리의 종점 검출이나 조건 보정은, 챔버 방식의 리플로우 처리 장치에 한정하지 않고, 예를 들면 코로나 롤러 등의 반송 수단을 이용해 기판(G)을 반송하면서 리플로우 처리를 행하는 평류 방식의 리플로우 처리 장치에 있어서도 적용가능하다.
