본 발명은, 표시용 패널 등의 제조에 이용되는 유리 기판 및 플라스틱 기판 등의 결함을 레이저 광을 이용하여 검출하는 인라인 기판 검사 장치의 광학 시스템 교정 방법 및 인라인 기판 검사 장치에 관한 것으로, 특히 유리 기판이나 플라스틱 기판 등의 제조 라인 내나, 이들을 이용한 표시용 패널 기판의 제조 라인 내에 갖추어진 검사 장치의 광학 시스템 보수 작업에 적합한 인라인 기판 검사 장치의 광학 시스템 교정 방법 및 인라인 기판 검사 장치에 관한 것이다.
배경 기술
표시용 패널로서 이용되는 액정 디스플레이 장치의 TFT(Thin Film Transistor)기판이나 컬러 필터 기판, 플라즈마 디스플레이 패널용 기판, 유기EL(Electroluminescence) 표시 패널용 기판 등의 제조는, 포토리소그래피 기술에 의해, 유리 기판이나 플라스틱 기판 등의 기판 상에 패턴을 형성해서 실시된다. 그 때 기판에 상처나 이물질 등의 결함이 존재하면, 패턴이 양호하게 형성되지 않고, 불량의 원인이 된다. 이 때문에, 기판 검사 장치를 이용하여, 기판의 상처나 이물질 등의 결함 검사가 실시된다.
기판 검사 장치는 레이저 광 등의 검사광을 기판으로 조사하여, 기판으로부터의 반사광 또는 산란광을 수광하여, 기판의 상처나 이물질 등의 결함을 검출하는 것이다. 검사광에 의해 기판이 주사되기 때문에 기판 전체의 검사에는 시간이 걸린다. 그 때문에 종래는 유리 기판이나 플라스틱 기판 등의 제조 라인 내나, 이들을 채용한 표시용 패널 기판의 제조 라인 내에서 기판의 결함을 실시간으로 검사하고 있다. 이렇게 제조 라인 내에서 실시간으로 검사를 실시하는 기판 검사 장치에 있어서는, 광학 시스템의 정기적인 레이저 파워의 관리, 검출 감도의 조정 작업 등의 교정 작업은 필요 불가결하게 되어 있다. 종래에는 기판 검사 장치의 광학 시스템의 교정 작업은 검사 스테이지 상에 표준입자를 도포한 기준 샘플 기판을 탑재함으로써 광학 시스템의 교정 작업을 실시했었다. 이와 같은 교정 작업에 있어서는 광학 시스템의 교정 작업 실시를 위해서 표준 입자 부착 기판을 검사 스테이지 상으로 작업자가 사람 손으로 실어서 실시할 필요가 있었다. 이처럼 기준 샘플 기판을 탑재해서 교정을 실시하는 것으로 특허문헌 1(특개2003-059994호 공보)에 기재된 것과 같은 것이 알려져 있다.
발명의 내용
해결하려는 과제
특허문헌 1에 기재된 것은, 반도체의 웨이퍼를 검사하는 장치의 관리 방법에 관계되는 기술이며, 복수의 피검사 샘플을 연속해서 측정하는 검사 도중, 미리 세트된 표준 샘플 전용 카세트로부터 자동적으로 표준 샘플을 공급하여 측정을 실시하고, 상기 표준 샘플의 측정 결과와 교정 기준·관리 기준과의 대조를 실시하여 검사 장치의 관리를 실시하는 것을 목적으로 하고 있다.
표시용 패널용 기판은 사이즈가 웨이퍼에 비교해서 아주 대형이기 때문에, 특허문헌 1에 기재된 것과 같이 표준 샘플을 준비해서 그것을 전용 카세트에 세트하여, 검사 장치 내에 탑재해 두는 것은, 대단히 곤란하다. 따라서 종래의 표시용 패널 등의 기판 검사 장치에 있어서의 광학 시스템의 교정 작업은 기판을 반송하기 위한 검사 스테이지 상에 표준 입자 부착 기판을 사람의 손으로 탑재하고, 상기 검사 스테이지를 광학 시스템 바로 아래로 이동하여 광학 시스템의 교정 작업을 실시하였다. 이러한 작업은 기판이 대형화됨에 따라 작업이 곤란해지고, 또한 기준 샘플 취급 시 작업자에게 엄청난 부담이 되었다. 게다가, 이러한 방법에 있어서는 기판을 반송하기 위한 검사 스테이지를 광학 시스템의 교정 작업을 실시하는 동안 점유해버리기 때문에 제조 라인을 흐르는 기판을 검사 장치의 상류에서 정체시켜 버리는 것이 되어 기판 검사 장치의 실시간성에 지장을 주었다.
본 발명은 상술한 점을 고려하여 실시한 것으로 제조 라인 내에 갖추어진 검사 장치의 광학 시스템의 교정 작업을, 제조 라인을 정지시키지 않고 실시할 수 있는 인라인 기판 검사 장치의 광학 시스템 교정 방법 및 인라인 기판 검사 장치를 제공하는 것을 목적으로 한다.
과제의 해결 수단
본 발명에 의한 인라인 기판 검사 장치의 광학 시스템 교정 방법의 제1 특징은 상류 라인에서 하류 라인으로 기판을 차례로 이동시키면서, 기판 이동 수단에 의해 이동 중인 상기 기판과 직교하는 방향으로 투광 시스템 및 수광 시스템으로 이루어지는 광학 시스템을 이동시켜서 검사광을 조사함과 동시에 상기 기판으로부터의 반사광 또는 산란광을 수광하고, 수광된 상기 기판으로부터의 반사광 또는 산란광에 근거하여 상기 기판의 결함을 검사하는 인라인 기판 검사 방법에 있어서, 상기 기판의 검사가 행하여지는 검사 영역 이외의 장소에 교정 작업 영역을 마련하고, 상기 광학 시스템을 상기 교정 작업 영역으로 이동이 가능하도록 하고, 상기 기판의 이동 중에 상기 광학 시스템의 교정 작업을 상기 교정 작업 영역에서 실시하도록 함에 있다.
본 발명은 상류 라인에서 하류 라인으로 기판을 수수하는 기능을 갖는 검사 스테이지 혹은 반송 컨베이어 등의 검사 영역 이외의 장소에 광학 시스템의 교정 작업을 실시하기 위한 교정 작업(maintenance) 영역을 마련하고, 상기 광학 시스템의 이동 스트로크를 상기 교정 작업 영역까지 이동을 가능하게 함으로써 광학 시스템의 교정 작업을 검사 영역 밖에서 실시하는 것이 가능해지며, 제조 라인을 멈추지 않고 교정 작업을 실시할 수 있도록 한 것이다.
본 발명에 의한 인라인 기판 검사 장치의 광학 시스템 교정 방법의 제2 특징은 상류 라인으로부터 하류 라인으로 기판을 차례로 이동시키면서, 투광 시스템 및 수광 시스템을 갖는 광학 시스템을 상기 기판의 이동 방향과 직교하는 방향으로 이동시켜, 상기 투광 시스템으로부터의 기판 이동 방향과 직교하는 방향으로 소정의 폭을 갖는 검사광에 의해 주사되는 기판의 주사 영역을 기판마다 변경하고, 상기 투광 시스템으로부터 상기 기판의 이동 방향과 직교하는 방향으로 소정의 폭을 갖는 검사광을 기판으로 조사하고, 상기 수광 시스템이 수광한 광의 강도로부터 주사 영역의 기판의 결함을 검출하고, 검출한 주사 영역의 기판 결함 데이터를 주사 영역마다 기억하고, 기판마다, 새로이 검출된 주사 영역의 기판 결함 데이터에 의해 기억된 동일한 주사 영역의 기판 결함 데이터를 갱신하고, 복수의 주사 영역의 기판 결함 데이터로부터, 기판 한 장분의 결함 데이터를 작성하는 인라인 기판 검사 방법에 있어서 상기 기판의 검사가 행하여지는 검사 영역 이외의 장소에 교정 작업 영역을 마련하고, 상기 광학 시스템을 상기 교정 작업 영역으로 이동이 가능하도록 하고, 상기 기판의 이동 중에 상기 광학 시스템의 교정 작업을 상기 교정 작업 영역에서 행하도록 한 것에 있다.
본 발명은 기판마다 다른 주사 영역의 결함 데이터를 취득하고, 상기 결함 데이터를 주사 영역마다 기억하며 기판마다, 새로이 검출한 주사 영역의 기판 결함 데이터에 의해 기억된 같은 주사 영역의 기판 결함 데이터를 갱신하여 복수의 주사 영역의 기판 결함 데이터로부터 기판 한 장분의 결함 데이터를 작성하여 인라인 내에서의 기판의 결함 검사를 보다 신속히 실시할 수 있도록 한 인라인 기판 검사 장치에 있어서 광학 시스템의 교정 작업을 실시하기 위한 교정 작업영역을 마련하고, 상기 광학 시스템의 이동 스트로크를 상기 교정 작업 영역까지 이동이 가능하도록 함으로써 상기 광학 시스템의 교정 작업을 검사 영역 밖에서 실시가 가능해져서 제조 라인을 멈추지 않고 교정 작업을 실시할 수 있도록 한 것이다.
본 발명에 의한 인라인 기판 검사 장치의 광학 시스템 교정 방법의 제3 특징은, 상기 제1 또는 제2 특징에 기재 된 인라인 기판 검사 방법에 있어서 상기 기판의 이동 방향과 같은 방향 및 같은 속도로 이동하는 표준 입자 부착 기판을 상기 교정 작업 영역 내에 마련하고, 상기 광학 시스템을 상기 교정 작업 영역으로 이동하고, 상기 기판의 이동 중에 상기 표준 입자 부착 기판을 검사함으로써 상기 광학 시스템의 교정 작업을 실시하도록 함에 있다. 실제 기판의 이동과 같은 상태로 이동하는 표준 입자 부착 기판을 검사함으로써 광학 시스템의 교정 작업을 정확하게 실시할 수 있다.
본 발명에 의한 인라인 기판 검사 장치의 광학 시스템 교정 방법의 제4 특징은 상기 제3 특징에 기재된 인라인 기판 검사 방법에 있어서 상기 표준 입자 부착 기판을 상기 검사 영역 내의 기판 높이에 맞추는 높이 조정 수단을 구비함에 있다. 상기 표준 입자 부착 기판의 높이를 검사 영역 내의 기판의 높이에 맞추는 것에 의해 교정 작업을 정확하게 할 수 있다.
본 발명에 의한 인라인 기판 검사 장치의 광학 시스템 교정 방법의 제5 특징은, 상기 제2 특징에 기재된 인라인 기판 검사 방법에 있어서 작성한 기판 한 장분의 결함 데이터에 근거하여 기판마다, 기판 한 장분의 결함 수가 허용 값 이내인지 아닌지를 판정함에 있다. 이는 작성한 기판 한 장분의 결함 데이터에 근거하여 기판마다, 기판 한 장분의 결함 수가 허용 값 이내인지 아닌지를 판정하고 있으므로, 기판 한 장분의 결함 수가 허용 값을 넘는 불량이 발생했을 경우 불량을 기판마다 조기에 발견할 수 있다.
본 발명에 의한 인라인 기판 검사 장치의 제1 특징은, 상류 라인에서 하류 라인으로 기판을 차례로 이동시키는 기판 이동 수단과 상기 기판 이동 수단에 의해 이동 중의 기판에 대하여 검사광을 조사하는 투광 시스템 및 상기 기판으로부터의 반사광 또는 산란광을 수광하는 수광 시스템을 갖는 광학 시스템과 상기 광학 시스템을 상기 기판의 이동 방향과 직교하는 방향으로 이동시켜서 상기 기판으로부터의 반사광 또는 산란광에 근거하여 상기 기판의 결함을 검사하는 검사 수단으로 이루어지는 인라인 기판 검사 장치에 있어서 상기 검사 수단에 의해 상기 기판의 검사가 행하여지는 검사 영역 이외의 장소에 교정 작업 영역을 마련하고, 상기 광학 시스템을 상기 교정 작업 영역으로 이동이 가능하도록 하고, 상기 기판의 이동 중에 상기 광학 시스템의 교정 작업을 상기 교정 작업 영역에서 하도록 함에 있다. 이는 상기 인라인 기판 검사 장치의 교정 방법의 제1 특징에 기재된 것을 실현한 인라인 기판 검사 장치의 발명이다.
본 발명에 의한 인라인 기판 검사 장치의 제2 특징은, 상류 라인으로부터 하류 라인으로 기판을 차례로 이동시키는 기판 이동 수단과 상기 기판 이동 수단에 의해 이동 중의 기판에 대하여 검사광을 조사하는 투광 시스템 및 상기 기판으로부터의 반사광 또는 산란광을 수광하는 수광 시스템을 갖는 광학 시스템과 상기 광학 시스템을 기판 이동 방향과 직교하는 방향으로 이동하고, 상기 투광 시스템으로부터의 검사광에 의해 주사되는 기판의 주사 영역을 기판마다 변경하는 광학 시스템 이동 수단과 상기 수광 시스템이 수광한 광의 강도로부터 주사 영역의 기판의 결함을 검출하는 처리 수단과 상기 처리 수단이 검출한 주사 영역의 기판 결함 데이터를 주사 영역마다 기억하는 기억 수단과 상기 기억 수단을 제어하고, 기판마다 상기 처리 수단이 새로이 검출한 주사 영역의 기판 결함 데이터에 의해 상기 기억 수단에 기억된 같은 주사 영역의 기판 결함 데이터를 갱신하고, 상기 기억 수단에 기억된 복수의 주사 영역의 기판 결함 데이터로부터 기판 한 장분의 결함 데이터를 작성하는 제어 수단으로 이루어지는 인라인 기판 검사 장치에 있어서 상기 검사 수단에 의해 상기 기판의 검사가 행하여지는 검사 영역 이외의 장소에 교정 작업 영역을 마련하고, 상기 광학 시스템을 상기 교정 작업 영역으로 이동이 가능하도록 하여 상기 기판의 이동 중에 상기 광학 시스템의 교정 작업을 상기 교정 작업 영역에서 실시하도록 함에 있다. 이는 상기 인라인 기판 검사 장치의 교정 방법의 제2 특징에 기재된 것을 실현한 인라인 기판 검사 장치의 발명이다.
본 발명에 의한 인라인 기판 검사 장치의 제3 특징은, 상기 제1 또는 제2 특징에 기재된 인라인 기판 검사 장치에 있어서 상기 기판의 이동 방향과 같은 방향 및 같은 속도로 이동하는 표준 입자 부착 기판을 상기 교정 작업 영역 내에 마련하여 상기 광학 시스템을 상기 교정 작업 영역으로 이동하고, 상기 기판의 이동 중에 상기 표준 입자 부착 기판을 검사함으로써 상기 광학 시스템의 교정 작업을 실시하도록 함에 있다. 이는 상기 인라인 기판 검사 장치의 교정 방법의 제3 특징에 기재된 것을 실현한 인라인 기판 검사 장치의 발명이다.
본 발명에 의한 인라인 기판 검사 장치의 제4 특징은, 상기 제3 특징에 기재된 인라인 기판 검사 장치에 있어서, 상기 표준 입자 부착 기판을 상기 검사 영역 내의 기판 높이에 맞추는 높이 조정 수단을 구비함에 있다. 이는 상기 인라인 기판 검사 장치의 교정 방법의 제4 특징에 기재된 것을 실현하는 인라인 기판 검사 장치의 발명이다.
본 발명에 의한 인라인 기판 검사 장치의 제5 특징은, 상기 제2 특징에 기재된 인라인 기판 검사 장치에 있어서, 상기 제어 수단은 작성한 기판 한 장분의 결함 데이터에 근거하여 기판마다 기판 한 장분의 결함 수가 허용 값 이내인지 아닌지를 판정함에 있다. 이는 상기 인라인 기판 검사 장치 교정 방법의 제5 특징에 기재된 것을 실현한 인라인 기판 검사 장치의 발명이다.
발명을 실시하기 위한 구체적인 내용
그림 1은 본 발명의 일실시 형태에 의한 기판 검사 장치의 상면도이며, 그림 2는 본 발명의 일실시 형태에 의한 기판 검사 장치의 측면도이다. 본 실시 형태는 검사광이 기판의 결함에 의해 산란된 산란광으로부터 기판의 결함을 검출하는 기판 검사 장치의 예를 나타내고 있다. 기판 검사 장치는, 스테이지(10), 롤러(11), 프레임(13, 14), 광학 시스템 이동 기구, 광학 시스템 유닛(20a, 20b), 초점 조절 기구(41), 센서(51), 교정용 스테이지(61a, 61b) 및 제어 시스템을 포함해서 구성된다. 한편, 이하에 설명하는 실시 형태에 있어서의 XY 방향은 예시이며, X 방향과 Y 방향을 바꿀 수도 있다.
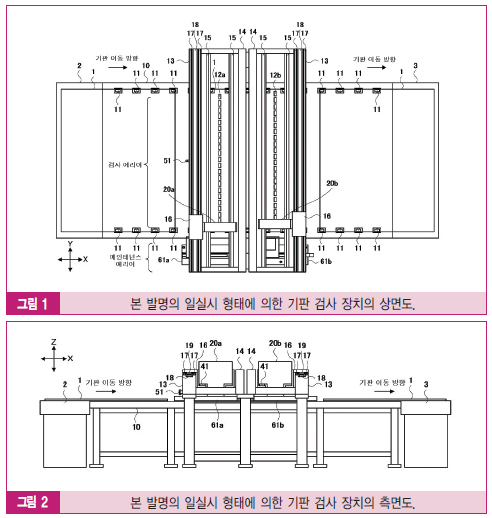
그림 1 및 그림 2에 있어서 검사 대상인 복수의 기판(1)은, 라인 내에 있어서 반입 컨베이어(2)에 의해 기판 검사 장치로 차례로 반입되며, 검사 후, 반출 컨베이어(3)에 의해 상기 기판 검사 장치로부터 차례로 반출된다. 스테이지(10)는 반입 컨베이어(2)로부터 각 기판(1)을 받는다. 그림 3은, 스테이지를 위쪽에서 바라본 상면도이다.

그림 3에서 나타내듯이 스테이지(10)의 양단부에 각각 직선 형상으로 마련된 롤러(11)는, 그림 3에서 파선으로 나타낸 각 기판(1)의 이면의 주변부에 접촉하면서 회전하고, 각 기판(1)을 화살표로 나타내는 기판 이동 방향(X방향)으로 차례로 이동시킨다. 스테이지(10)의 상면에는, 도시하지 않은 복수의 에어 취출구가 마련되어 있다. 이들 복수의 에어 취출구는 롤러(11)에 의해 이동되는 각 기판(1)의 이면에 대하여 에어를 내뿜도록 되어 있다.
각 기판(1)의 중앙부로 뿜어지는 에어의 작용에 의해, 각 기판(1)은 휘지 않고 부상되어, X 방향으로 차례로 이동한다.
그림 1 및 그림 2에서 나타내듯이 롤러(11)에 의해 X 방향으로 이동되는 기판(1)의 상방(그림 1의 도면의 안길이 방향의 앞측, 그림 2의 상측)에는, 기판(1)의 기판 이동 방향(X 방향)과 직교하는 방향(Y 방향)의 폭 이상으로 걸쳐서 연장되는 프레임(13, 14)이 설치된다. 이 프레임(13, 14)에는 광학 시스템 유닛(20a, 20b)을 Y방향으로 이동시키는 광학 시스템 이동 기구가 탑재된다. 한편, 본 실시 형태에서는, 2개의 광학 시스템 유닛(20a, 20b)이 마련되어 있지만, 광학 시스템의 수는 이에 한하지 않고, 1개 또는 3개 이상의 광학 시스템을 마련할 수 있다.
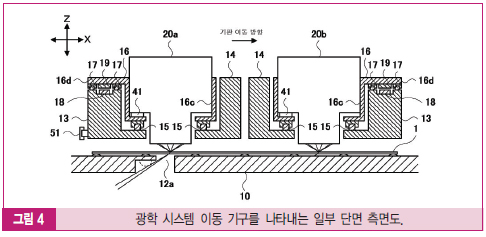
그림 4는 2개의 광학 시스템을 Y 방향으로 이동시키는 광학 시스템 이동 기구의 개략적 구성을 나타내는 일부 단면 측면도이다. 광학 시스템 이동 기구는, 가이드(15, 17), 이동대(16) 및 자석판(18)과 코일(19)로부터 이루어지는 리니어 모터를 포함하여 구성된다. 단면의 형상이 거의 L자 형상의 프레임(13, 14)에는, 그림 4의 도면 안 길이 방향(Y 방향)으로 연장되는 가이드(15)가 2개의 광학 시스템 유닛(20a, 20b)을 사이에 개재하듯이 마련되어 있다. 각각의 가이드(15)의 상측에는 이동대(16)의 수납부(16c)가 탑재된다.
이동대(16)는 광학 시스템 유닛(20a, 20b)을 수납하는 오목형의 수납부(16c)와 이 수납부(16c)의 상단부에서 수평 방향으로 연장되는 암부(16d)로 구성된다. 수납부(16c)에는 후술하는 초점 조절 기구(41)를 통하여, 광학 시스템 유닛(20a, 20b)이 수납 탑재된다. 프레임(13)의 상면부 양측에는, 그림 4 도면의 안길이 방향(Y 방향)으로 연장되는 가이드(17)가 마련되어 있다. 각각의 가이드(17)의 상측에는, 이동대(16)의 암부(16d)가 탑재된다.
프레임(13) 상면부의 중앙에는 리니어 모터의 고정자인 자석판(18)이 설치되어 있다. 이동대(16)의 암부(16d)의 하측에는, 리니어 모터의 가동자인 코일(19)이 설치되어 있다. 후술하는 광학 시스템 이동 제어 회로(60)로 부터 코일(19)로 전류를 흘리면, 코일(19)의 전류와 자석판(18)의 자기장으로부터 플레밍(Fleming)의 왼손 법칙에 의해, 코일(19)에 추진력(로렌츠력)이 작용하여, 이동대(16)가 가이드(15) 및 가이드(17)를 따라 이동하고, 광학 시스템 유닛(20a, 20b)이 기판 이동 방향( X방향)과 직교하는 도면의 안길이 방향(Y 방향)으로 이동이 제어된다.

그림 5는, 광학 시스템 및 제어 시스템의 개략적 구성을 나타내는 도면이다. 광학 시스템 유닛(20a, 20b)은, 검사광을 기판(1)으로 조사하는 투광 시스템, 기판(1)으로부터의 반사광을 검출하는 반사광 검출 시스템 및 기판(1)으로부터의 산란광을 수광하는 수광 시스템을 포함해서 구성된다. 또한, 제어 시스템은, 초점 조절 제어 회로(40), 신호 처리 회로(50), 광학 시스템 이동 제어 회로(60), 메모리(70), 통보 장치(80), 입출력장치(90) 및 CPU(100)를 포함해서 구성된다.

그림 6은 광학 시스템의 투광 시스템 및 수광 시스템의 개략적 구성을 나타내는 사시도이다. 투광 시스템은 레이저광원(21), 렌즈군(22) 및 미러(23)을 포함해서 구성된다. 레이저광원(21)은 검사광이 되는 레이저광을 발생한다. 렌즈군(22)은 레이저광원(21)으로부터 발생된 검사광을 집광하고, 집광된 검사광을 기판 이동 방향(X방향)과 직교하는 방향(Y 방향)으로 넓히고, 넓힌 검사광을 기판 이동 방향(X 방향)으로 집속시킨다. 미러(23)는 렌즈군(22)에 의해 집광된 검사광을 기판(1)의 표면에 비스듬히 조사한다. 기판(1)의 표면에 조사된 검사광은 기판(1)의 표면상에 있어서 기판 이동 방향(X 방향)으로 집속되고, 기판 이동 방향(X 방향)과 직교하는 방향(Y 방향)으로 소정의 폭을 가진 길이가 긴 형상의 검사광이 된다. 기판(1)이 기판 이동 방향(X 방향)으로 이동하는 것에 의해 투광 시스템으로부터 조사된 소정의 폭의 검사광이 기판(1)을 주사하게 되어, 주사 영역의 결함 검사가 실시된다.
기판(1)의 표면에 상처나 이물질 등의 결함이 존재하지 않을 경우, 기판(1)의 표면에 비스듬히 조사된 검사광의 일부는 기판(1)의 표면에서 반사되고, 나머지 검사광은 기판(1)의 내부를 투과해서 기판(1)의 이면에서 출사된다. 기판(1)의 표면에 상처나 이물질 등의 결함이 있을 경우는, 기판(1)의 표면에 조사된 검사광 안에서 기판 표면의 상처나 이물질 등의 결함에 조사된 광은 산란광이 되어 산란되고, 이외의 부분에 조사된 빛은 앞에서 언급한 바와 같이, 일부는 표면에서 반사되고, 나머지는 투과된다.
그림 5에 있어서, 반사광 검출 시스템은 미러(25), 렌즈(26) 및 CCD 라인 센서(27)를 포함해서 구성된다. 기판(1)의 표면으로부터의 반사광은 미러(25)를 통해서 렌즈(26)에 입사된다. 렌즈(26)는 기판(1)으로부터의 반사광을 집속시켜서 CCD 라인 센서(27)의 수광면에 결상시킨다. 이 때, CCD 라인 센서(27)의 수광면에 있어서의 반사광의 수광 위치는 기판(1) 표면의 높이에 의해 변화한다.
그림 5에서 나타내는 기판(1)의 표면 높이를 기준으로 했을 때, 기판(1) 표면의 높이가 기준보다 낮을 경우, 기판(1)의 표면에서 검사광이 조사 및 반사되는 위치가 도면의 왼쪽으로 이동하고, CCD 라인 센서(27)의 수광면에 있어서의 반사광의 수광 위치가 도면의 오른쪽으로 이동한다. 반대로, 기판(1)의 표면의 높이가 기준보다 높을 경우, 기판(1)의 표면에서 검사광이 조사 및 반사되는 위치가 도면의 오른쪽으로 이동하고, CCD 라인 센서(27)의 수광면에 있어서의 반사광의 수광 위치가 도면의 왼쪽으로 이동한다.
CCD 라인 센서(27)는 수광면에서 수광된 반사광의 강도에 따른 검출 신호를 초점 조절 제어 회로(40)로 출력한다. 초점 조절 제어 회로(40)는 CPU(100)로부터의 지령에 따라, CCD 라인 센서(27)의 검출 신호에 근거하여, 기판(1)의 표면으로부터의 반사광이 CCD 라인 센서(27)의 수광면의 중심위치에서 수광되도록 초점 조절 기구(41)를 구동해서 광학 시스템 유닛(20a, 20b)을 이동한다. 초점 조절 기구(41)는 펄스 모터(42), 캠(43) 및 캠 폴로어(cam follower)(44)를 포함해서 구성된다. 펄스 모터(42)의 회전축에는 편심된 캠(43)이 설치되어 있으며, 광학 시스템 유닛(20a, 20b)에는 캠 폴로어(cam follower)(44)가 설치되어 있다. 초점 조절 제어 회로(41)로부터 펄스 모터(42)로 구동 펄스를 공급하는 것에 의해, 펄스 모터(42)가 구동되어 캠(43)이 회전하고, 광학 시스템 유닛(20a, 20b)이 상하로 이동되어 광학 시스템 유닛(20a, 20b)의 초점 위치가 제어된다.
그림 6에 있어서 수광 시스템은 수광 렌즈(28), 결상 렌즈(29) 및 CCD 라인 센서(30)을 포함해서 구성된다. 집광 렌즈(28)는 기판(1)으로부터의 산란광을 집광하고, 결상 렌즈(29)는 집광 렌즈(28)로 집광한 산란광을 CCD 라인 센서(30)의 수광면에 결상시킨다. 그림 5에 있어서 CCD 라인 센서(30)는 수광면에서 수광한 산란광의 강도에 따른 검출 신호를 디지털 신호로 변환하여 신호 처리 회로(50)로 출력한다.
그림 1 및 그림 3에 있어서 스테이지(10)에는 광학 시스템 유닛(20a)의 투광 시스템으로부터의 검사광이 조사되는 영역에 복수의 개구(12a)가 마련되며, 광학 시스템 유닛(20b)의 투광 시스템으로부터의 검사광이 조사되는 영역에 복수의 개구(12b)가 마련되어 있다. 개구(12a)와 개구(12b)는 기판 이동 방향(X 방향)과 직교하는 방향(Y 방향)에 있어서, 광학 시스템 유닛(20a, 20b)의 투광 시스템으로부터의 검사광의 폭 이상의 길이를 가지며, 다른 위치에 교대로 마련되어 있다. 그림 4에 있어서, 광학 시스템 유닛(20a)의 투광 시스템으로부터 조사되어, 기판(1)의 내부를 투과해서 기판(1)의 이면으로부터 출사된 검사광은 개구(12a)를 통해서 스테이지(10)의 하방으로 나아가고, 광학 시스템 유닛(20a)의 반사광 검출 시스템 및 수광 시스템으로 수광되지 않는다. 광학 시스템 유닛(20b)의 투광 시스템으로부터 조사되어, 기판(1)의 내부에 투과해서 기판(1)의 이면으로부터 출사된 검사광도 동일하게 개구(12b)를 통해서 스테이지(10)의 하방으로 나아가며, 광학 시스템 유닛(20b)의 반사광 검출 시스템 및 수광 시스템으로 수광되지 않는다.
그림 5에 있어서 광학 시스템 이동 제어 회로(60)는 CPU(100)로부터의 지령을 따라, 코일(19)로 전류를 공급하고, 광학 시스템 유닛(20a, 20b)을 기판 이동 방향(X 방향)과 직교하는 방향(Y 방향)으로 이동하여, 광학 시스템 유닛(20a, 20b)의 투광 시스템으로부터의 소정의 폭의 검사광에 의해 주사되는 기판(1)의 주사 영역을 기판마다 변경한다.

그림 7은 기판의 주사 영역을 나타내는 도면이다. 본 실시 형태는, 기판(1)의 검사 영역을 44개의 주사 영역으로 분할하고, 2개의 광학 시스템 유닛(20a, 20b)을 이용하여, 각각 22회씩 주사하는 예를 나타내고 있다. 또한, 주사 영역 수 및 주사 회수는 이에 한하지 않고 기판의 크기나 광학 시스템의 수에 따라서 적절히 결정된다. 그림 7에 있어서 기판(1)의 주변부의 영역(NS)은 롤러(11)가 접촉하는 검사 대상 이외의 영역이며, 영역(SA1~SA22, SB1~SB22)은 광학 시스템 유닛(20a, 20b)의 주사 영역이다. 본 실시 형태에서는 우선, 첫 번째 기판(1)이 후술하는 센서(51)의 하방에 도달하기 전에, 광학 시스템 유닛(20a)을 주사 영역(SA1)이 통과하는 위치의 상공으로 이동하고, 광학 시스템 유닛(20b)을 주사 영역(SB1)이 통과하는 위치의 상공으로 이동한다. 그리고 첫 번째 기판(1)에 대해서, 광학 시스템 유닛(20a)의 투광 시스템으로부터의 검사광에 의해 주사 영역(SA1)의 주사가 실시되어, 광학 시스템 유닛(20b)의 투광 시스템으로부터의 검사광에 의해 주사 영역(SB1)의 주사가 실시된다.
첫 번째 기판의 주사가 종료된 후 두 번째 기판(1)이 후술하는 센서(51)의 하방에 도달하기 전에, 광학 시스템 유닛(20a)을 주사 영역(SA2)이 통과하는 위치의 상공으로 이동하고, 광학 시스템 유닛(20b)을 주사 영역(SB2)이 통과하는 위치의 상공으로 이동한다. 그리고 두 번째 기판(1)에 대해서, 광학 시스템 유닛(20a)의 투광 시스템으로부터의 검사광에 의해, 주사 영역(SA2)의 주사를 실시하고, 광학 시스템 유닛(20b)의 투광 시스템으로부터의 검사광에 의해, 주사 영역(SB2)의 주사를 실시한다. 이후, 이들 동작을 되풀이하고, 22번째 기판(1)에 대해서, 광학 시스템 유닛(20a)의 투광 시스템으로부터의 검사광에 의해, 주사 영역(SA22)의 주사를 실시하고, 광학 시스템 유닛(20b)의 투광 시스템으로부터의 검사광에 의해, 주사 영역(SB22)의 주사를 실시한다.
22번째 기판(1)의 주사가 종료된 후에는, 처음으로 되돌아가, 23번째~44번째 기판(1)의 주사를, 첫 번째~22번째 기판(1)의 주사와 동일하게 실시할 수 있다. 혹은, 23번째 기판(1)의 주사를 22번째 기판(1)의 주사와 동일하게 실시한 후, 광학 시스템 유닛(20a, 20b)을 역방향으로 이동하고, 24번째~44번째 기판(1)의 주사를 21번째~첫 번째 기판(1)의 주사와 동일하게 실시할 수 있다. 45번째 이후의 기판(1)의 주사도 같다.
그림 5에 있어서 메모리(70)는, CPU(100)의 제어에 의해 신호 처리 회로(50)가 검출된 주사 영역의 기판(1)의 결함 데이터를, 주사 영역마다 기억한다. 통보 장치(80)는 CPU(100)의 제어에 의해 후술하는 통보를 실시한다. 입출력장치(90)는, 후술하는 라인 정지 명령을 입력하고, CPU(100)의 제어에 의해, 결함의 데이터 및 후술하는 판정 결과를 출력한다.
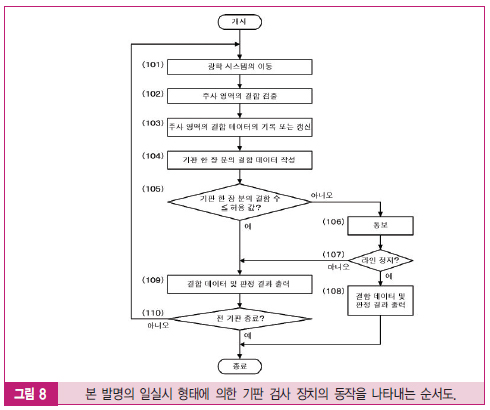
그림 8은 본 발명의 일실시 형태에 의한 기판 검사 장치의 동작을 나타내는 순서도이다. 우선, CPU(100)는 광학 시스템 유닛(20a, 20b)의 이동을 광학 시스템 이동 제어 회로(60)로 지령한다. 광학 시스템 이동 제어 회로(60)는 CPU(100)로부터의 지령을 따라 코일(19)로 전류를 공급하고, 광학 시스템 유닛(20a, 20b)을 각각의 주사 영역이 통과하는 위치의 상공으로 이동한다(단계 101). 롤러(11)에 의한 기판(1)의 이동에 따라, 신호 처리 회로(50)는 CCD 라인 센서(30)로부터의 디지털 신호를 처리하고, 주사 영역의 기판(1)의 결함을 검출한다(단계102).
다음으로, CPU(100)는 메모리(70)를 제어하고, 검출한 주사 영역의 기판 결함 데이터를 주사 영역마다 기억하고, 기판마다 신호 처리 회로(50)가 새로이 검출된 주사 영역의 기판(1) 결함 데이터에 의해 메모리(70)에 기억된 같은 주사 영역의 기판(1)의 결함 데이터를 갱신한다(단계 103). 그리고 CPU(100)는 기판마다, 메모리(100)에 기억된 복수의 주사 영역의 기판(1)의 결함 데이터로부터, 기판 한 장분의 결함 데이터를 작성한다(단계 104).
다음으로, CPU(100)는 작성한 기판 한 장분의 결함 데이터에 근거하여, 기판마다, 기판 한 장분의 결함 수가 허용 값 이내인지 아닌지를 판정한다(단계 105). 이러한 판정은, 결함 크기의 랭크별로 실시할 수도 있고, 혹은 결함 크기의 랭크에 관계없이 기판 한 장분의 모든 결함을 대상으로 실시할 수도 있다. 기판 한 장분의 결함 수가 허용 값 이내였을 경우, 단계 109로 넘어간다. 기판 한 장분의 결함 수가 허용 값을 넘었을 경우, CPU(100)는 통보 장치(80)를 제어하고, 라인 관리자 또는 라인 제어 설비로 기판 한 장분의 결함 수가 허용 값을 넘었다는 취지를 통보한다(단계 106). 이어서, CPU(100)는 라인 관리자 또는 라인 제어 설비로부터 입출력 장치(90)로 라인 정지 명령이 입력된 것인지 아닌지를 판정한다(단계 107). 라인 정지 명령이 입력되지 않을 경우, 단계 109로 넘어간다. 라인 정지 명령이 입력되었을 경우, CPU(100)는 입출력장치(90)를 제어하고, 결함 데이터 및 판정 결과를 출력하고(단계 108), 처리를 멈춘다. 그 다음, CPU(100)는 입출력장치(90)를 제어하여 기판마다, 결함 데이터 및 판정 결과를 출력한다(단계 109).
결함의 데이터의 출력은, 예를 들면, 결함의 크기 및 위치를 나타내는 맵을, 모니터용 디스플레이로 표시하면서 프린터로 인쇄하거나 혹은 결함 크기의 랭크별로, 각 주사 영역의 결함 수 및 기판 한 장분의 결함 수를 모니터용 디스플레이로 표시하면서 프린터로 인쇄하여 실시한다. 계속해서, CPU(100)는 전 기판의 검사가 종료되었는지 여부를 판정하고(단계 110), 종료되지 않은 경우는 단계 101로 되돌아가고, 종료되었을 경우는 처리를 멈춘다.
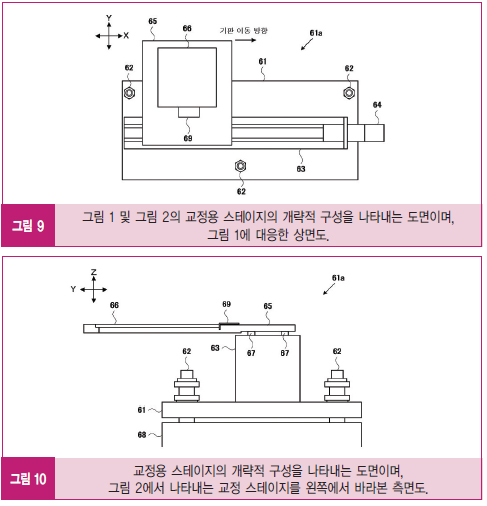
그림 9 및 그림 10은, 그림 1 및 그림 2의 교정용 스테이지의 개략적 구성을 나타내는 도면이며, 그림 9는 그림 1에 대응하는 상면도를 나타내고, 그림 10은 그림 2에서 나타내는 교정 스테이지를 왼쪽에서 바라본 측면도를 나타낸다. 교정 스테이지(61a)는, 그림 1에서 나타내듯이, 스테이지(10)의 하측의 메인테넌스 영역 내에 있으며, 프레임(13, 14)의 다리 위에 설치된다. 교정 스테이지(61a)는 베이스(61, 68), 조정 볼트(62), 볼나사 유닛(63), 서보 모터(64), 샘플 홀더(65), 표준 입자 부착 기판(66), 가동 블록(67) 및 판 스프링(69)으로 구성된다. 표준 입자 부착 기판(66)은 샘플 홀더(65)에 세팅된다. 표준 입자 부착 기판(66)은 샘플 홀더(65)에 마련된 판 스프링(69)에 의해 지지된다. 샘플 홀더(65)는 볼나사 유닛(63)의 가동 블록(67) 상에 설치되어, 서보 모터(64)가 회전하는 것에 의해 직선 이동을 한다. 볼나사 유닛(63)은 기판 이동 방향과 나란히 설치함으로써 가동 블록(67) 상의 샘플 홀더(65)도 평행하게 이동하는 것이 가능해진다.
볼나사 유닛(63)은 베이스(61) 상에 고정되어 있으며, 베이스(61)는 3개의 조정 볼트(62)에 의해, 장치의 다리 위에 설치된 베이스(68)와의 틈에서 두 방향으로 조정이 가능하도록 되어 있다. 이에 의해 기판 이동 방향으로 이동 중인 기판(1)의 표면과 표준 입자 부착 기판(66)의 표면 높이가 동일하게 되도록 높이를 조정하는 것이 가능하다.
광학 시스템의 교정 작업은 오퍼레이터가 조작 패널을 조작해서 검사 모드를 교정 모드로 전환하는 것에 의해 실시된다. 이에 의해 광학 시스템 유닛(20a, 20b)은 -Y 방향으로 동작하고, 메인테넌스 영역으로 이동한다. 광학 시스템 유닛(20a, 20b)은 메인테넌스 영역 내의 표준 입자 부착 기판(66) 상의 검사 시작 위치까지 이동한 후, 정지하여 표준 입자 부착 기판(66)의 검사 개시 대기 상태가 된다. 교정용 스테이지(61a)가 검사 영역 내의 기판 이동 방향과 같은 방향, 같은 속도로 X 방향으로 이동을 시작하면 광학 시스템 유닛(20a, 20b)이 표준 입자 부착 기판(66)의 주사를 실시한다. 교정용 스테이지(61a, 61b)의 X 방향으로의 동작 완료 후, 광학 시스템 유닛(20a, 20b)은 다음 주사 준비를 하기 위해서 Y 방향으로 주사 피치만큼 이동한다. 교정용 스테이지(61a, 61b)는 검사 시작 위치까지 X 방향으로 되돌아와 동작을 실시한다.
교정용 스테이지(61a, 61b)의 검사 개시 위치까지 X 방향으로 되돌아가는 동작 완료 후, 교정용 스테이지(61a, 61b)가 검사 영역 내의 기판 이동 방향과 같은 방향, 같은 속도로 X 방향으로 이동하여 광학 시스템 유닛(20a, 20b)이 표준 입자 부착 기판(66)의 주사를 실시하고, 검사를 완료한다. 이 검사 결과에 근거하여 오퍼레이터는 레이저 파워의 확인, 감도 조정 작업을 실시한다. 교정 작업 중은 제조 라인 내에 사람이 억지로 들어갈 필요가 없기 때문에 라인 가동 중에 있어서도 이 교정 작업을 실시하는 것이 가능해진다. 한편, 이 실시 형태에서는, 교정 스테이지(61a, 61b)가 배치되는 곳이 메인테넌스 영역이며, 기판(1)이 이동하는 영역이 검사 영역이다.
