| ASMPT, 세미콘 코리아 2026서 ‘지능형 혁신’ 가속화할 첨단 패키징 솔루션 대거 공개 |
|
|
|
| 2026-02 |
|
|
‘Empower the Intelligence Revolution’ 주제 내세워
AI·스마트 모빌리티·하이퍼커넥티비티 최적화 장비 선보여
ASMPT(www.asmpt.com)가 2월 11일부터 13일까지 서울 코엑스에서 개최되는 ‘세미콘 코리아 2026(SEMICON Korea 2026)’에 참가해 차세대 반도체 제조를 위한 핵심 포트폴리오를 선보인다. 이번 전시회에서 ASMPT는 ‘Empower the Intelligence Revolution(지능형 혁신의 동력)’을 메인 테마로 설정하고, 급변하는 AI 시스템과 스마트 모빌리티(smart mobility), 하이퍼커넥티비티 (hyperconnectivity) 시장에 대응하기 위한 고정밀 조립 및 패키징 솔루션을 집중 조명할 예정이다.
ASMPT Semiconductor Solutions 한국 지사장 김진우는 “ASMPT는 AI, 스마트 모빌리티 등 초연결 시대를 선도하는 기업들에게 단순한 장비 공급을 넘어 탁월한 가치를 전달하고 있다”며, “이번 세미콘 코리아를 통해 미세 수준에서의 완벽한 정밀도와 신뢰성을 기반으로 지능형 시스템을 실현하는 ASMPT의 독보적인 기술력을 확인할 수 있을 것”이라고 강조했다.
특히 이번 전시회에서 주목할 부분은 ASMPT Semiconductor Solutions 부문이 국내 최초로 공개하는 3가지 혁신 시스템이다. 카메라 모듈 조립부터 멀티칩 본딩, 레이저 다이싱에 이르기까지 반도체 후공정의 생산성과 정밀도를 획기적으로 높인 설비들이 참관객들을 맞이한다.
범용성과 정밀도의 조화, 카메라 모듈 조립 시스템 ‘DALA’
국내 최초로 공개되는 DALA는 카메라 모듈 구성품 조립을 위한 범용 픽앤플레이스 시스템으로, 최근 수요가 급증하고 있는 Edge-AI 이미지 및 센싱 시스템 제조에 최적화된 설비다. 이 장비는 ±7㎛에 달하는 탁월한 본딩 정밀도를 자랑하며, 칩, 렌즈 홀더, 글래스 부착 등 다양한 공정에 유연하게 대응할 수 있는 구성 옵션을 갖췄다. 소비자 가전부터 자동차용 센서에 이르기까지 폭넓은 활용성을 바탕으로 제조사의 공정 효율을 극대화한다.

고성능 멀티 칩 패키징의 기준, 본딩 솔루션 ‘MEGA’
MEGA는 차세대 광 트랜시버와 포토닉스, 센서 등 첨단 멀티 칩 패키징 요구 사항을 충족하기 위해 설계된 멀티 칩 본딩 솔루션이다. 에폭시 디스펜싱과 스탬핑, 3D 검사, 선택적 UV 경화 기능을 하나의 장비에 통합한 것이 특징이다. 특히 독립적으로 작동하는 픽업 및 본딩 암에 ‘플립-픽업’과 ‘로테이션 유닛’을 탑재해 정밀한 정렬을 보장하며, 복잡한 적층 구조에서도 높은 신뢰성을 유지할 수 있도록 설계되었다.

정밀 가공의 차세대 플랫폼, ‘ALSI LASER 1206’
다이싱 및 그루빙 공정을 위해 개발된 ALSI LASER 1206은 IDM 및 파운드리 업체의 증가하는 웨이퍼 가공 수요에 대응하는 차세대 플랫폼이다. ASMPT가 특허 출원한 ‘멀티빔 UV 레이저’ 기술을 적용해 가공 시 발생하는 열 영향을 최소화하고 버(burr) 형성을 억제한다. 이를 통해 다이(Die)의 강도를 유지하면서도 초정밀 가공을 실현하며, 필름 프레임 및 벌크 웨이퍼 모두를 지원해 선도적인 플라즈마 다이싱 공급업체들로부터 이미 그 성능을 검증받았다.

SMT와 패키징의 경계를 허물다, ‘SIPLACE’ 시리즈
ASMPT SMT Solutions 부문은 첨단 패키징 기능과 SMT 공정을 융합한 하이브리드 솔루션을 제시한다. ‘SIPLACE CA2’ 플랫폼과 ‘SIPLACE TX Micron’ 설비는 고속 실장과 극도의 정밀도를 동시에 요구하는 시장 환경에 최적화된 솔루션이다. ASMPT SMT Solutions Korea의 성안경 총괄 매니저는 “첨단 패키징 및 고집적 SiP 모듈의 발전으로 반도체 제조와 SMT 공정의 경계가 점차 모호해지고 있다”며 “ASMPT SMT Solutions는 생산 스펙트럼을 새로운 차원으로 확장시키는 플랫폼을 제공한다”고 밝혔다.
SIPLACE CA2는 웨이퍼에서 직접 다이를 고속으로 부착하면서 SMT 부품도 동시에 실장하는 하이브리드 플랫폼이다. 시간당 최대 54,000 다이 및 76,000 SMD를 ±10㎛?@?3σ 정밀도로 실장할 수 있다.
SIPLACE TX micron은 첨단 패키징 및 고밀도 응용 분야를 위해 개발된 고정밀 실장 플랫폼이다. 온도 안정성이 높은 유리 세라믹 스케일, 고정밀 피디셜 감지, 고해상도 비전 시스템, 첨단 진공 툴링을 결합하여, 시간당 최대 93,000개의 부품을 ±10㎛정밀도로 실장할 수 있다.
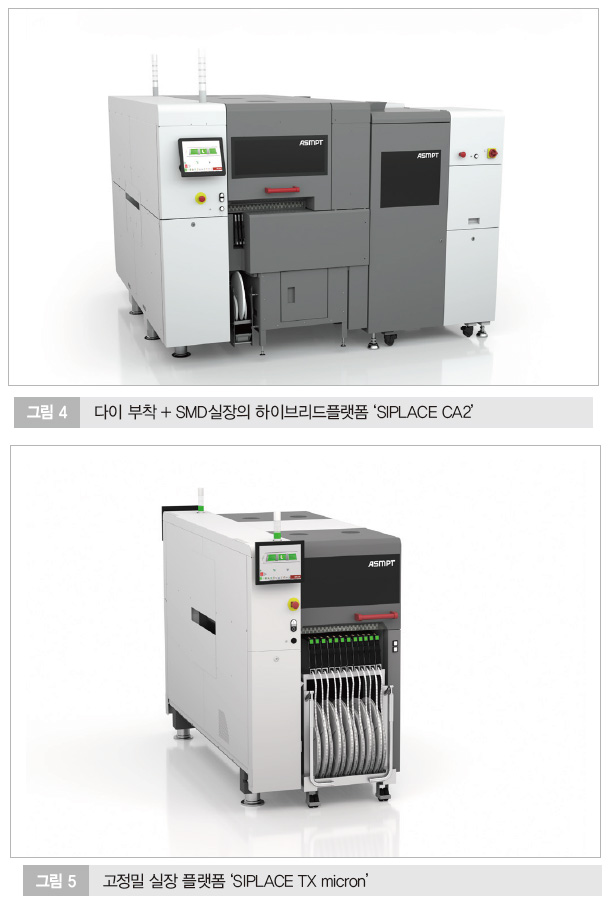
한편, ASMPT의 최신 반도체 제조 솔루션은 세미콘 코리아 2026 기간 동안 코엑스 D722 부스에서 직접 만나볼 수 있다.
|
| [저작권자(c)SG미디어. 무단전재-재배포금지] |
|
|
|
|
