다층 기판 위의 베어 다이 마운팅은 1960년대부터 마이크로일렉트로닉 산업계에서 사용되어 왔다. 우주항공 산업계의 하이브리드 모듈들과 IBM의 Solid Logic Technology는 1960년대에 개발된 초기 구현제품이다. 테크놀로지들은 BGA 패키징과 CSP의 출현으로 마이크로일렉트로닉스 산업계가 area array packaging으로 대이동을 시작한 1990년대 중반까지 꾸준하게 진일보하였다.
전통적으로, 첨단 IC 어셈블리의 진화는 국방 및 우주항공 애플리케이션 때문에 지속되어 왔다. 신뢰성, 사이즈 그리고 무게가 최우선이고 비용이 2번째 고려사항인 애플리케이션이다. 1980년대, 고성능의 컴퓨터 성능은 첨단 패키징 발전 자극제가 되기 시작했다. 그 흐름은 유비쿼터스 디지털 콘텐츠가 출현한 1990년 후반에 들어 다시 변화했다. 이 시대에는 디지털 카메라, 휴대전화, 포터블 컴퓨터, PDA 그리고 다른 유사한 대용량 애플리케이션이 소비재 시장을 촉발시켰다. 이러한 휴대용 디바이스들은 현재 반도체의 첨단 어셈블리에 있어서 ‘동력원’이 되기 시작했다. 최첨단 소비제품들의 어셈블러들은 이러한 유형의 애플리케이션에 다이 제품군의 활용에 더욱 의존하는 정교한 패키징과 interconnect 방법들을 향상시키고 있다. 다이 제품군은 베어 다이, 범프 다이 혹은 ‘웨이퍼 레벨 패키지 다이’로 정의되는데, 다이 크기가 변할 때 실장 기판 위의 전체 ‘풋프린트’가 변경된다. 본고에서는 여러 가지 다이 제품군 기술들을 리뷰할 것이고, 그들 사용에 있어서 마운팅 도전과제를 요약할 것이다.
서문
다층 기판 위의 베어 다이 마운팅은 1960년대부터 마이크로일렉트로닉 산업계에서 사용되어 왔다. 우주항공 산업계의 하이브리드 모듈들과 IBM의 Solid Logic Technology는 1960년대에 개발된 초기 구현제품이다. 테크놀로지들은 BGA 패키징과 CSP의 출현으로 마이크로일렉트로닉스 산업계가 area array packaging으로 대이동을 시작한 1990년대 중반까지 꾸준하게 진일보하였다. 본고에서는 PWB(printed wiring board)에 대한 전통적인 와이어-본드 다이 접합과 고성능 기판에 대한 범프 다이 접합 애플리케이션 양쪽의 도전과제를 알아본다.
다이 제품군 테크놀로지들
다이 제품군으로 간주되는 다양한 테크놀로지들은 알루미늄 와이어 본드가 가능한 I/O와 파워 패드를 가진 베어 다이, I/O와 파워 패드 상 상호접합 구조의 범프 다이 그리고 여유로운 피치를 가지면서, 다이의 표면을 기계적으로 보호하고, I/O와 파워 패드의 선택적으로 재라우팅하고, I/O와 파워 패드 상 상호접합 구조로 형성된 웨이퍼 레벨 패키지가 있다. 이들은 제품으로써 고객들에게 판매되고 일반 IC 공급채널을 통해 납품되고 있어서 다이 제품군이라고 한다.
베어 다이
다이 제품군의 가장 쉽게 이용할 수 있는 형태를 베어 다이라고 한다. 이러한 다이는 오늘날 대부분의 싱글 칩 패키지에 사용되는 다이와 동일하며, 리드프레임 혹은 상호연결한 기판에 와이어 본드된다. PWB에 직접적으로 장착된 와이어 본드된 다이의 사용은 CoB(chip-on-board)라고 불린다. CoB는 베어 다이 시장에서 가장 성숙하고 가장 큰 부문이다. CoB 기술은 다음과 같은 특징을 가지고 있다:
▶ 베어 다이는 상호연결한 기판 혹은 PWB 상에 장착된다.
▶ 전도성 혹은 비전도성 에폭시를 활용하여 기판에 다이가 기 계적으로 부착된다.
▶ 와이어 본딩을 활용하여 기판에 다이가 전기적으로 접촉된다.
▶ 다이는 보호막으로 캡슐화되었다.
그림 1에서는 보드 상에 4개 칩으로 직접 장착된 PWB를 보여주고 있다.
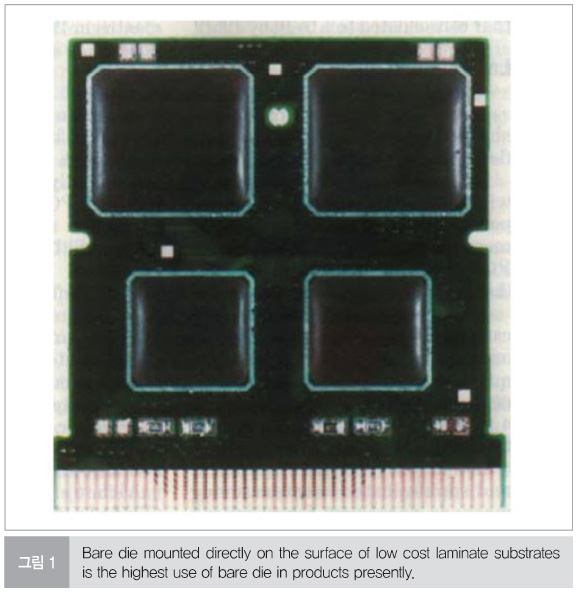
CoB 어셈블리 프로세스는 ‘다이 어테치, 와이어 본드, 캡슐화’라는 기본 3단계로 구성되어 있다. 그림 2에서는 CoB 어셈블리의 종단면 모식도를 보여주고 있다. 다이 어테치는 의도된 기판에 칩의 기계적인 접착력을 제공하고, 정밀한 칩 플레이스먼트 이후에 접착 애플리케이션이 필요하고, 그 이후 접착제 경화공정이 이어진다. 제 위치에 단단히 고정되면, 와이어 본드 프로세스는 기판 상의 와이어링 패턴과 관련된 다이 본드 패드를 전기적으로 연결한다. 와이어 본드 설비는 칩 상의 각 패드와 기판 상의 인접한 패드 사이에 일반적으로 Al 혹은 Au로 된 미세한 와이어들을 용접한다. 와이어 본딩은 강력한 접착뿐만 아니라 높은 생산수율을 보장하기 위해 칩과 기판 모두 깨끗한 상태의 패드 표면을 요구한다. 마지막으로, 캡슐화는 이동 및 추가적인 프로세스 동안 발생하는 기계적인 손상으로부터 다이와 본드 와이어들을 보호한다. 일부 경우, 특히 SiP(system in package) 애플리케이션의 경우, 캡슐화는 부품 마킹을 위한 표면 마감재 역할도 또한 수행한다. 캡슐화 공정에는 액상형 디스펜싱 혹은 특정 애플리케이션에 따른 전사 몰딩 둘 중 하나가 적용된다.
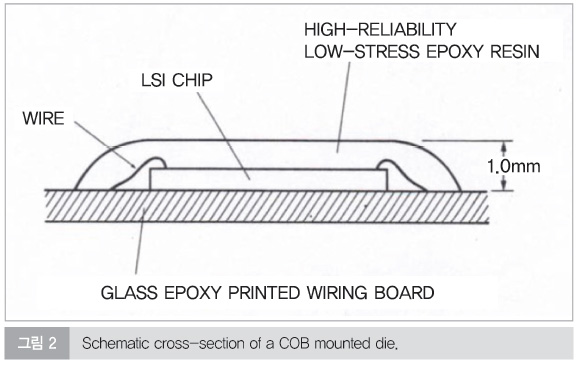
싱글 기판에 다이 제품군과 SMT 부품들이 혼재된 애플리케이션에서 CoB 어셈블리 프로세스를 설계하는 것이 특히 중요해 질 것이다. 원칙적으로, CoB 프로세스는 SMT 어셈블리 프로세스 선행 혹은 후속에서 이뤄질 수도 있다. 그러나 일반적으로 양호한 클리닝 프로세스가 채용된 CoB 프로세스의 경우에 SMT 프로세스는 먼저보다 더 단순한 프로세스 플로우를 제공한다. 본딩 표면을 준비하기 위해 플라즈마 클리닝과 같은 프로세스가 권장된다. CoB 어셈블리의 프로세스 특징과 고려사항은 하부에 자세하게 설명하고 있다. 그리고 CoB 프로세스 이해하기, 선택하기 그리고 지정하는데 특정 정보를 제공한다.
클리닝
와이어 본드들이 본딩할 때 표면이 깨끗하지 않으면 낮은 수율과 낮은 신뢰성을 나타낼 것이다. 최근까지, 와이어 본드의 수율과 신뢰성을 향상시키기 위해서 특별하게 설계된 클리닝 단계는 거의 고려되지 않았다. 높은 신뢰성을 요구하는 하이브리드 산업계는 본딩 전 분자세정방법의 활용을 개척해 왔다. 일부 오염물질이 패드에 화학적으로 결합될 가능성이 크고, 그래서 웨이퍼 레벨에서 클리닝을 해야 함에도 불구하고, 대부분의 bondability 관련 문제들은 유기 오염물질에 의해 발생한다. 유기 오염물질들은 산소 혹은 아르곤과 같은 플라즈마 클리닝 가스를 이용하는 것뿐만 아니라 다이 패키징 레벨에서 적용되는 단순한 UV-오존 처리만으로도 효과적으로 제거될 수도 있다. 한 보고서에서는 수 옹스트롱의 카본 두께막이 bondability를 악화시키는 것으로 발표했다. 세척된 골드막(<1 A carbon)은 thermosonic bonding에 사용되는 저온인 150℃에서 신뢰할만한 접합상태를 보였다. 그림 3에서는 세정 표면에 있어서 플라즈마 vs 비-플라즈마 방식의 전형적인 수율 곡선을 보여주고 있다. 세정과 비-세정 표면에 따른 와이어 본드 결함 vs 에너지 레벨의 상태도 나타내고 있다.
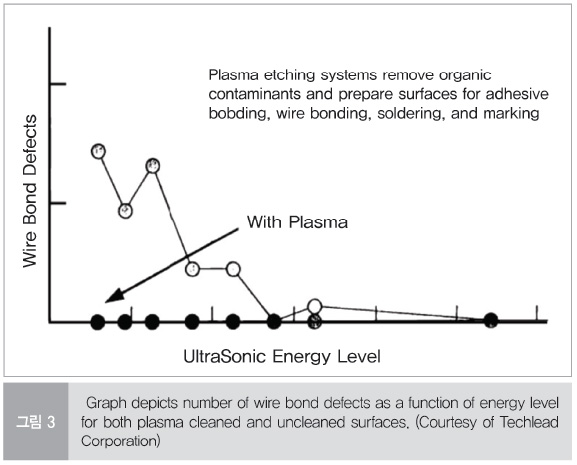
시각 검사
CoB 프로세스의 품질과 수율은 우수한 제조특성에 달려 있고, 시각 검사는 성공적인 결과를 얻는데 중요한 부문이다. 상호연결된 기판, 다이 어테치, 와이어 본드 그리고 캡슐 등의 불량은 시각 검사를 통해 검출될 수도 있다. 시각 검사는 전기 테스트와 같이 다른 방법에 의해 검출되지 않는 사항들도 검사한다.
다이 본딩
다이가 기판에 비아 와이어 본드로 상호연결된다면, 다이는 적절한 접착제에 의해 기판에 후면으로 우선 접착되고, 그 후 와이어 본드가 만들어진다. 다이 본딩 접착제의 요구사항에는 높은 접착력, 높은 열 전도성, 높은 전기 전도성 그리고 수용 가능한 프로세스 온도를 포함하고 있다. 가장 일반적인 다이 어테치 재료로는 Ag계 에폭시이지만, silver-glass 페이스트 및 액상 솔더를 포함한 다른 재료들도 고전력 애플리케이션에서 주로 사용되고 있다. 표 1에서는 전형적인 다이 어테치 재료들을 보여주고 있고, 각 재료의 장단점을 비교해 나타내고 있다.
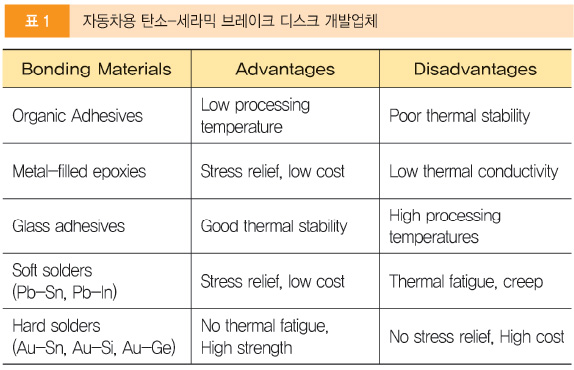
디스펜싱, 스텐실 프린팅 혹은 접착제의 핀 전사 방법은 다이 사이즈에 따라 사용될 수도 있다. 디스펜싱은 필름 타입 접착제를 제외한 가장 대중적인 도포 방법이다. 디스펜스 패턴들은 다이 사이즈와 모양에 따라 다르나, 이들 패턴들 모두는 보이드-프리 본드라인을 보장해야만 한다.
다이 실장
도포된 접착제 내부로의 다이 실장은 적절한 정방성 및 평탄성 제어뿐만 아니라 정확도가 요구된다. 다이를 접착제 내부로 넣기 위해 가해진 압력은 우수한 접착력을 보장할 것이고 본드 라인 두께를 설정한다. 정방성과 실장의 정확도는 본드 패드에 직접적으로 영향을 끼친다. 언더필과 같은 실장 작동 이후의 공정은 실장 동작 중에 고려되어야만 한다.
일반적으로, 다이 실장 공정 사이클은 다음과 같은 단계로 구성된다:
▶ 글로벌 혹은 로컬 피디셜 마크(혹은 회로 자체)를 활용한 기 판의 패턴 인식
▶ 이미지 확인 및 세타 수정
▶ 다이 실장
어떠한 다이 실장 기술이 사용되든지 간에, 다이 존재유무와 기판 취급상의 이슈들은 모두 공유되고 있다. 실장을 위해 다이는 웨이퍼 내, 와플 팩 그리고 테이프앤릴 등과 같은 다양한 형태로 공급될 수도 있다. 최적화된 다이-공급 스키마 선택은 상향식 프로세스, 웨이퍼 수율, 다이 사이즈 그리고 다이 소팅 요구 등과 같은 다양한 요인에 따라 달라진다.
와이어 본딩
와이어 본딩은 1960년대부터 마이크로전자산업계에서 실제 사용되어 왔다. 오늘날 산업계의 대부분의 IC 디바이스는 리드 프레임 혹은 기판 상에 와이어 본드되었다. 플립칩 방식으로 장착되는 ‘본드 패드’ 상의 범프와 같은 상호연결 구조를 지닌 디바이스들은 예외이다.
초음파 wedge bonding은 1960년에 산업계에 소개되었고, 골드 볼 열압착 본딩이 널리 보급되기 전까지 많이 사용되기 시작했다. 초음파 wedge bonding은 실온에서 실행된다. Au 또는 Al 본드 패드 중 하나에 Al 와이어를 본드하기 위해 주로 사용되어졌다. 초음파 용접은 조임력(clamping force)을 가한 초음파 에너지의 응용을 통해 형성된다.
하지만 오늘날, IC에 상호배선을 형성하는 대부분은 Au 열초음파 볼 접합으로 만들어진다. 이 방법은 초음파와 열압착 용접의 각 장점들만 최적화하여 결합하였다. 열초음파 용접은 열압착 용접보다 낮은 온도가 필요하다. 따라서 플라스틱 본딩, 라미네이트 및 민감한 다이에 적합하다.
▶ 골드 볼 접합 파라미터들
- 장점 : 높은 생산성, 강한 강도, 전방위적, 파인피치
- 단점 : 온도 상승, 재료 비용 증가, 금속간 전위
- 프로세스 고려사항 : 온도, 전력, 세기, 시간, 와이어 직경, 와이어 길이, 야금, 피치, 본딩 표면 상태, 본딩 영역
▶ 알루미늄 wedge 접합 파라미터들
- 장점 : 실온에서 프로세스 가능, 낮은 재료 비용(와이어), 파 인피치
- 단점 : 강도, 생산성, 밀봉되지 않은 애플리케이션 부적합
- 프로세스 고려사항 : 전력, 세기, 시간, 와이어 직경, 와이어 길이, 야금, 피치, 본드 각도, 전방향/역방향 본딩, 본딩 표 면 상태, 본딩 영역
캡슐화
다이를 물리적으로 보호하기 위해 액상 캡슐화 혹은 전사 몰딩 둘 중 하나가 일반적으로 필요하다. 거대한 모듈과 다양한 부품들이 혼재된 기판에 거대하게 실장된 다이는 액상 캡슐화가 일반적이다. 캡슐화를 위해 재료에는 낮은 투습성, 훌륭한 모바일 이온 배리어, 좋은 가시적외선 및 알파 입자 보호, 훌륭한 기계적, 전기적 그리고 물리적 특성이 요구된다. 캡슐화는 디바이스 전파 지연을 감소하기 위한 낮은 유전상수와 훌륭한 열 전도성을 가져야만 한다. 애플리케이션과 대상 조건에 적합한 제품을 선택하는 것이 중요하다.
플립칩 실장
플립칩은 다이의 면을 상호연결하는 기판을 향하게 하는 다양한 마운팅 테크놀로지를 설명하는데 사용되는 항목이다. 플립칩 테크놀로지가 1960년에 IBM과 Delco에 의해 개시되었음에도 불구하고, 많은 다이 디바이스에 상호배선 방법으로 최근 선택되기 시작했다. 범프의 등장으로 기생전기소자는 보드에 최상의 인터페이스, 다이의 표면 도체에 전력과 접지연결을 놓을 수 있는 능력을 제공한다. 실제로, 일반적인 ‘gang’ 본딩 기술은 플립칩에 있어서 와이어본드 디바이스의 컨버젼 역할을 한다.
게다가 이러한 장점들 이외에도 가장 중요한 점 중 하나는 본딩 패드가 다이의 주위에 놓일 필요가 없다는 사실이다. 실제로 바람직한 배열은 다이의 면 전체에 걸친 array configuration이다. 어레이 I/O 또한 전력 공급, 고속 퍼포먼스를 향상시키고, 다이 제품군 어셈블리가 용이하도록 편안한 피치 간격을 제공한다. 현재 선호되고 있는 기술 중 일부는 솔더 볼 플립칩과 접착제 플립칩이다. 그림 4에서는 area array pad configuration vs peripheral configuration을 적용한 효과를 보여주고 있다.
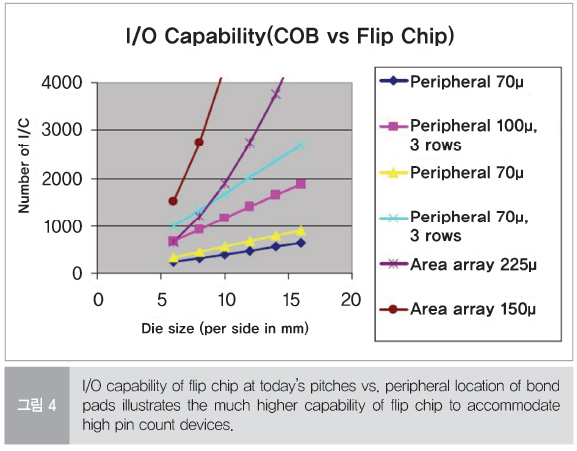
Moore의 법칙에 따라 IC 크기가 지속적으로 줄어들고 있기 때문에 area array pad configuration은 한정된 I/O으로부터 디바이스 사이즈를 유지시켜줄 수 있다.
솔더 플립칩
솔더 범프 플립칩은 1960년대부터 IBM에서 사용되기 시작해 왔다. IBM 솔더 범핑 프로세스, 일명 C4(controlled-collapse chip connection)는 고융점 솔더를 활용한다. FR-4와 같은 Low Tg을 사용하다면 리플로우되지 않을 수 있다. 그러나 범프들은 스탠드오프로써 활용될 수 있고, 상호연결된 기판 상 패드의 표면에 적용된 공융 솔더의 얇은 레이어를 접합시킬 수 있다. 다른 옵션으로는 다이에 공융 범프를 형성하는 것이고, 상호연결한 기판의 지정된 패드 상에 직접적으로 리플로우하는 것이다. 플립칩 실장의 이 방법은 표면실장 프로세스와 직접 호환할 수 있다. 그림 5에서는 공융 솔더 플립칩 라인의 프로세스 플로우를 보여주고 있다.
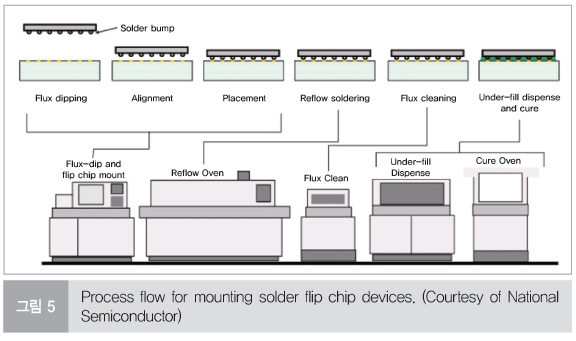
▶ 낮은 점성(빠른 플로우)
▶ 낮은 경화온도/빠른 경화시간. 비용 절감 및 다른 부품에 덜 해로움.
▶ Low Tg. 칩, 솔더 범프 및 서브스트레이트 간의 열팽창 불 일치 감소.
▶ 높은 탄성계수. 우수한 기계적 특성 달성.
▶ 낮은 흡습성. 보관 수명 연장.
▶ 우수한 접착력. 제품 수명 향상.
언더필 캡슐화의 최근 발전기술은 일명 ‘no flow’ 언더필이다. 이 프로세스의 경우, 언더필은 칩이 놓이기 전에 기판에 도포된다. 일반적인 프로세스는 다음과 같다:
▶ 서브스트레이트 상 본드 패드 위에 no flow 재질의 제어된 체적이 도포된다.
▶ 솔더 페이스트가 SMT 부품 어셈블리용 보드 상에 프린트 된다.
▶ SMT 부품이 놓인다.
▶ 그런 다음 베어 칩은 서브스트레이트 상의 본드 위치 피디셜 마크에 따라 칩에 적합한 비전 시스템을 활용하여 얼라인된다.
▶ 칩들이 서브스트레이트 상에 놓고, 서브스트레이트에 압착 본드를 형성하도록 no flow 액상 언더필을 압착한다.
▶ 솔더 상호배선은 플럭싱과 no flow 언더필의 중합이 발생하 는 동안에 동시에 리플로우된다.
No-flow 언더필은 대형 디바이스에 요구되는 긴 capillary flow 시간을 없앨 수 있어서 스탠더드 언더필 프로세스 전체에 커다란 장점을 줄 수 있다. 게다가 리플로우 단계 동안에 no flow 재료가 완벽하게 경화되는 특성을 가지고 있어서 프로세스 속도는 늘어난다.
접착제 활용 플립칩
오늘날 전세계 휴대기기 업계에서 선호하고 있는 플립칩 마운팅의 다른 형성은 접착제를 활용한 플립칩 공법이다. 이 기술에는 요구사항에 따라 다양한 타입이 존재한다. 미세 라인 회로보드에 스터드 범프 IC를 직접적으로 접합시키기 위한 비도전성 접착 필름을 활용한 플립칩 형성이 보고되어 있다. 도전성 접착제의 경우, 접착 필름은 도전성 입자를 함유하지 않기 때문에 소형 패드 피치에 사용될 수 있다.
필름은 또한 열-기계적 관리를 위한 봉합재 혹은 언더필 재료 역할을 한다.
접착제 사용 플립칩 실장의 또 다른 형성은 전기적, 기계적 접합제로써 ACF 필름 혹은 ACA 접착제 둘 중 하나의 이방성전도재질을 활용하는 것이다. 이방성전도필름은 종이처럼 보이며, 열경화접착제, 도전성입자 그리고 이형필름으로 구성되어 있다. 그림 6에서는 이방성전도필름 플립칩 테크놀로지의 대표적인 모습을 보여주고 있다.
접착제 활용 플립칩 실장 테크놀로지에는 여러 장점이 있다: 일반적으로, 다이의 패드 피치는 솔더 플립칩 방법에서 가능한 것보다 더욱 세밀하다. 클리닝 단계는 솔더 기반 시스템만큼 엄격하지 않고, 솔더로 상호배선 패드를 코팅하는 프로세스 단계를 없애고, 납의 사용을 제거한다. 범핑 프로세스는 스터드 범핑 사용으로 인해 단순화될 수도 있다. 스터드 범핑은 IC 패드에 와이어본드를 하는 범프 형성을 위해 동일한 프로세스와 장비를 활용한다. 열압착 및 초음파 에너지는 IC 패드 상의 골드 볼 형성에 사용되고 있다; 와이어는 볼의 상부에서 절단되고 평평하게 되는데, 기판에 ACF 본딩이 적합한 골드 범프를 생성한다.
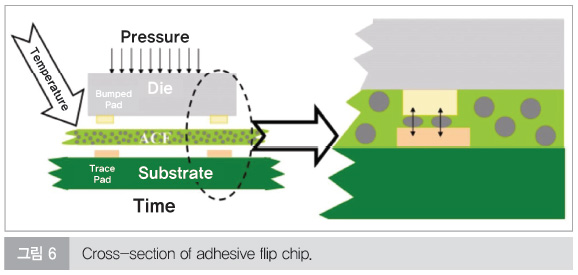
웨이퍼 레벨 패키징
플립칩 어셈블리로의 동력은 웨이퍼 레벨 패키징 방식에 의해 지원되고 있다. 웨이퍼 레벨 패키징(WLP)은 다이 터미널이 웨이퍼 상에서 제조 및 테스트되고 그 후 표면실장라인에서 어셈블리가 가능하도록 다이싱 작업을 통해 싱귤레이트되는 첨단 패키징 테크놀로지이다. 다이 터미널들은 연관된 플립칩 구조보다 더 넓은 피치와 더 넓은 볼 구조가 특징이다. 더 넓은 피치들은 표준 표면실장라인에 이들 테크놀로지를 통합하는데 유리하다. 더 커진 볼 직경은 IC와 상호연결된 기판 간의 TCE 부정합 변형 감소에 대한 기계적 요구사항을 지원한다. 더 거대한 스탠드오프 높이는 상호연결하는 구조, 예를 들어 솔더 기반 디바이스에 대한 개별적인 솔더 볼 내의 변형을 줄인다. 표 2에서는 웨이퍼 레벨 패키지된 IC들의 핵심 사항들을 요약해서 보여주고 있다.
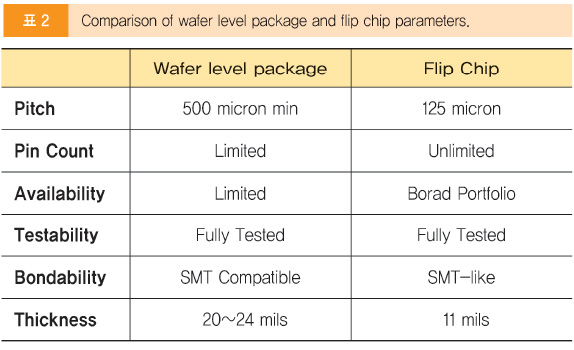
웨이퍼 레벨 패키징은 1990년대 후반 CSP(Chip Scale Packages)로 알려진 일련의 디바이스로 시작된 베어 다이 어셈블리의 기능 및 밀도를 달성하고자 노력하는 추세의 연속이다. 베어 실리콘 다이의 치수와 매우 근접한 여러 CSP 테크놀로지들이 패키징 업계에 의해 개발되어 왔다. CSP 테크놀로지는 거대한 볼 피치와 전통적인 표면실장 어셈블리 설비와의 호환성 때문에 어셈블리 및 테스트 요구사항을 쉽게 처리할 수 있다. 지난 몇 년 동안, CSP 패드 피치들은 1.0mm에서 0.8~0.75mm로 감소해 왔다. 0.5mm 이상의 area array 패드 피치들은 표준 표면실장제조 플로우에 적용될 수 있는 것으로 간주되고 있다. 웨이퍼 레벨 패키징 테크놀로지들은 표준 SMT 프로세스의 장점을 활용하면서 상호연결하는 기판에 절대적인 초소형 풋프린트를 제공하는 것이 목표이다. 물론, Moore의 법칙 개선을 이끌어 낸 batch 프로세싱의 경제성은 디바이스의 패키징에서 처음으로 적용하고 있다.
CSP와 웨이퍼 레벨 패키징 테크놀로지의 추구에 있어서 강력한 요인 하나는 언더필을 회피하고자 하는 바램이다. 제조업자들은 실리콘과 상호연결하는 기판 간의 CTE 불일치에 대한 우려 혹은 떨어뜨릴 수 있는 휴대형 기기 내 다이의 ‘충격’ 완화를 제공하기 위해 디바이들을 언더필할 수도 있다. WL-CSP 프로세스의 전형적인 소형 다이는 기계적인 전단력 때문에 위험에 덜 노출되며, 언더필 요구가 줄어든다.
결론
IC 제조업체에 의해 제공되는 놀랄만한 경제성에 힘입어, 디지털 콘텐츠의 폭발적인 증가로 오늘날 소비자 기대심리에 불을 지피고 있다. 디지털 사진, 통신기기, 컴퓨터 내의 높은 밴드폭, 더 커진 해상도 그리고 향상된 품질뿐만 아니라 가격은 낮아야만 하고, 신뢰성을 더 좋아야한 한다. 첨단 가전기기 디바이스 제조업체들은 공간 및 무게 절감, 제품 차별화, 기능 집적화, 비용 및 타임-투-마켓 이점을 누리기 위해 다이 제품군을 채용하고 있다.
